摘要
采用晶体离子切割(CIS)技术制造的碳化硅(SiC)复合基板可以成为实现多种微电子器件功能的优良材料平台。研究中发现,在不同热激发条件下,剥离薄膜的表面形态存在差异。为了探究导致这些差异的不同劈裂行为,基于AFM、拉曼光谱、XRD和TEM材料表征,建立了SiC薄膜在CIS技术制造过程中的缺陷演变基本模型,缺陷演变过程可分为脱离、聚集、增长和连接阶段。结合分子动力学模拟结果和缺陷演变模型,导致不同退火热激发下表面形貌差异的劈裂行为可以归因于H2气泡成核速率的不同。本文研究了CIS技术中缺陷演变和晶体劈裂的基本物理化学现象,并为热处理工艺的改进提供了指导,这有助于实现SiC单晶薄膜转移的整齐劈裂,并实现SiC单晶薄膜的可行异质集成。
1. 引言
基于碳化硅(SiC)单晶薄膜的异质集成复合基板可以成为实现多种微电子器件功能的优良材料平台[1],例如离散功率器件[2,3]、高温SiC传感器[4,5]、GaN的异质外延[6,7]以及多功能器件的集成[8,9]。此外,这种复合基板还可以通过替代传统的SiC单片晶圆显著降低SiC技术的应用成本[3,10]。
通过异质外延生长制造SiC薄膜在工业上并不推荐,因为SiC与大多数半导体基板之间存在巨大的晶格失配(与Si的失配率为40%,与Al₂O₃为35%)[11]。这种制造方法会引入高度损伤的外延层,包含不可接受的大量位错和反相边界[12,13]。目前,异质外延一般应用于3C-SiC,而4H-SiC和6H-SiC很少报道。晶体离子切割(CIS)技术是一种通过晶圆粘接和层转移技术,利用H+/He+注入制造单晶薄膜的有效技术。其优点是可以制造较少缺陷的薄膜,而无需考虑晶格失配问题。CIS技术已成功应用于多种材料[14–18]。
由于高杨氏模量和共价键能量,通过CIS技术制造SiC薄膜需要较高的热预算,且缺陷演变缓慢且难以控制。有一些报告简要阐述了SiC薄膜的制造以及注入引起的缺陷的演变行为。Di Cioccio等人首次介绍了SiC复合基板的制造[10]。Amarasinghe等人研究了最低热预算的最佳离子注入参数[19]。Daghbouj等人研究了缺陷的发展和气泡形成效率与注入剂量的关系[20]。一些学者研究了注入引起的缺陷及其演变行为[21–23]。然而,关于基于高质量薄膜制备实验结果,讨论缺陷演变对薄膜剥离的影响的文献较少。
本文表明,注入引起的缺陷在不同热激发条件下的演变行为对剥离薄膜的形貌具有重要影响,而这一点在以往的研究中未曾报道。在本研究中,建立了不同热激发下的缺陷演变模型,通过多种材料表征方法和分子动力学模拟,旨在实现SiC薄膜的整齐劈裂并指导热处理技术的优化,为CIS技术制备高杨氏模量材料的单晶薄膜过程提供指导。
2. 材料与方法
采用4H-SiC单晶晶圆(由SICC公司提供,晶面为(0001))进行H+注入。注入参数为:180 keV能量,8 × 10¹⁶ 原子/cm²剂量,120°C温度,7°角。注入深度约为1.2 μm。注入后的晶圆被切割为20 × 20 mm的尺寸进行实验。在缺陷演变的研究中,切割后的注入晶圆在200°C、300°C、400°C、500°C、600°C和700°C下退火10小时,然后进行相应的材料表征。在剥离实验中,清洗后的SiC芯片与热氧化硅芯片(25 × 25 mm)通过等离子激活在13.56 MHz频率、O₂气氛和90秒的时间下进行粘接。在剥离过程中,薄膜在不同温度下在2 MPa压力下退火。CIS实验中的代表性退火参数为:780°C退火10小时,700°C退火60小时,以及700°C退火20小时 + 740°C退火20小时。加热和冷却速率均为4°C/min。CIS技术的过程如图1所示。
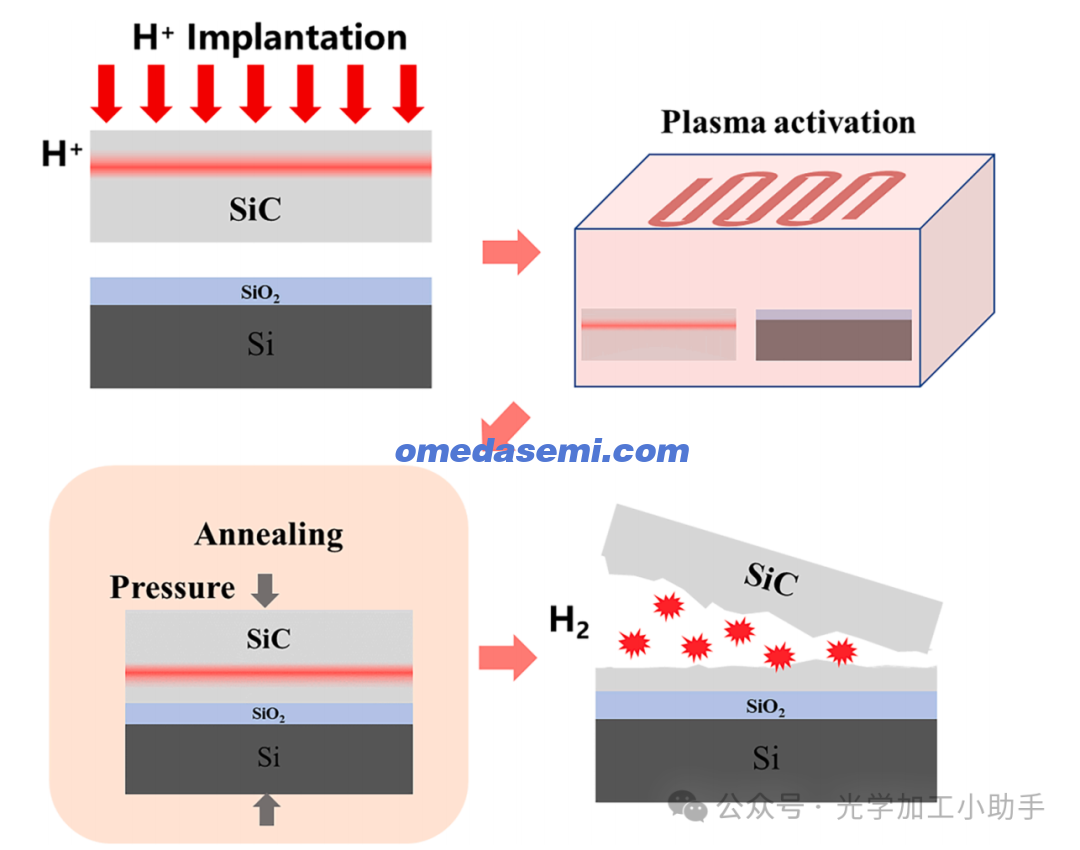 图1. CIS技术制备SiC薄膜的过程
图1. CIS技术制备SiC薄膜的过程
通过不同的表征技术研究了H+注入引起的缺陷在退火过程中的演变。原子力显微镜(AFM)用于表征剥离薄膜的表面形貌。拉曼光谱用于表征H+注入引起的缺陷及其在退火过程中的变化,532 nm激光波长是一种快速且无损的研究方法,用于研究晶体材料中的缺陷,测试在室温下进行。532 nm激光在原始SiC中的入射深度约为2 μm。注入后的SiC具有比原始SiC更大的吸收系数,这使得能够分析深度为几个μm的材料信息。X射线衍射(XRD)用于分析注入SiC的晶格应力。透射电子显微镜(TEM)用于观察注入引起的缺陷及其演变过程。
分子动力学模拟用于研究SiC晶体在热激发下的应力-应变和断裂行为,为薄膜表面形貌差异提供依据。通过LAMMPS对SiC进行了700°C和780°C下的拉伸模拟。模拟模型的尺寸为10a × 10b × 10c,选择Teroff势函数描述SiC中原子之间的相互作用。进行了能量最小化以获得稳定的结构。拉伸模拟过程中使用NPT系综,拉伸速度设为0.005 /ps【24,25】。
3. 结果与讨论
3.1. 不同热激发条件下表面形貌的差异
不同热激发条件下代表性剥离薄膜的特征形貌光学照片和AFM表面形貌图如图2所示。退火参数分别为:780°C退火10小时、700°C退火60小时以及700°C退火20小时 + 740°C退火20小时。
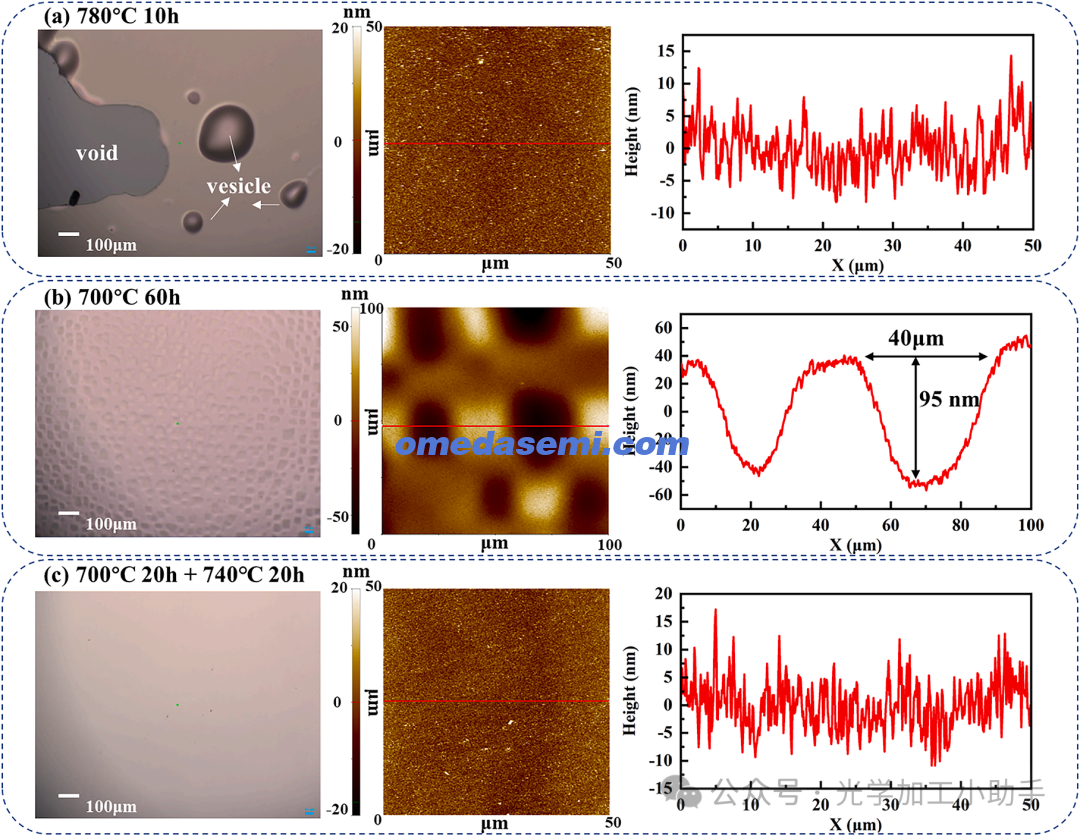
图2. 在不同退火参数下剥离薄膜的光学照片和AFM结果:
(a) 780°C退火10小时;(b) 700°C退火60小时;(c) 700°C退火20小时 + 740°C退火20小时。
如图2(a)所示,在780°C退火10小时的退火温度下,剥离表面存在大量的空隙和小泡,且剥离表面相对平坦,Ra = 3.2 nm。当退火参数为700°C退火60小时时,如图2(b)所示,剥离膜具有完整区域,但表面显示出40 μm宽、95 nm深的波动坑,Ra = 16.4 nm,这对于后续的平整化过程极为不利。在优化退火温度下,700°C退火20小时 + 740°C退火20小时(如图2(c)所示),剥离膜具有完整区域,剥离表面平整,Ra = 3.4 nm。实验结果表明,过大的热预算会极大影响区域完整性,而过低的热预算则不利于实现SiC薄膜转移的整齐劈裂,从而对表面形貌产生不利影响。因此,为了探讨H+注入引起的缺陷演变对SiC薄膜转移劈裂行为的影响,深入理解薄膜剥离机制,建立缺陷演变、气泡生长和裂纹传播模型是至关重要的,这有助于提高CIS过程,从而制备大面积高质量的SiC单晶薄膜。
3.2. 退火过程中H+注入引起的缺陷的形貌和演变
H+的渗透和在目标深度的积累损害了SiC的晶体结构,并引入大量的缺陷。H+注入引起的缺陷的形貌及其在退火过程中的演变通过拉曼光谱研究,如图3所示。
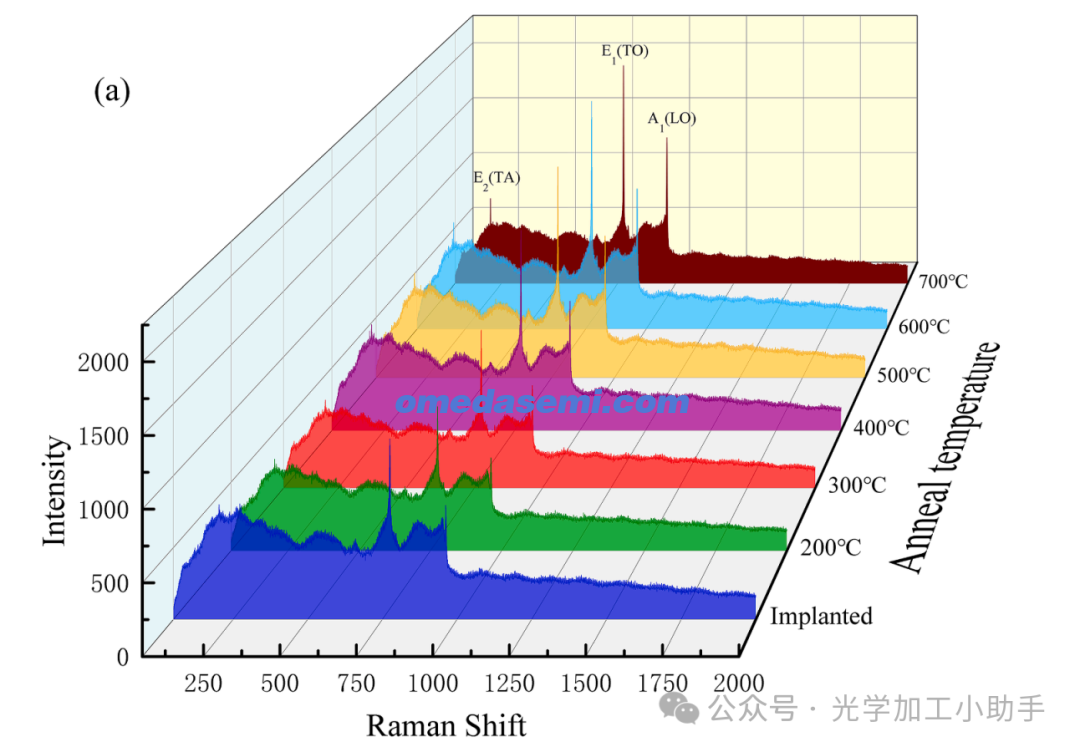

图3. 在不同退火温度下注入SiC的拉曼结果:
(a) 原始数据;(b) 标准化比较。
如图3(a)所示,SiC特征分子振动峰E1(TO)、E2(TA)和A1(LO)的强度在退火过程中持续增强。原因是H+在热激发下从晶格中脱离,导致化学键的重组和晶格应力的减小,表现为晶体的不断修复。为了更直观地反映H+注入引起的缺陷类型及其在热激发下的变化,图3(b)显示了标准化后的表征数据。
H+注入后,拉曼光谱带发生了变化,如强度减弱、谱带底部变宽、不对称以及TO和TA谱带的变形。原因是H+注入引起的缺陷导致堆垛层错的形成和晶体周期性的失败,导致声子寿命减少,并扰乱了拉曼散射过程中的波速矢量和偏振光选择规律【28】。
H+注入引起的拉曼谱带主要集中在150~470 cm⁻¹、480~635 cm⁻¹、660 cm⁻¹、870 cm⁻¹、920~980 cm⁻¹和峰值>~1090 cm⁻¹,分别代表堆垛层错中的各化学键的分子振动。每个光谱带代表的分子振动列于表1中,结果表明离子注入极大地破坏了原始晶体的原子排列,形成了Si-Si、C-C和Si-C键,并在高应力下出现。
随着退火温度的升高,堆垛层错的拉曼谱带强度相对于SiC的特征峰逐渐减弱,而SiC特征峰的强度相对增加,如图3所示。这一现象主要可以通过以下几点解释:根据拉曼光谱原理,在532 nm波长下表征的材料信息覆盖几个微米的深度,包括H+渗透区、积累区和未到达区。一方面,H+渗透区和H+分布较少的区域随着退火温度的升高不断修复,表现为SiC特征峰强度的不断增强。另一方面,积累区中H+的成核和生长严重破坏了晶体结构,并在退火过程中导致大量化学键断裂,导致堆垛层的拉曼光谱强度减弱。
3.3. 退火过程中SiC晶格的演变
X射线衍射(XRD)是一种非常灵敏的单晶材料表征方法,SiC晶格在离子注入后的应力-应变行为可以通过XRD进行表征。退火温度下X射线衍射谱的变化如图4(a)所示。
主布拉格峰(35.6°)是由X射线在SiC单晶(0006)晶格面上的相干衍射产生的,而主峰左侧的一系列卫星峰则是由晶格的膨胀引起的【22,33】。这些波动的卫星峰提供了晶格应力分布的参考,周期性与应变层的分布有关【34】。应变层和原始SiC晶格都满足布拉格定律:
其中 λ 是入射光波长,d 是与衍射角对应的晶面间距,根据布拉格定律:
其中,dSiC 表示(0006)晶面的晶面间距,dlayer 表示应变层的晶面间距,Δθ 表示应变层相对于(0006)晶面的入射角变化,因此应变率 ε 可以表示为:
3.3. 退火过程中SiC晶格的演变
X射线衍射(XRD)是一种非常灵敏的单晶材料表征方法,SiC晶格在离子注入后的应力-应变行为可以通过XRD进行表征。退火温度下X射线衍射谱的变化如图4(a)所示。
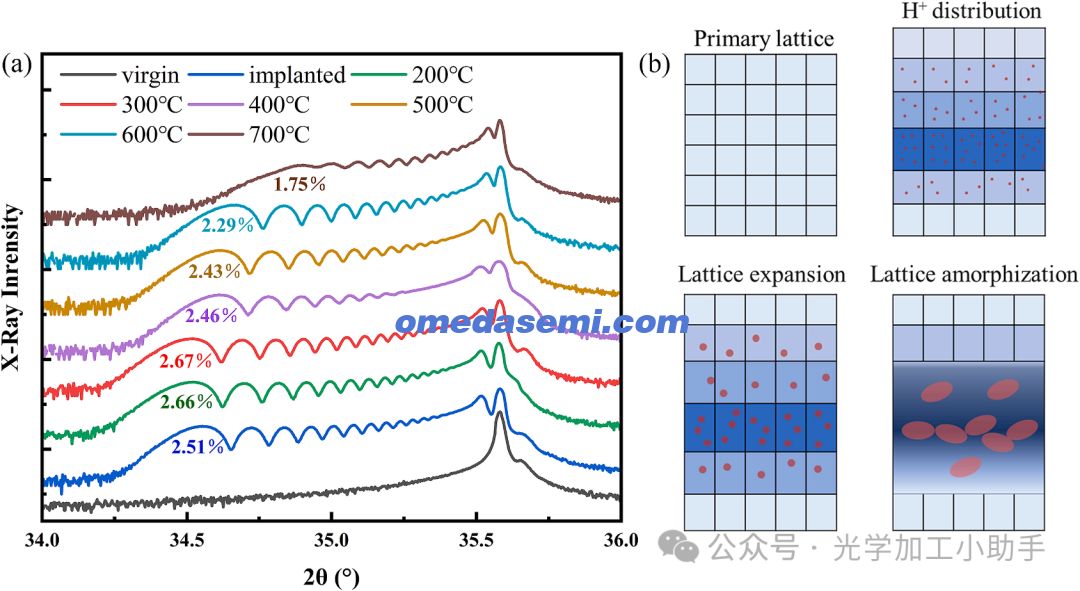 图4.
图4.
(a) 在不同退火温度下注入SiC的XRD结果;
(b) 退火过程中H+在SiC晶格中的演变示意图。主布拉格峰(35.6°)是由X射线在SiC单晶(0006)晶格面上的相干衍射产生的,而主峰左侧的一系列卫星峰则是由晶格膨胀引起的【22,33】。这些波动的卫星峰提供了晶格应力分布的参考,周期性与应变层的分布有关【34】。应变层和原始SiC晶格都满足布拉格定律:
3.4. 退火和劈裂过程中的微观结构演变
前期的研究从化学键和晶格应力的角度展示了缺陷引入和演变过程。然而,通过CIS技术制造单晶薄膜是一个极为复杂的物理化学过程。除了原子和晶格层面的变化外,还涉及H2气泡的积聚与生长以及SiC晶体中裂纹的扩展。不同热激发条件下注入SiC的TEM表征结果如图6所示。
如图5(a)和图5(b)所示,H+注入产生了明显的晶体损伤区,H+聚集使得原本整齐的晶格排列趋于混乱,导致大量的晶格缺陷和堆垛层错。注入的SiC在700°C退火10小时后的缺陷演变结果如图5(c)和图5(d)所示。
 图5. TEM结果:
图5. TEM结果:
(a) (b) 注入后;
(c) (d) 700°C退火10小时;
(d) (e) 720°C退火20小时。
H+聚集区逐渐演变为微腔区,H2在微腔中的聚集和生长破坏了晶格,导致裂纹的形成。720°C退火20小时后的表征结果如图5(e)和图5(f)所示。裂纹随着退火时间或温度的增加进一步横向扩展,并趋向互相连接,形成裂纹区并导致该区域晶格的非晶化。结合拉曼光谱和XRD的表征结果,CIS技术中缺陷演变导致剥离的过程主要可以分为以下四个阶段,如图6所示。
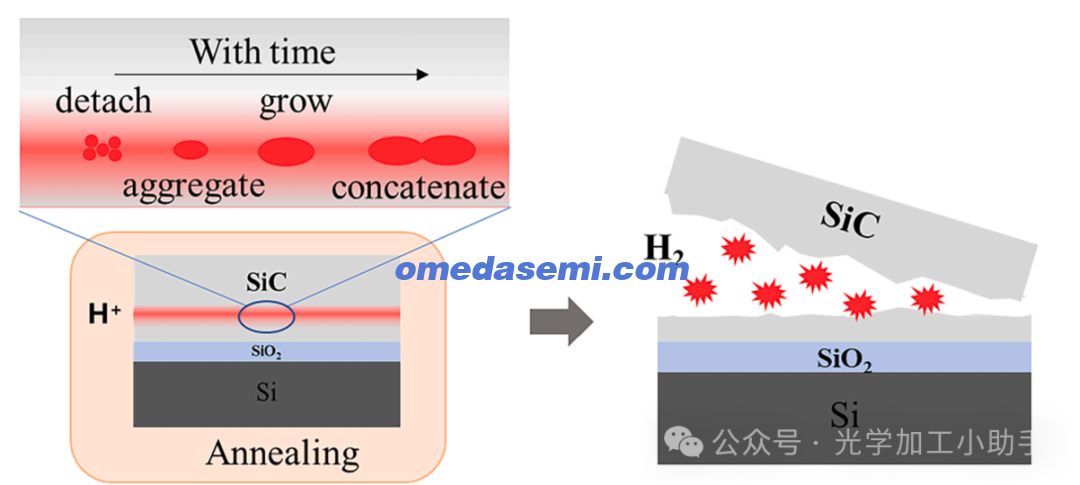 图6. 缺陷演变导致SiC薄膜剥离的示意图。
图6. 缺陷演变导致SiC薄膜剥离的示意图。
缺陷演变导致剥离的过程:
(1) 脱离:H+在热激发下从晶格捕获位置脱离,形成分散在晶格中的H2分子,导致晶格膨胀。
(2) 聚集:H2聚集形成更大的气体分子,进一步膨胀晶格。
(3) 生长:气体分子的持续生长导致晶格破裂,导致非晶化,并形成微腔和气泡。
(4) 连接:气泡互相连接形成裂纹,最终导致SiC薄膜的整齐劈裂。
3.5. 分子动力学模拟
为了研究不同热激发条件下薄膜劈裂行为的差异,使用分子动力学模拟分析了不同温度下SiC的应力-应变行为,如图7所示。分子动力学模拟广泛应用于实验中的定性分析。

图7. 分子动力学模拟结果
(a) SiC在应力下的三个阶段变化;
(b) 应力-应变曲线。
图7(a)展示了SiC在应力下的三阶段变化,分别为弹性变形、断裂和劈裂。图7(b)展示了700°C和780°C下的应力-应变行为曲线。模拟结果显示,在700°C下,SiC晶体断裂所需的应变和压力显著大于在780°C下的情况。SiC的剥离压力是由内部H+聚集和H2生长提供的,这意味着气泡成核点需要更多的H+聚集和生长才能在较低温度下实现剥离。最终,导致晶格破裂的气泡成核点数量在较低温度下减少。当退火温度为780°C时,由于较大的热激发,H+更容易从晶体的捕获位置脱离,SiC晶体的晶格需要较低的压力才能断裂,最终在高退火温度下形成大量的气泡成核点。700°C和780°C下气泡成核速率的差异导致了气泡生长和晶体劈裂行为的不同,从而造成薄膜表面形貌的差异。
结合缺陷演变模型和分子动力学模拟结果,可以对不同热激发条件下导致不同表面形貌的劈裂行为差异进行以下解释,如图8所示。
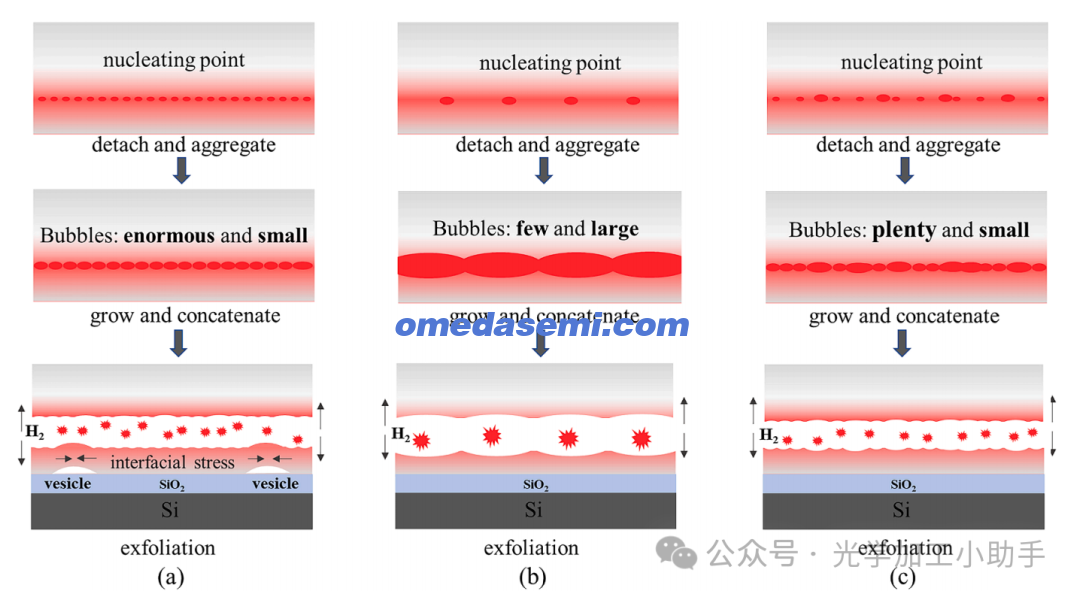 图8. 在不同退火参数下H+成核和气泡生长的示意图:
图8. 在不同退火参数下H+成核和气泡生长的示意图:
(a) 780°C退火10小时;
(b) 700°C退火60小时;
(c) 700°C退火20小时 + 740°C退火20小时。
当退火温度较高时,如图8(a)所示,由于充足的热激发,H+积聚层中形成了大量的气泡成核点,在气泡生长过程中,大量气泡迅速连接在一起,形成横向扩展的裂纹,从而导致平坦表面。然而,在高温下薄膜剥离的瞬间,原始的应力平衡被打破,过高的温度使得SiC薄膜受到较大的界面压应力,产生大量表面小泡,如图2(a)所示,因为SiC的热膨胀系数大于Si的【11】。当在较低温度下退火较长时间时,成核点较少,如图8(b)所示。随着退火时间的增加,大量H+不断聚集到已形成的成核点,使得气泡生长并最终互相连接。图2(b)所示的坑洼薄膜表面是由少数大气泡的连接劈裂行为造成的。优化的退火温度主要是通过较低温度退火预先演变缺陷到一定程度,有利于应力释放,然后进一步提高退火温度,在更大的热激发下形成更多的H+成核点。巨大的H2气泡的生长和相互连接实现了SiC薄膜的整齐劈裂,从而形成大面积平整的薄膜,如图2(c)和图8(c)所示。
4. 结论
研究了SiC薄膜在CIS技术制备过程中,H+注入缺陷的热演变及不同热激发条件下SiC薄膜转移过程中的晶体劈裂行为。H+注入在SiC晶体中引入了大量的晶格缺陷和堆垛层错,形成混乱的原子排列,并产生了较大的晶格应力。缺陷的演变过程可以简化为四个阶段:脱离、聚集、生长和连接。结合分子动力学模拟结果和缺陷演变模型,导致不同退火热激发下表面形貌差异的劈裂行为可以归因于不同的H2气泡成核速率。根据理论分析,改进了热处理工艺,并实现了CIS技术中SiC单晶薄膜转移过程中的整齐劈裂。
文章:The evolution of H+ implantation induced defects and the different cleavage behaviors under different thermal excitation in 4H-SiC during Crystal-Ion-Slicing technology
作者:
Dailei Zhu a, Wenbo Luo a,b,*, Gengyu Wang a, Limin Wan a, Yuedong Wang a, Shitian Huang a, Yao Shuai a,b, Chuangui Wu a,b, Wanli Zhang
单位:电子科大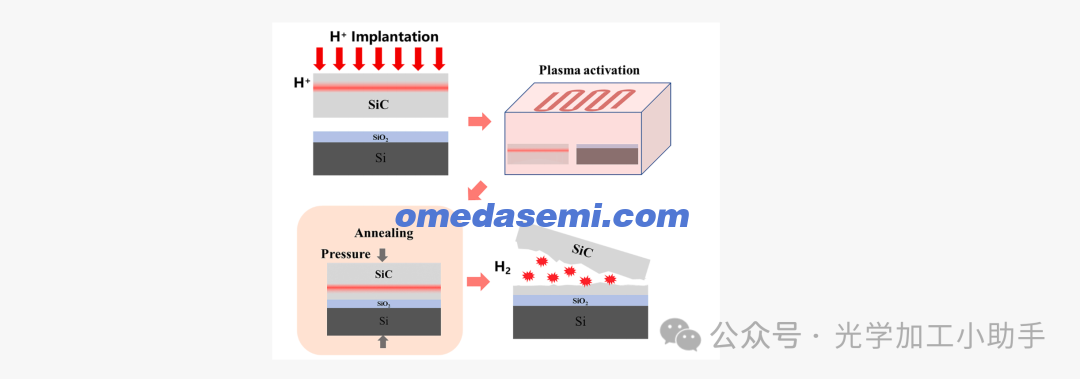



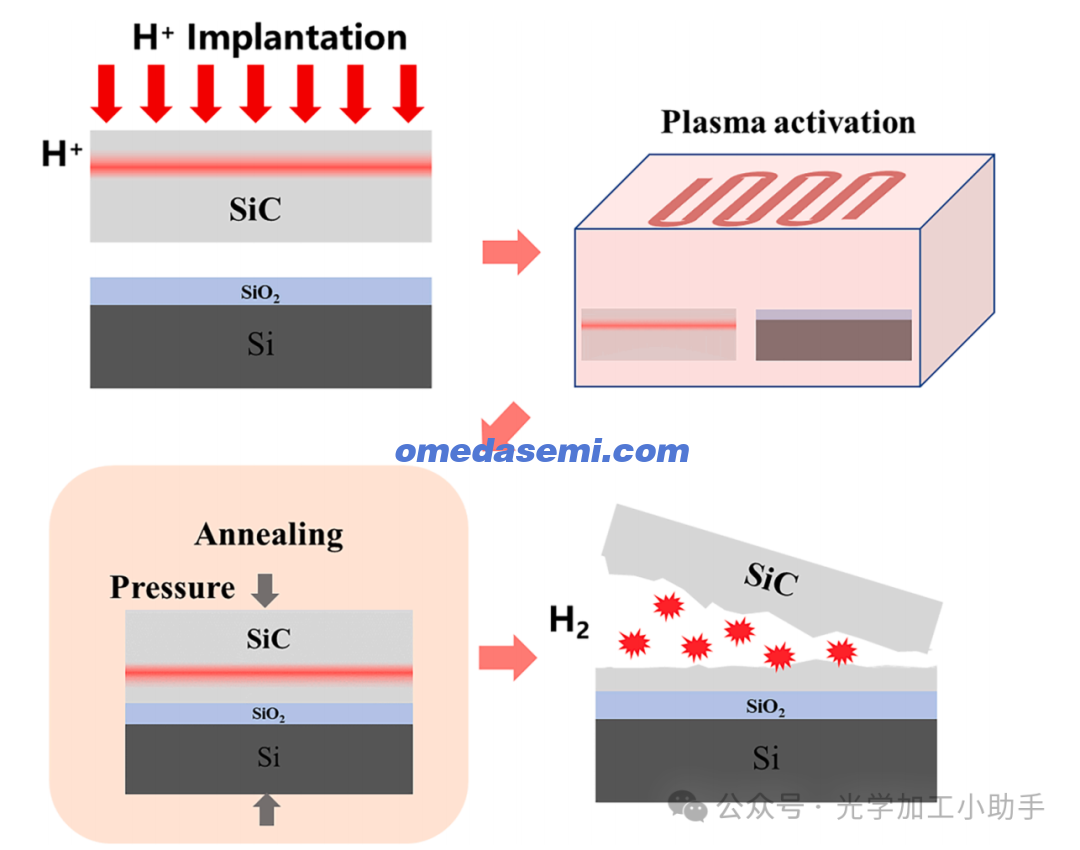 图
图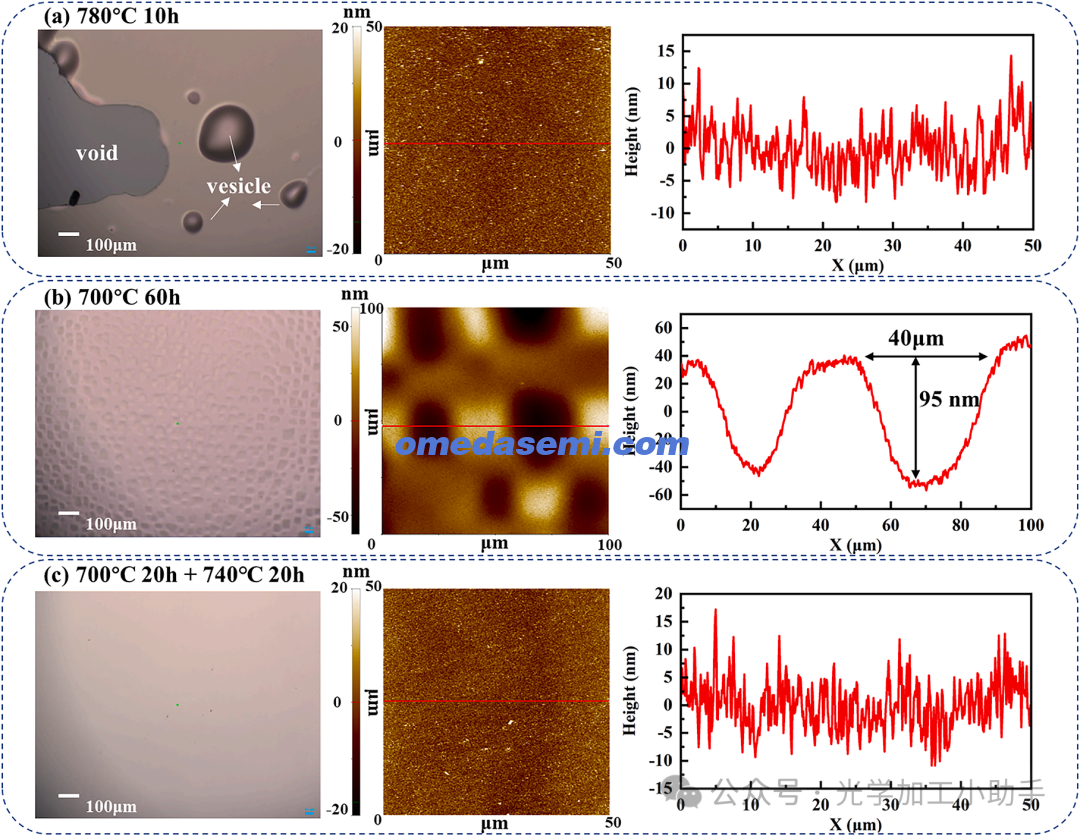
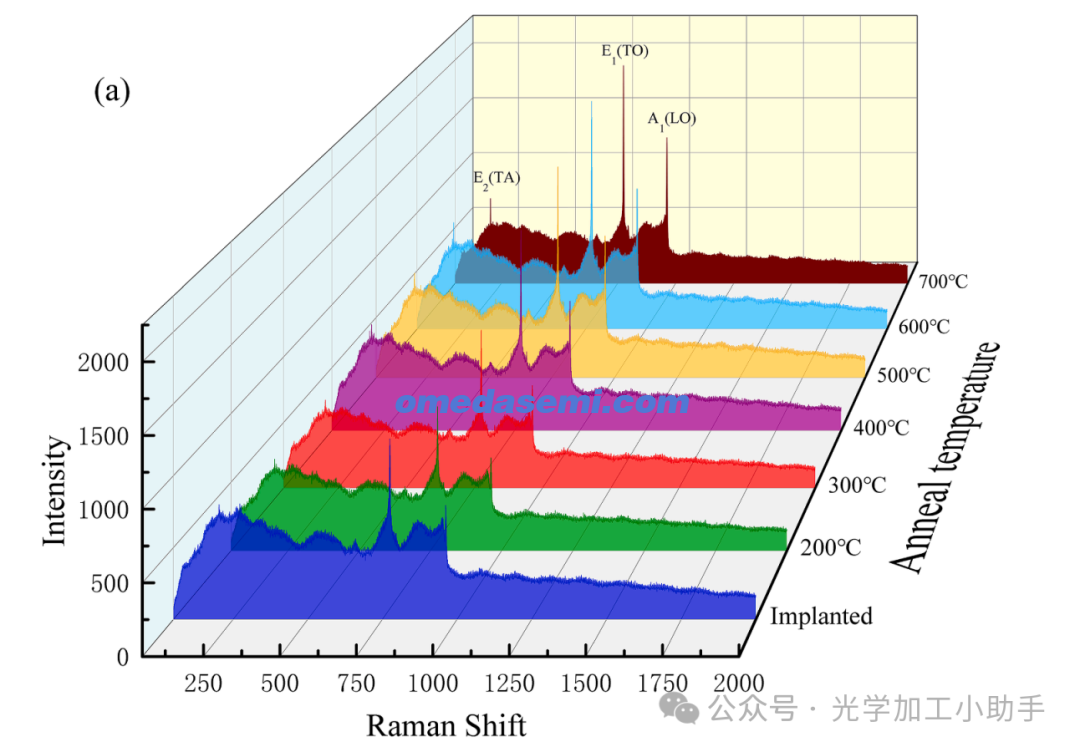





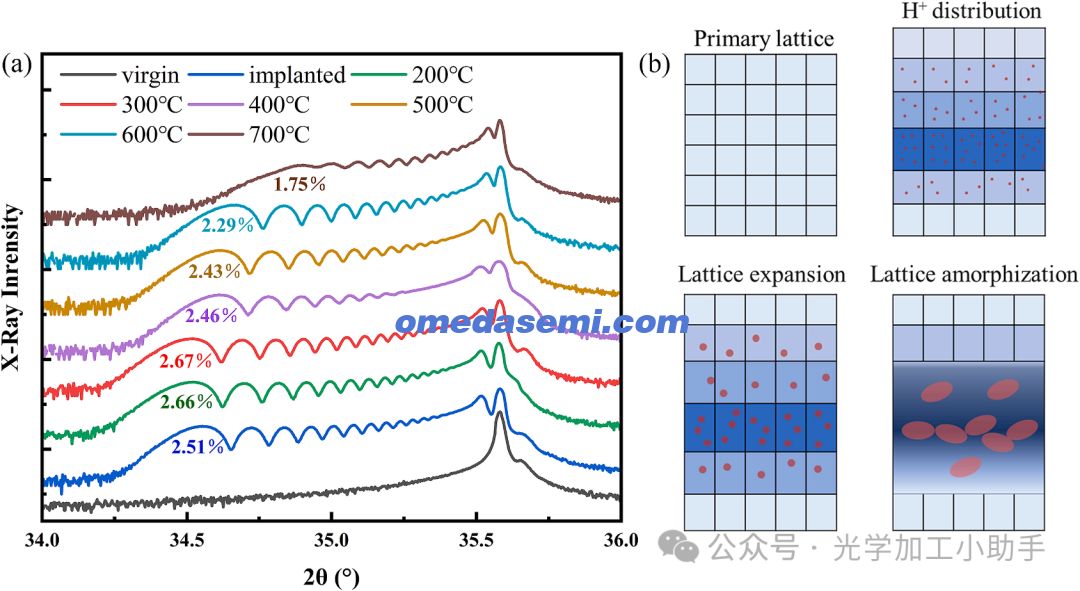 图
图 图
图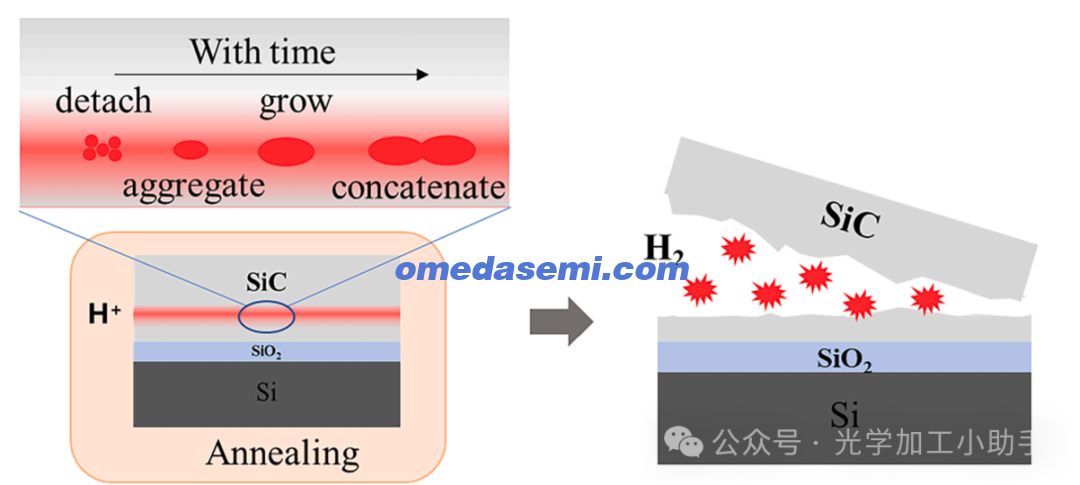 图
图
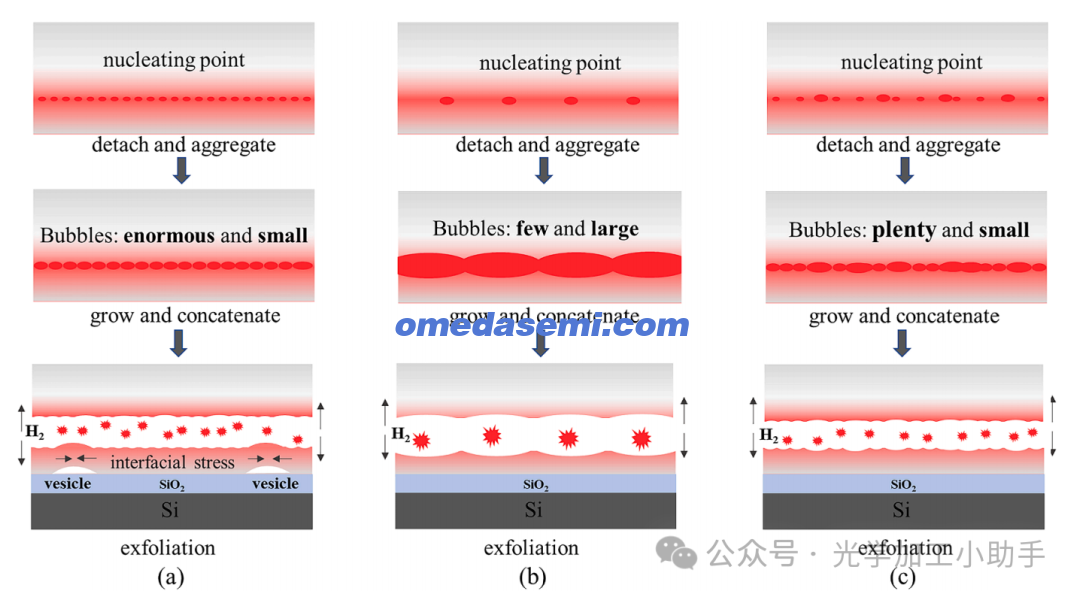 图
图