划重点:金刚石刻蚀加工
#最小线宽150nm #最大刻蚀深度 2um #侧壁垂直度85-87度
应用场景:金刚石光子晶体等等
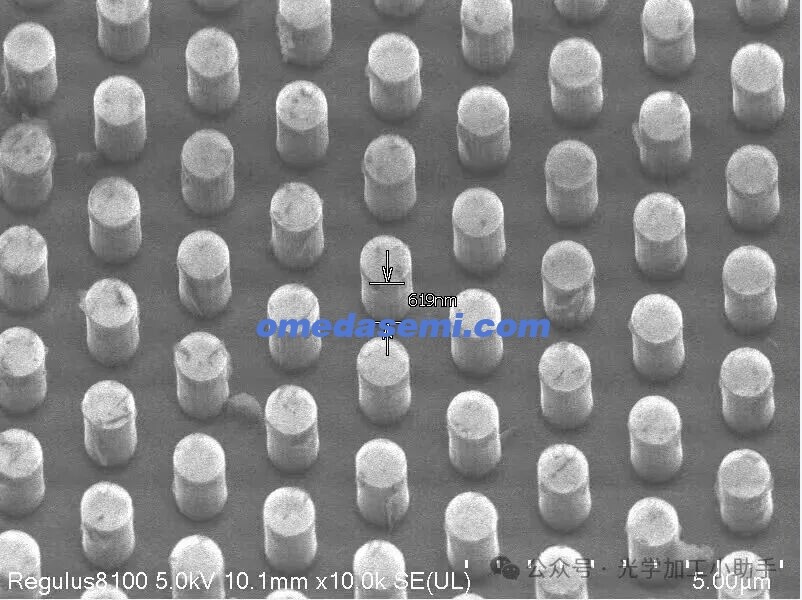
许多量子网络应用需要高效的光子接口与量子存储器连接,这些接口必须能够大规模生产且具有高良率。合成钻石为实现这一技术提供了独特的潜力,因为它包含能够保持相干光学接口和长时间自旋相干的颜色中心,并且能够在纳米光子结构中发挥作用。在这里,我们报告了一种技术,能够实现薄膜钻石的晶圆级加工,该技术结合了离子植入和膜剥离、高质量的过生长、定向颜色中心植入,以及串行高通量热压接合,良率接近于1。这种薄钻石膜在半导体基底上的定向沉积促进了光子晶体腔与硅空位(SiV)量子存储器的一致集成。我们展示了SiV与光子的可靠强耦合,协同效应接近50。此外,我们还展示了可以在多个膜之间可靠地制造光子晶体腔,这些膜被粘接到同一处理芯片上。我们的平台实现了模块化制造,其中光子层可以与功能化基底集成,基底上包括电子控制线路,如用于微波传输的共面波导。最后,我们实现了具有亚分贝插入损耗的被动光学封装。这些进展共同为大规模组装光学可寻址的量子存储器阵列铺平了道路,这些阵列是模块化光子量子互连的关键构建块。
划重点--销售晶圆和加工SOI晶圆:--220nm薄膜/ 3um厚膜-3umSIO2-675um
ALOOI晶圆;--氧化铝薄膜晶圆,键合工艺和镀膜工艺
TAOOI晶圆--氧化钽薄膜晶圆,镀膜工艺
SINOI晶圆--超低损耗氮化硅薄膜晶圆,210nm-300nm-400nm-800nm
SICOI晶圆;新型量子光学平台500nm-700nm-1um
8寸LTOI晶圆批量供应;铌酸锂的有力的竞争对手,薄膜钽酸锂晶300600
6寸X切Z切掺镁薄膜铌酸锂晶圆 ,厚膜 3um 5um 和 薄膜 100-600nm
8寸LNOI晶圆;8寸LNOI助力更大规模薄膜铌酸锂产品量产
流片: 6寸 氮化硅 铌酸锂 硅光 超高性价比流片, 1个BLOCK的价格买一整片晶圆
划重点--全国产-超高性价比-6 寸硅光-氮化硅-铌酸锂流片白皮书
我们为客户提供晶圆(硅晶圆,玻璃晶圆,SOI晶圆,GaAs,蓝宝石,碳化硅(导电,非绝缘),Ga2O3,金刚石,GaN(外延片/衬底)),镀膜(PVD,cvd,Ald,PLD)和材料(Au Cu Ag Pt Al Cr Ti Ni Sio2 Tio2 Ti3O5,Ta2O5,ZrO2,TiN,ALN,ZnO,HfO2。。更多材料),键合(石英石英键合,蓝宝石蓝宝石键合)光刻,高精度掩模版,外延,掺杂,电子束光刻等产品及加工服务(请找小编领取我们晶圆标品库存列表,为您的科学实验加速。
请联系小编免费获取原文

I. 引言
在过去40年中,利用晶圆级制造半导体材料对经典计算和电信技术的快速进步至关重要。许多量子技术,从计算到网络再到传感,也将从高质量、高良率的晶圆级制造中在性能和规模上获得类似的好处[1]。量子设备的晶圆级制造的一个示例应用是量子存储器。存储器可以用于通过互连通道连接许多个别的量子处理单元,利用量子存储器作为网络缓冲区来补偿通道损失[2]。这种方法的可扩展性依赖于制造大量高质量量子存储器的能力,这使得固态存储方法尤其引人注目。然而,晶圆级制造方法仅直接适用于一小部分材料,阻止了许多拥有最有前景量子存储器的材料以经济可行的方式大规模生产[3,4]。
合成钻石就是一个长期以来被认为具有独特光学、量子和机械特性的材料,但由于无法以晶圆级的规模、足够低的应变和缺陷密度来生产,限制了其在量子技术应用中的使用。这一制造瓶颈减缓了基于钻石的量子传感、计算和通信技术的部署,而这些独特的材料特性正是支撑这些技术的[5]。
特别是,钻石是量子传感器实现的领先平台之一[6,7],并且是高效接口的量子存储器的生产平台,这些存储器是量子网络实际应用的关键,因为它们使得“重复直到成功”协议成为可能[8,9]。基于钻石中的IV族空位中心的光学活性自旋缺陷因其结合了高度相干的光学接口和长时间的自旋相干时间[10,11],以及具有最小化光谱扩散的倒易对称性的关键优势,成为了突出材料[12]。量子网络节点的性能不仅取决于每个通道的存储保真度、效率和带宽,还取决于并行存储通道的总数[4]。大规模生产多通道钻石存储器设备将标志着迈向模块化架构的一大步,为实用规模的量子计算机以及盲量子计算[13]、长基线望远镜[14,15]和分布式传感[16,17]等新应用铺平道路。
高质量钻石光子器件的制造长期以来依赖于定制的纳米制造技术,主要在小型、独立的钻石块中进行,这限制了所生产技术的良率和规模。一种角度刻蚀技术[18–20]已被用于从电子级大块钻石中雕刻出设备,使得量子光学和纳米机械实现的概念验证成为可能。不幸的是,这些大块雕刻技术与光子集成电路的代工制造不兼容。准各向同性钻石下切技术[21–25]也被用来生产单个高质量器件,但由于粗糙度限制的品质因子和强烈的晶体学与纵横比依赖的刻蚀行为,扩展此方法仍然具有挑战性。
在这里,我们展示了一项重大进展,迈向量子存储器的大规模生产,具备确定性、高效的光学接口,并与功能化的电子控制线路基底进行异质集成(图1)。
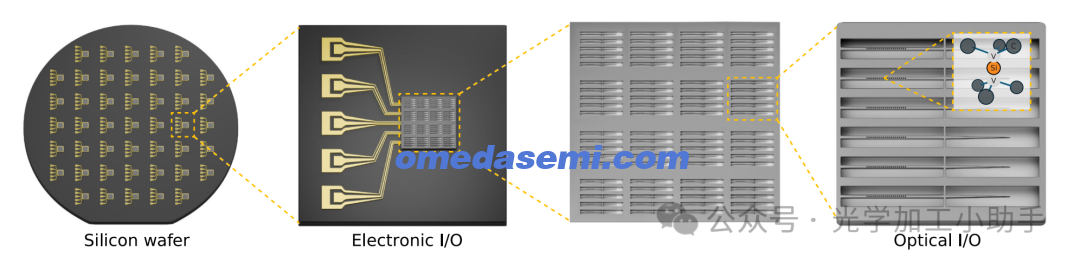
图1. 可扩展钻石量子存储平台示意图。晶圆级矩阵芯片,功能化了电子输入输出(I/O)控制线路,如用于硅空位(SiV)量子存储器自旋控制的共面波导。钻石薄膜沉积到每个独立的芯片上,并使用标准的自上而下纳米制造技术创建纳米光子器件矩阵。高质量的光子晶体腔和锥形波导耦合器提供了高效的光子I/O接口,用于嵌入式SiV量子存储器的光学跃迁,从而实现确定性的自旋-光子相互作用。
我们的方法包括高良率沉积和并行化图案化薄膜钻石矩阵,这些薄膜钻石被沉积在具有多个预图案化单个芯片的晶圆上。这项技术代表了朝着可扩展制造迈出的关键一步,能够在单个制造过程中制造出数百个钻石设备,而不需要使用晶圆级的量子级钻石。
我们的平台利用通过结合离子植入和剥离技术与高纯度钻石过生长[26,27]创造的均质单晶钻石薄膜。这些薄膜钻石已被证明适合承载具有寿命限制的光学跃迁和长时间自旋相干的量子存储器[28]。此外,关键的量子存储器组件,包括光学接口,如光子晶体腔[29]和慢光波导[30],以及自旋控制[31],已经在单个钻石薄膜中得到了演示。
为了展示我们的钻石薄膜所支持的大规模制造能力,我们开发了一个强大的制造流程,能够生产接近完全良率的高质量设备。我们报告了几个方向的重大进展,包括高质量、高均匀性的钻石过生长、通过纳米孔精确植入颜色中心、并行化的电化学刻蚀和单步毫米级膜沉积,并通过金属热压接合实现接近单位的良率。我们展示了将数十个膜沉积到同一个处理芯片上,这一过程可以扩展到全晶圆再组装,其中许多个别膜被平铺以覆盖晶圆表面,进行进一步的处理。
确定性硅空位(SiV)记忆与光子相互作用的高协同接口可以在此平台上常规实施。我们证明了可以可靠地并行制造光子晶体腔,对于粘接到同一处理芯片的多个膜,保持共振波长的小范围分布,并保持高品质因子。
我们的流程通过将钻石中的光学组件制造与基底中的功能化层分开,从而简化了制造过程。设备的应用和性能可以通过引入具有不同电子或光子组件的层来调节。重要的是,为了创建缺陷中心所需的高温处理与电子或光子组件(如电子控制线路)前端制造过程中较低温度容忍度的制造过程分开。此外,基底与膜上的设备之间的对准可以通过光刻完成,从而消除了在挑选和放置集成步骤中对纳米级对准的需求[24]。
当与晶圆级制造结合时,我们的方法为实现基于存储的量子互连节点的大规模集成铺平了道路,这些节点具有许多高效的光子和电子通道。我们的平台代表了实现实用规模量子计算机的关键一步,基于离子[32]或原子[33]的个别量子处理单元的高效互联。
II. 结果
A. 高良率制造高质量钻石薄膜
我们实现了一个高良率、可扩展的制造流程,用于生成与半导体基底粘接的高质量钻石薄膜。我们的过程结合了离子植入和膜剥离、高纯度钻石过生长、量子存储器的纳米孔植入和翻转芯片热压接合,以制造高良率的钻石薄膜和光子器件[图2(a)(i)-(x),方法]。
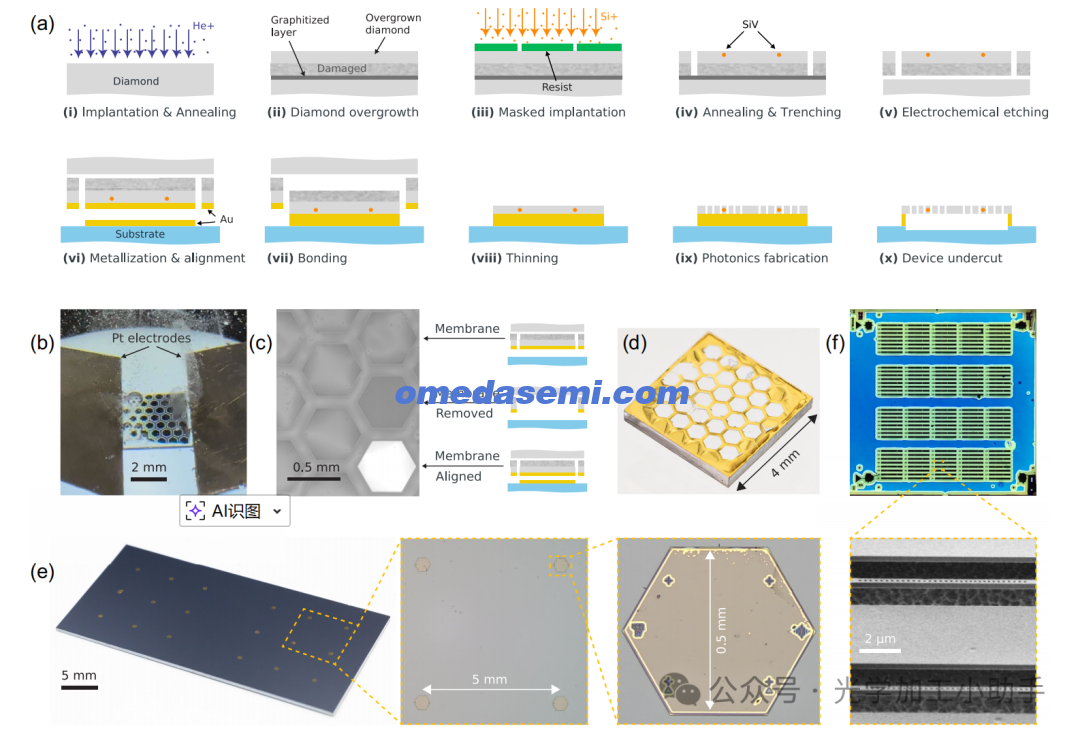
图2. (a) 钻石光子器件的制造过程流程 (i) 通过高能氦离子植入和高温退火的结合生成一个在特定深度的石墨化层;(ii) 随后进行高纯度钻石过生长;(iii) 通过使用纳米孔在预定位置植入硅来创建SiV中心;(iv) 随后的高温退火;(v) 在钻石中蚀刻出一个固定的薄膜阵列,便于通过电化学刻蚀去除石墨化层;(vi) 钻石表面进行金属化处理;(vii) 将各个薄膜通过翻转芯片粘接到具有对应金属化粘接垫的硅基底上;(viii) 将薄膜削薄,去除损坏的钻石层;(ix) 光子晶体腔的制造,与植入的SiV中心对齐;(x) 通过金属蚀刻剂和氟化氢酸的组合进行下切处理。
(b) 牺牲性石墨化层的电化学刻蚀;
(c) 对齐翻转芯片粘接过程的光学显微照片。图像叠加显示了金属化的钻石薄膜阵列和基底上的对应粘接垫,便于精确对准。通过移动基底并对齐阵列中的各个薄膜,依次沉积各个薄膜;
(d) 转移25个薄膜后的母钻石块;
(e) 重新构建的3 × 6矩阵的偏振照片,其中的六边形薄膜(0.5 mm)按5 mm间距排布,由图(d)中的钻石经过18次连续转移创建。放大图像使用显微镜拍摄;
(f) 制造的光子晶体腔阵列的光学显微照片和两个代表性光子晶体腔设备的扫描电子显微照片。
我们报告了相对于之前报告的方法[26,27]的几项重大进展。首先,通过在离子植入过程中遮掩钻石基底的边缘,我们保留了一个坚固的钻石框架,这个框架在下切和粘接过程中锚定了膜[图2(a),(i)]。其次,针对高纯度钻石的同质外延生长条件进行了系统研究,结果一致地创造出表面粗糙度低(< 0.2 nm RMS)且厚度变化小(< 20 nm)的钻石层[图2(a),(ii),方法]。最后,通过纳米孔定向植入SiV颜色中心[图2(a),(iii)],显著减少了意外创建的弱耦合SiV中心的背景荧光,从而提高了最终设备的良率。
为了准备一个与晶圆粘接的钻石膜阵列,我们通过对准沟槽制造定义了一个带有固定边框的微膜阵列[图2(a),(iv)],这使得能够通过电化学刻蚀同时对整个膜阵列进行下切[图2(a),(v)和2(b)]。我们将表面金属化,并使用对准的翻转芯片热压接合[图2(a),(vi)],以确定性地将膜从母钻石转移到处理芯片上,实现高通量(每次接合< 1分钟)和高良率[图2(a),(vii)]。最后,通过首先将膜厚度减薄至所需厚度[图2(a),(viii)],采用标准的自上而下半导体制造技术[图2(a),(ix)],并最终使用湿化学刻蚀技术下切结构[图2(a),(x)]。
我们的高通量转移过程是迈向晶圆级制造的关键步骤,使得通过在单个硅处理芯片上沉积多个膜阵列,能够创建大规模设备阵列,而无需更换基底或母钻石。在这个演示中,我们定义了一个六边形膜阵列,横向尺寸为0.5毫米,排列成蜂窝状晶格,并通过一个框架弱连接。当母钻石被撤回时,固定点断裂,膜被粘接住。接下来,通过对准下一个粘接垫,将下一个膜粘接到处理芯片上[图2(c)]。这一接合过程最多可以在一个母钻石块上重复25次[图2(d)]。可变形金属中间层减轻了粒子污染和表面不规则性(如丘状或凹坑)的影响,这些不规则性可能在过生长过程中形成。图2(e)展示了一个3 × 6的膜阵列,间距为5毫米,依次沉积,展示了我们工艺的接近单位良率。
B. 实现高协同接口至量子存储器
在膜粘接到基底后,我们通过精确对齐光子晶体腔与植入的颜色中心的制造,创建了一个确定性、低背景的光子接口,用于钻石量子存储器。在粘接后,膜的厚度被削减到160 nm,表面粗糙度低于0.3 nm rms。然后,我们使用标准的自上而下制造方法[图2(f),方法],制造了一个4 × 32的光子晶体腔阵列。
我们的设备实现了用于控制钻石中SiV颜色中心的高协同接口,展示了我们材料的卓越质量。为了表征,我们使用可移动的锥形光纤探针在温度为20 mK的稀释制冷机中测量腔体的反射光谱[图3(a)]。

图3. (a) 实验设置的示意图和SiV中心的简化能级结构;
(b) 代表性腔体反射光谱的激光扫描测量。腔体共振通过与协同度为46的SiV中心耦合进行调制;
(c) 在3个芯片上测量的12个SiV在腔体中的协同度统计数据;
(d) 显示自旋依赖的设备反射率的反射光谱;
(e) 在弱光照下SiV自旋的量子跳跃。
我们在设备上沉积氮冰,来将腔体共振频率红移,随后使用激光控制氮的升华,将腔体调谐到与嵌入的SiV中心共振[34]。通过扫描窄线宽激光,我们解决了尖锐的光谱特征,揭示了与腔模式良好耦合的多个SiV中心[图3(b)]。我们当前的自旋光子门协议利用这种光谱非均匀性,从每个腔体中选择性能最佳的SiV颜色中心[4,35]。通过拟合腔体反射光谱的调制[2],我们提取出腔体的协同度C = 4g² / (κtot · γSiV) = 46。假设SiV中心的频率为fSiV = 406.755 THz,其寿命限制的线宽为γSiV / (2π) = 94 MHz,而腔体的总线宽为κtot / (2π) = 11.46 GHz。通过拟合,光子-原子耦合强度为g / (2π) = 3.52 GHz。
图3(c)展示了我们通过共聚焦光致发光(PL)测量在4 K制冷机中跨3个不同芯片预选的设备的协同度分布。在测量的12个设备中,有10个SiV中心与腔体的协同度C > 5,证明我们可以确定性地创建高效的自旋光子接口,其中腔体的非共振反射较高,且自旋态之间的反射对比大,能够抵抗光谱扩散的影响。我们将协同度的变化主要归因于缺陷相对于腔模式最大位置的随机空间分布所导致的发射器-腔体耦合强度的差异[36]。
接下来,我们沿SiV轴施加外部磁场,以提升SiV自旋态的简并性[见图3(a)中的能级图示]。磁场的精确对准将决定SiV跃迁至自旋态的激发态衰减分支比[11]。由于基态和激发态的g因子不同,不同自旋态的光学跃迁频率也不同,从而导致自旋状态依赖的腔体反射[图3(d)]。通过将激光锁定在两个自旋态之间最大反射对比点,我们观察到量子跳跃,从中推断出自旋弛豫时间。在沿SiV轴优化的磁场对准下,我们发现T1 = 32 s,在弱光照条件下设定了实际T1时间的下限[图3(e)]。鉴于测量的T1时间依赖于磁场对准,我们推测主要的弛豫通道是由我们用来探测自旋状态的弱激光照射引起的。T1的最终极限取决于声子引起的弛豫通道的速率,这些速率取决于外部磁场的大小和方向、静态晶体应变以及温度[37]。
C. 光子器件的并行制造
为了确认我们的平台与晶圆级生产的兼容性,我们在四个钻石膜上制造了并行阵列(4 × 32)光子晶体腔,这些膜在同一个处理芯片上间隔15 mm粘接[图4(a)]。我们测量了质量因子和共振波长,以捕捉由膜和制造过程中的变化引起的设备性能差异。我们专注于测量每个膜上的48个设备子集[图4(a)],以限制所需测量的数量并排除已知的邻近效应偏移。
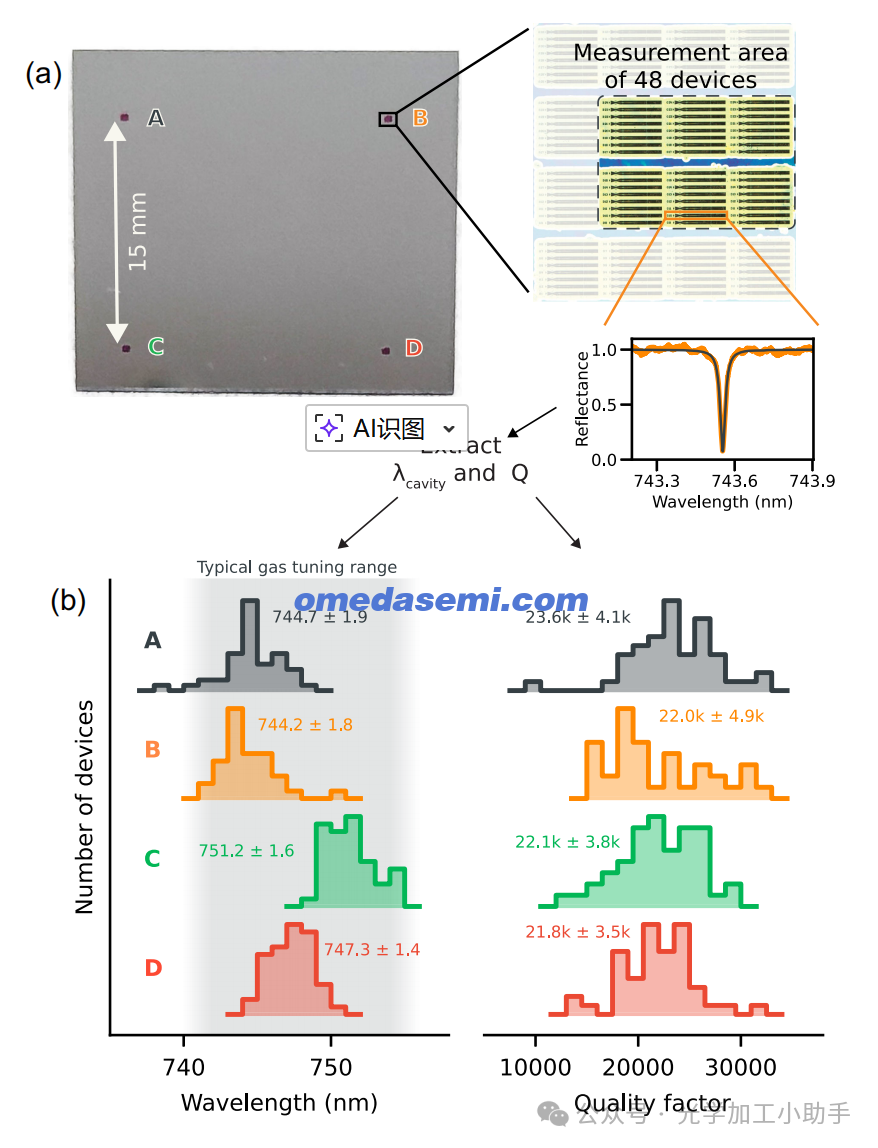
图4. (a) 微观照片显示4个钻石薄膜粘接在同一处理芯片上,间隔15毫米,用于并行制造薄膜器件阵列;放大图显示制造完4 × 32阵列光子晶体腔后的薄膜;代表性腔体反射扫描,得到质量因子Q = 3.20 × 10⁴,波长λcav = 743.5 nm;
(b) 在4个不同薄膜上,同一块48个设备的腔体共振波长和质量因子的直方图。
图4(a)展示了一个代表性设备的反射测量,其质量因子Q = 3.20 × 10⁴,波长λcav = 743.5 nm,接近临界耦合,反射对比度为92.5%。我们通过将超连续激光耦合到钻石波导中,并通过锥形光纤接口记录宽带反射光谱,确定了设备的质量因子和共振波长。
我们通过展示所有制造的膜上平均质量因子超过2 × 10⁴,并且共振波长的分布小于2 nm,验证了我们设备的高质量和制造的可重复性[图4(b)]。我们发现不同膜的波长分布分别为(744.7 ± 1.9)、(744.2 ± 1.8)、(751.2 ± 1.6)和(747.3 ± 1.4) nm,且相应的Qtot因子分布为(2.36 ± 0.41) × 10⁴、(2.20 ± 0.49) × 10⁴、(2.21 ± 0.38) × 10⁴和(2.18 ± 0.35) × 10⁴。腔体波长的分布范围远小于大约10 nm的低温调谐范围,这一调谐范围是通过氮气冷凝技术提供的,从而在整个晶圆上实现了接近单位良率的可用共振腔。这与角度刻蚀设备相比是一个显著的进展,因为在一个芯片内的波长分布如此之大,通常只有约10%的制造腔体位于SiV中心的光学跃迁调谐范围内。
我们注意到,鉴于有足够的材料用于优化过程,制造过程中仍有几项潜在的改进。通过调整光刻设计中的偏移量,可以进一步实现波长的全局偏移。通过添加见证芯片,可以补偿制造过程中的逐次变化,这得益于我们膜制造技术的高通量。通过基于制造过程中的计量步骤调整输入设计,可以进一步改善膜之间的变化,以补偿钻石膜的厚度变化、光刻胶和刻蚀硬掩模的差异[38]。总体而言,基于先前技术的钻石光子器件优化通常进展缓慢或成本较高,因为优化运行通常需要代理制造测试或大量样本。在去除材料瓶颈并为晶圆级制造铺平道路后,我们预计该材料平台将在专用代工环境中进一步改进,并将具有接近单位的良率。
D. 膜与功能化基底的集成
我们通过展示与功能化基底的集成以及基于我们先前展示的锥形光纤技术[39,40]的高效光子封装,展示了使用我们的制造技术实施高效、完全封装的钻石量子存储器的潜力。我们将植入氮空位中心的钻石薄膜沉积在具有埋置共面波导(bCPW)的硅基底上,以用于微波传输,硅基底具有1 μm厚的二氧化硅包层[图5(a)和5(b)]。

图5. (a) 埋置共面波导(bCPW,顶部)和粘接在bCPW上方的钻石薄膜(底部)的示意图截面。通过在薄膜中制造的接入孔进行金属蚀刻,部分去除Au粘接层,从而实现对植入的NV中心的高效自旋驱动。
(b) 具有9条独立控制线的代表性bCPW样品的显微照片。
(c) 通过bCPW驱动的NV中心的光学检测磁共振和
(d) Rabi振荡,样品与图(b)中显示的相似,其中薄膜粘接垫部分下切,以去除bCPW线路和钻石薄膜之间的所有粘接层金属。
这些基底在晶圆级制造并使用化学机械抛光进行平坦化,从而实现高通量和高良率生产。钻石薄膜可以并行粘接到多个不同的共面波导设备上,然后集体进行图案化,进一步提高集成钻石光子器件(如传感器)的生产速率。
作为概念验证,我们通过使用bCPW产生的微波脉冲驱动植入的NV中心的自旋跃迁(方法)。通过调整外部磁场,我们隔离并测量了具有相同方向的小规模NV中心集合的光学检测磁共振[图5(c)]。通过应用共振微波脉冲,我们实现了通过集成的共面波导控制自旋[图5(d)]。我们在连续驱动下测量了NV自旋的拉比振荡。施加的常磁场在空间上是非均匀的,因此,正如预期的那样,对于空间分布的NV中心集合,拉比衰减相对较快,衰减常数为0.93 μs。施加15 dBm的微波功率得到tπ = 55 ns。以这样的微波场强度,每个输入功率,bCPW应立即适用于集成SiV量子存储器设备的实现。重要的是,bCPW通过显著减少微波驱动所产生的热负载,能够并行驱动多个设备,而不必像在钻石表面上图案化CPW那样[41]。
利用模块化制造和钻石薄膜与功能化基底集成的潜力,标志着量子存储器实际应用的重大进步。在先前的方法中,用于微波传输和自旋控制的片上共面波导(CPW)制造需要在光子制造完成后进行后续制造步骤,这增加了复杂性并降低了设备的良率。此外,对准的光刻和蒸发步骤由于额外的处理步骤,固有地存在损坏设备的风险。此外,由于金属轨迹直接制造在钻石薄膜上方,热量难以散发,因此并行驱动多个设备具有挑战性。
为了进一步说明我们方法的可扩展性,我们展示了薄膜设备的高效光学封装,使设备在没有任何主动对准的情况下运行。
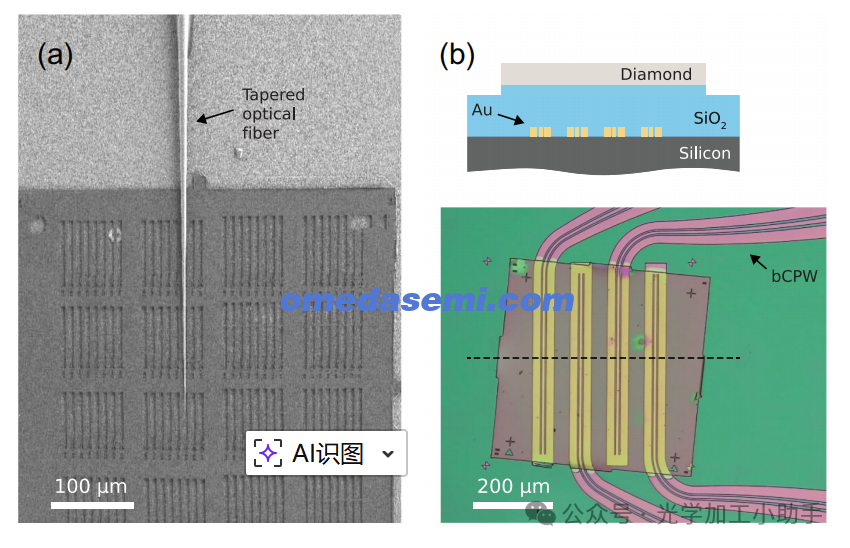
图6. (a) 封装设备的扫描电子显微镜图像,其中锥形光纤通过锥形波导耦合器永久连接到光子晶体设备上。
(b) 在bCPW芯片上实施氧化物连接,展示了无需金属接口层的完全代工兼容方法的可行性。底部:氧化物连接钻石薄膜的光学显微照片。顶部:光学显微照片中虚线所示的设备示意截面图。
图6(a)展示了一个封装设备的扫描电子显微镜图像,其中锥形光纤通过锥形波导耦合器永久连接到光子晶体设备上。这种光纤连接方法保持了与通过优化的主动对准技术实现的光纤到芯片耦合效率相当的效率。我们测量了系统的耦合效率为ηc ∼ 85% (< 1 dB损耗),通过将腔体反射与反射镜的反射进行比较。通过进一步优化,插入损耗可以降低到< 0.5 dB,如在角刻设备中所示[40]。
III. 讨论与展望
这项工作代表了高协同量子器件可扩展制造的重大进展。薄膜钻石平台结合了高良率的膜沉积、确定性颜色中心定位、高均匀性的光子晶体腔制造和微波控制。这些特点共同使得实现具有协同度C > 5的自旋-光子接口成为常规操作,展现了材料和工艺质量。在这些设备中,我们的最佳设备实现了非常高的协同度C ∼ 50,与固态平台上的最先进实现相当[2,42]。
我们强调,制造出接近单位良率的膜阵列以及在多个膜上并行制造具有所需特性的光子晶体腔的可扩展且稳健的制造方法,为晶圆级设备制造铺平了道路。我们报告了多个粘接膜上的高质量因子(Q ∼ 2 × 10⁴),以及每个膜内腔体共振波长的窄分布(< 2 nm)。我们预期,通过在制造过程中添加计量步骤,并将我们的工艺从共享用户设施转移到专用制造设施,可以消除膜之间的波长偏移。所展示的良率和均匀性标志着与先前定制技术相比的关键飞跃,后者受限于扩展性和可重复性。
除了高速微波控制,功能化基底将提供多个电子信号用于控制SiV量子存储器,例如通过应变调谐[43],并且可能启用更复杂的互补金属氧化物半导体电路,用于信号处理,兼容低温环境[44]。我们的平台通过与bCPW结构的集成,正如在薄膜钻石中对NV中心的微波控制所示,为大规模生产低成本、小尺寸、低重量和低功耗的量子传感器奠定了基础[45]。与bCPW的集成,再加上我们先前展示的高效光纤封装,能够实现完全封装、可电光寻址的量子存储架构。光学I/O的数量,由钻石膜的大小限制,可以通过与如锂铌酸盐或氮化硅等平台的异质光学集成显著提高。
在我们当前平台中使用金属热压接合提供了稳健的膜附着和高通量加工。通过氧化物连接,异质集成光子和电子组件将在bCPW基底上得到实现[图6(b)]。这种无金属集成方法显示出简化后续加工、提高连接界面的清洁度并扩展材料兼容性的潜力。我们预计,在代工级制造中,连接良率将接近金属热压接合的类似水平。
总之,我们的工作是实现晶圆级工业级集成量子存储器和传感器制造的重大步骤。我们平台的良率、性能和多功能性代表了构建可扩展量子网络和传感系统的关键推动力。我们预期,沿着氧化物连接路径的持续发展,以及与光子电路的集成,将使薄膜钻石成为未来异质量子技术中的核心材料。
附录
钻石薄膜制造
钻石薄膜是通过结合离子植入和剥离技术与高纯度钻石过生长来制造的。首先,单晶钻石被抛光,并通过高能氦离子植入(0.5 MeV,7度倾斜,5 × 10¹⁶ cm⁻²)在一个精确的深度创建一个亚表面石墨化层。我们在植入过程中遮掩钻石的边缘,从而得到一个坚固的钻石框架,这个框架在下切和粘接过程中固定薄膜。通过高温退火(1300°C,1 × 10⁻⁶ Pa,120分钟),将该损伤层转化为石墨。退火后,使用烟雾H₂SO₄ + KNO₃去除表面的石墨化层。然后,通过同质外延高纯度过生长,在其上生长一层高纯度钻石。该层的典型厚度为约0.5 μm,并且在钻石上具有较低的厚度变化[通常 < 10 nm/1 mm,图7(a)]和低表面粗糙度[< 0.2 nm rms,图7(b)]。
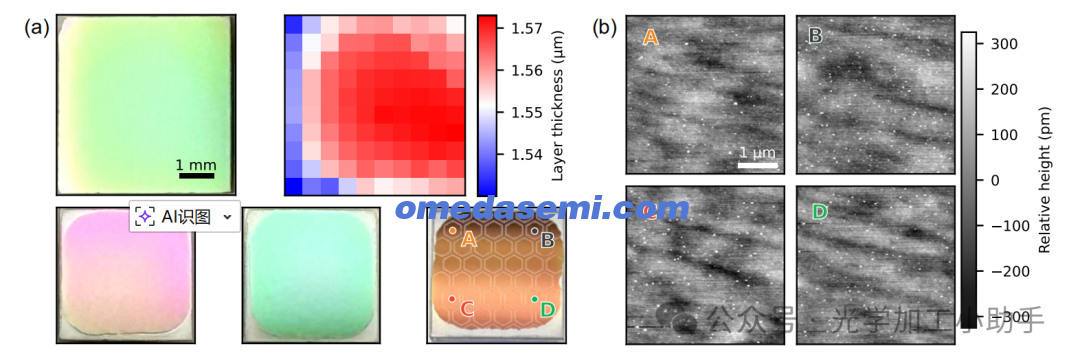
图7. (a) 上部:在牺牲钻石层上方的钻石薄膜厚度变化,记录于(左上)使用相干白光源和(右上)使用Filmetrics F3反射仪,揭示薄膜厚度为(1.54 ± 0.01)μm。下部:三种额外样品的相干白光源图像,薄膜厚度分别为(1.38 ± 0.01)μm、(1.33 ± 0.01)μm和(1.28 ± 0.01)μm(从左到右)。每个图像中的比例尺为1 mm。
(b) AFM测量结果,显示在(a)面板右下方样品的4个不同区域的生长钻石表面,样品经过沟槽制造,形成微薄膜阵列。样品的RMS粗糙度为< 0.15 nm。每个图像中的比例尺为1 μm。
制造对准标记,并通过对准的硅离子植入(²⁸Si,125 kV,1 × 10¹² cm⁻²)通过纳米孔引入SiV颜色中心,实现与光子器件的对准集成。
纳米孔(100 nm × 100 nm)在PMMA/MMA光刻胶堆叠中定义,SiV中心通过高温退火(1250°C,1 × 10⁻⁸ Pa,90分钟)生成,通常每个植入点生成2–3个SiV中心。然后,我们通过光刻在钻石中图案化沟槽,定义一个固定的微膜阵列。最后,我们通过电化学刻蚀[46]下切薄膜。在硅基底上使用光学光刻定义粘接垫,尺寸与钻石微薄膜相对应。接着,我们在钻石表面和粘接垫上沉积粘接材料,使用50 nm钛和100 nm金或二氧化硅。最后,采用翻转芯片粘接(Finetech Sigma)以低温(150°C)、低压(5 kPa)和短时间(15秒)确定性地粘接薄膜,且良率高。我们以单位良率和高通量(每次粘接<1分钟)沉积薄膜。为了达到适合光子集成的所需厚度(通常在100–300 nm之间),基底通过基于氧气的感应耦合等离子体反应离子刻蚀(ICP-RIE)被削薄。
纳米光子腔的制造
我们设计了具有二次锥形晶格常数的单面光子晶体腔。通过优化入射镜单元的数量,使其优先耦合到波导模式,从而通过锥形光纤探针提取光。使用等离子体增强化学气相沉积法沉积硅氮化物(SiN)硬掩模,然后旋涂ZEP520A光刻胶。光子晶体腔通过电子束光刻定义,并随后通过感应耦合等离子体反应离子刻蚀(ICP-RIE)与C4F8/SF6=H2气体混合物转移到SiN层上。去除光刻胶后,图案被转移到薄膜钻石中,使用基于O₂的ICP-RIE。然后,通过浸泡在稀氟化氢酸和金蚀刻液中,去除SiN掩模和下层金属粘接层,并通过氙氟化物(XeF2)对硅基底进行各向同性刻蚀,均匀下切器件。
埋置共面波导的制造
bCPW样品是在4英寸硅晶圆上使用金属剥离和氧化物沉积制造的。我们首先使用光刻,通过双层LOR/S1805光刻胶堆叠进行剥离图案化,并在两侧沉积100 nm金和10 nm铬作为附着层。接着,我们使用感应耦合化学气相沉积法沉积约2 μm的SiO₂,并通过化学机械抛光使表面光滑,减薄至约1 μm。通过氮离子植入(N⁺,50 keV,1 × 10¹² cm⁻²)并随后的高温退火(1250°C,10 × 10⁻⁸ Pa,90分钟),在钻石薄膜中深度约60 nm处创建NV中心。钻石薄膜被削薄至约300 nm,并通过图案化孔洞去除膜和bCPW线路之间的粘接金属层。
实验设置
用于mK纳米光子腔量子电动力学实验的方法和实验设置已在单独的出版物中详细描述[47]。所有测量都在温度为20 mK的稀释制冷机(BlueFors BF-LD250)中进行。该制冷机包括超导矢量磁铁(American Magnets Inc., 1-1-1 T)、定制的自由空间宽场显微镜,配有低温非球面透镜、压电定位器(Attocube ANPx101 和 ANPx311系列)以及光纤和微波穿透接口。使用气体冷凝和激光反调谐技术来调谐纳米腔共振。SiV-腔体系统通过光纤网络通过锥形光纤耦合器进行光学寻址[39,40],消除了使用自由空间光学的需求。
通过埋置共面波导(bCPWs)微波驱动NV中心的实验使用标准共焦显微镜设置进行。通过绿色激光二极管(Laes Electronics DLNSec 520)光激发一组NV中心,并通过600 nm二色光镜和670/70 nm带通滤光片过滤后,使用雪崩光电二极管(Excelitas SPCM 14/16)读取发射信号。我们使用时间标记器(Swabian Time Tagger Ultra)收集APD计数。为了生成微波驱动和激发/检测门控的脉冲序列,我们使用脉冲生成器(Swabian Pulsestreamer 8/2)。我们使用信号发生器(R&S SMB100B)以及微波开关(CMCS0947A-C2)生成用于ODMR和拉比测量的微波信号。
文章名:Scalable Photonic Quantum Interconnect Platform
作者:Daniel Riedel ,1,* Teodoro Graziosi,2 Zhuoxian Wang,3 Chawina De-Eknamkul ,1 Alex Abulnaga,1Jonathan Dietz,1 Andrea Mucchietto,1 Michael Haas ,1 Madison Sutula ,1 Pierre Barral ,1 Matteo Pompili ,1Mouktik Raha ,3 Carsten Robens,1 Jeonghoon Ha ,1 Denis Sukachev ,1 David Levonian ,1 Mihir Bhaskar ,1Matthew Markham ,2 and Bartholomeus Machielse 1,
单位:ionq&元素6&AWS