最深 300um,深宽比 7.5:1
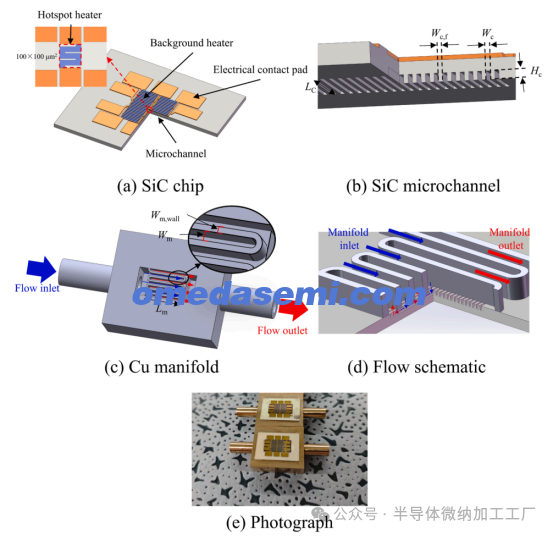
高效的热管理对于高功率电子器件的可靠运行至关重要,尤其是在极端热通量条件下。本研究旨在实验研究一种碳化硅(SiC)汇流微通道散热器,以实现超高热通量下的背景和热点高效冷却。在高导热 SiC 衬底中,通过等离子体蚀刻制备微通道阵列,其通道宽度为 15 μm,深度为 100 μm。采用单相去离子水作为冷却液,并在不同背景及局部热点热通量条件下评估其性能。实验结果表明,SiC 汇流微通道散热器能够在 5 × 5 mm² 区域内成功散发背景热通量 3190 W/cm²,同时压力降仅为 32 kPa;在 100 × 100 μm² 区域内去除局部热点热通量 12.0 kW/cm²,同时将热点温升控制在 150 ℃以下。测得最小热阻为 0.040 cm²·K/W,最大换热系数为 6.8 × 10⁵ W/(m²·K)(流量 3 g/s)。非均匀背景加热的影响也进行了分析,结果表明,局部加热可通过 SiC 衬底内的横向热扩散受益,从而使热阻降低约 5–8%。本研究的新颖性在于展示了通过嵌入式近结点冷却结构去除超高热通量的能力,并在背景及热点加热场景下通过实验验证了其性能。该研究为下一代高功率电子器件的先进近结点冷却策略设计提供了重要参考,兼顾了热性能优化、系统级压力降控制及结构完整性。
我们为客户提供晶圆(硅晶圆,玻璃晶圆,SOI晶圆,GaAs,蓝宝石,碳化硅(导电,非绝缘),Ga2O3,金刚石,GaN(外延片/衬底)),镀膜(PVD,cvd,Ald,PLD)和材料(Au Cu Ag Pt Al Cr Ti Ni Sio2 Tio2 Ti3O5,Ta2O5,ZrO2,TiN,ALN,ZnO,HfO2。。更多材料),键合(石英石英键合,蓝宝石蓝宝石键合)光刻,高精度掩模版,外延,掺杂,6寸DUVKRF电子束光刻等产品及加工服务(请找小编领取我们晶圆标品库存列表,为您的科学实验加速。
请联系小编免费获取原文

1.引言
随着微电子器件功率密度的不断增加,传统的远程冷却方法在应对由此产生的极端热通量时变得越来越不足。一种有前景的方法是直接芯片冷却(direct-to-chip cooling),即液体直接接触衬底表面,从而实现高效的热量去除和最佳工作温度。微通道散热器(MCHS)已成为一种特别高效的高热通量散热技术。其优异性能主要归因于小的液压直径和高的表面积与体积比,这既增大了传热面积,也提高了传热系数 [1,2]。这些特性使得微通道散热器成为一种紧凑、轻量且高效的热管理解决方案。
Tuckerman 和 Pease [1] 首次提出了微通道散热器(MCHS)的概念,展示了在 10 × 10 mm² 加热区内散发 790 W/cm² 热通量的能力。该结构通过在硅(Si)晶片上蚀刻微通道制备,翅片和通道宽度为 50 μm,通道深度为 302 μm,使用单相水冷却实现了 0.09 cm²·K/W 的低热阻。这项开创性研究为 MCHS 技术的发展奠定了基础,使高热通量应用中的有效热管理成为可能。大量分析、数值和实验研究 [3–6] 调查了在优化几何结构下,硅微通道中单相水冷的性能,以进一步降低热阻。为了改善热和流体特性,各种微通道结构被提出,例如带针状翅片的微间隙/微肋 [7,8]、腔体与喷嘴 [9]、汇流管结构 [10–12]、仿生几何结构 [13,14] 以及沟槽表面 [15,16]。在这些创新中,汇流微通道(MMC)结构尤为引人关注,因为它可以将长微通道分割为较短的段。这种结构改进有效缩短了微通道的有效流动路径,降低压力降,促进更高效的散热,并增强温度均匀性。

鉴于衬底材料在热性能中的关键作用,硅(Si)因其热导率为 130–160 W/m·K、适宜的半导体特性、高兼容性、低成本以及成熟的制备工艺而被广泛使用。针对硅微通道散热器(MCHS)的实验研究采用了微铣削、光刻结合湿/干法蚀刻及激光烧蚀等先进微加工技术 [17,18]。相比之下,碳化硅(SiC)具有更高的热导率(300–400 W/m·K),且因其宽禁带、高击穿电场、优越的机械强度、化学稳定性以及在恶劣环境下的耐久性,在氮化镓(GaN)基 SiC 高电子迁移率晶体管(HEMT)和 SiC 金属氧化物半导体场效应晶体管(MOSFET)中被广泛应用 [19,20]。然而,由于 SiC 硬度高、脆性大、断裂韧性低,其微通道的加工较为困难,因此关于 SiC MCHS 高热通量散热特性的实验研究仍然有限。
近年来,SiC 和 GaN 器件的热散问题受到越来越多关注,尤其是在器件级功率密度持续上升的背景下。为满足下一代电子器件严格的热要求,嵌入式微通道近结点冷却策略正被积极探索,作为局部高效散热的潜在解决方案。Van Erp 等 [21] 提出将电子器件设计与 Si 微通道冷却协同集成,其设计实现了高达 1700 W/cm² 的散热能力,而泵送功率仅需 0.57 W/cm²。采用单相水冷,该单片集成的毫米级微通道结构(mmC)性能系数(COP)超过 10,000,几乎是传统直平行微通道散热器的 50 倍。Jung 等 [22] 考察了嵌入式 Si 毫米级微通道散热器在单相水冷下的热流体行为,实验结果显示汇流微通道设计可在 100 mL/min 流量下以仅 3 kPa 压力降散发 250 W/cm² 热通量。Zhang 等 [8] 在硅衬底中制备了非均匀微针翅片阵列,并提出嵌入式热管理方法,用于多芯片电子系统,实现可配置与可替换性。在 300 mL/min 水流下,其设计可实现单芯片最高 1400 W/cm² 的散热,同时芯片温度保持在 101.5 ℃,泵送功率低至 0.37 W,总热阻为 0.056 cm²·K/W。Cassada 等 [23] 验证了 SiC MCHS 在 0.25 cm² 面积上管理高达 1 kW/cm² 热通量的有效性。通过采用高纵横比 14.3 且液压直径减小至 54 μm 的通道,该系统在 450 mL/min 单相水冷下实现热阻低至 0.024 cm²·K/W。然而,直平行微通道配置导致过高的压力降(499 kPa),最终引发通道破裂与结构失效。Mandel 等 [24] 利用膜蒸发及增强流体输送系统,实验研究了压装 Si 和粘接 SiC 嵌入式微散热器,在粘接 SiC 测试芯片上实现超过 1 kW/cm² 的热通量,最佳换热出现在较高蒸汽质量(30–50%)下,相比以往研究有所提升。
以往研究主要集中于均匀背景热通量,而实际功率电子器件通常存在高度非均匀的热分布,局部热点的热通量可比周围背景高数倍甚至数量级,对器件可靠性和热设计构成挑战。为应对这一问题,一些实验研究评估了 MCHS 在非均匀和热点热通量条件下的表现。Yu 等 [25] 在硅互连板中提出嵌入式收敛-发散微通道散热器,以解决 GaN 功率器件的局部热点加热问题,其设计可有效处理极端热负荷,实现局部热点峰值热通量 30.7 kW/cm²,芯片平均热通量约 550 W/cm²。在水冷流量 500 mL/min 下,结点最高温度保持在 137.2 ℃ 以下,压力降为 394.3 kPa。Drummond 等 [26] 使用 HFE-7100 两相冷却,实验研究了微通道几何对硅分级毫米级微通道散热器热性能的影响。对于固定通道深度,较窄微通道的样品具有更优散热能力,可处理背景热通量 900 W/cm² 和局部热点热通量 2700 W/cm²,这得益于总润湿表面积的增加。Weaver 等 [27,28] 探讨了 MCHS 在 GaN-on-SiC 功率放大器散热中的应用,每个栅极 0.5 × 350 μm² 面积的热通量为 1.08 × 10⁶ W/cm²,峰值温度约 258 ℃。SiC 微通道宽度为 100 μm,深度为 110 μm。结果表明,MCHS 冷却可在不改变工作温度和晶体管直流性能的情况下提升功率容量高达 50%。Ye 等 [29] 验证了 GaN-on-SiC HEMT 的嵌入式微通道主动热管理,在 70 mL/min 冷却液流量下,每个栅区(0.5 × 350 μm²,54 个并联栅)可承受热通量 6349 W/mm²,器件峰值温度低至 67.4 ℃,显著缓解自加热效应并提高饱和电流。Lu 等 [30] 提出 SiC 微通道近结点冷却技术用于 GaN-on-SiC 单片微波集成电路功率放大器。相比远程冷却,嵌入式冷却方法通过增加饱和电流 22.32% 并改善传输特性 11.74%,提升器件电性能。在宽度 50 μm、深度 200 μm 的微通道设计下,可有效管理栅区 0.5 × 100 μm² 面积 100 kW/cm² 热通量,将栅温保持在 128.2 ℃ 以下。
值得注意的是,在微通道中利用各种介质液体的两相沸腾冷却已成为一种有效且有前景的冷却方法。与单相冷却相比,其优势包括结构紧凑、在最小冷却液量下实现更高换热系数、改善流向温度均匀性 [31–33]。然而,两相流的基本现象(流型、流动沸腾换热、临界热通量及两相流压力降)仍复杂且理解不完全 [34,35],带来流动不稳定、表面干涸、压力降增加、气泡堵塞和逆流等技术挑战 [36,37]。因此,在实际应用中,单相微通道冷却通常被认为是管理高热通量更可靠、可行的解决方案。
文献表明,关于 SiC 微通道散热器的实验研究仍然有限,尤其是针对其在超高热通量下高效散热且保持系统压力降适中(通常为几十千帕)的能力,而这是实际工业应用中的关键因素。为填补这一空白,本研究提出了一种可行的 SiC 微通道汇流结构制备方法,并展示了其在单相水冷下的优越液压及热性能。为评估 SiC 毫米级微通道散热器在高集中局部热点下的性能潜力,本研究开展创新性实验,施加热通量超过 12 kW/cm² 于 100 × 100 μm² 区域,解决超高局部热散问题——这是现有文献中鲜有探讨的领域。据作者所知,这是首次在不同加热情景下对 SiC 毫米级微通道散热器进行实验研究,实现了迄今报道的最高背景热通量,同时施加超高局部热点热通量。研究结果预计为 SiC MCHS 在处理极端热负荷同时保持低系统压力降的潜力提供重要参考,为高功率电子器件热管理技术的发展奠定基础。
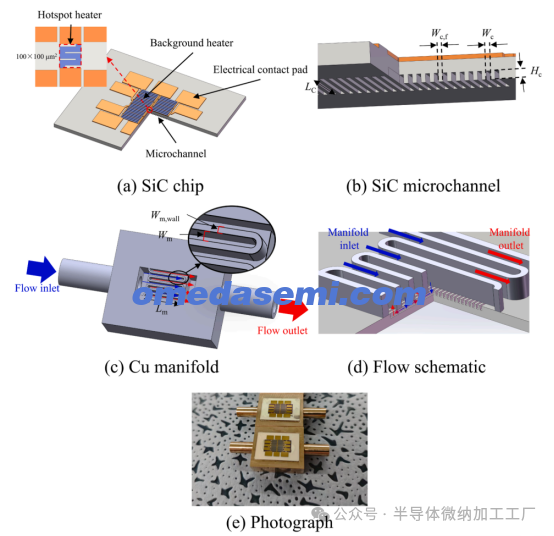
图 1. 测试段示意图。(a) 带背景加热器和热点加热器的 SiC 芯片:蓝色方块表示沉积的 Pt 层,橙色方块表示沉积的 Au 层。(b) SiC 微通道结构设计。(微通道尺寸未按比例显示,以便清晰展示结构。)(c) 铜汇流管结构设计及其尺寸。(d) 装配好的毫米级微通道(mmC)结构流动示意图。(e) SiC 测试段实物照片。
2.实验装置
2.1. 测试段设计
测试段由 SiC 微通道芯片和铜(Cu)汇流管组成,如图 1 所示。SiC 芯片的尺寸(L_chip × W_chip × H_chip)为 17 mm × 14 mm × 500 μm,加热区尺寸为 5 mm × 5 mm。该配置能够实现与汇流管的密封接口,并提供足够空间用于接触焊盘。
加热器包括四个铂(Pt)背景加热器,每个面积为 2.5 mm × 2.5 mm,以及位于中央的 Pt 热点加热器,面积为 100 μm × 100 μm。所有加热器均由独立电源供电。引线和焊盘采用沉积金(Au)制成,以降低其电阻占比。微通道阵列占据 5 mm × 5 mm 区域,与加热器区域对齐。微通道尺寸(L_c × W_c × H_c)为 5 mm × 15 μm × 100 μm,翅片宽度(W_c,f)为 25 μm。微通道与加热器之间的衬底厚度保证了结构支撑和电绝缘性能。
铜汇流管采用数控(CNC)加工制备,其结构设计用于通过沿微通道长度布置的多个入口和出口分配冷却液,从而缩短每段微通道的有效流动长度。汇流管通道尺寸(L_m × W_m × H_m)为 6 mm × 0.5 mm × 1.5 mm,汇流管壁宽度(W_m,wall)为 0.3 mm。SiC 芯片与 Cu 汇流管通过激光切割双面胶(AR-Global 94,119)固定,该胶具有防水性能和高温使用范围(最高可达 100 ℃)。压力端口和热电偶位于距离汇流管入口和出口约 20 mm 处。
在安装 SiC 芯片与 Cu 汇流管后,SiC 芯片上的电接触焊盘通过铝(Al)线键合至印刷电路板(PCB)。PCB 上开设观察窗,用于获取加热器的红外温度分布图。SiC 芯片表面涂覆黑色涂料并校准发射率。PCB 上施加固化胶以固定铝线。
2.2. 制备工艺
制备工艺的主要步骤包括:二氧化硅(SiO₂)绝缘层沉积、Pt 图案沉积、Au 图案沉积、Ni 掩模电镀、微通道电感耦合等离子体(ICP)蚀刻以及 Ni 掩模去除。图 2(a) 展示了 SiC 散热芯片的整体制备流程。该工艺始于 4 英寸半绝缘 SiC 晶片,并进行彻底的有机清洗。由于 SiC 晶片半透明,可在显微镜下同时观察加热器和微通道图案,如图 2(b) 所示。
首先,在晶片顶表面通过等离子增强化学气相沉积(PECVD)沉积 300 nm 厚的 SiO₂ 绝缘层。随后,通过一系列工艺步骤(包括光刻、溅射和去除工艺)对加热器和传感器特征进行图案化。热点加热器由 30 nm 钛(Ti)种子层上沉积的 300 nm Pt 层组成;背景加热器及热点引线迹由 30 nm Ti 种子层上沉积的 400 nm Au 层组成。
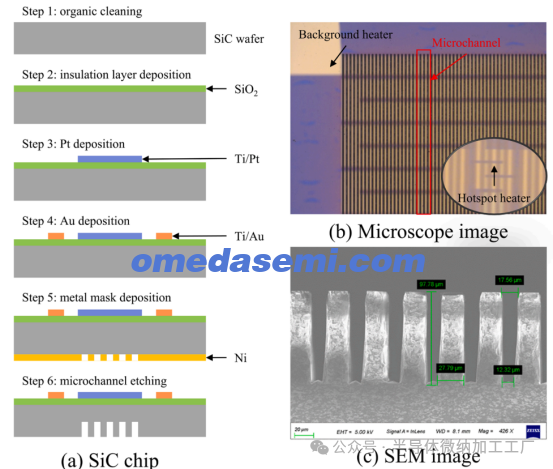
图 2. SiC 测试芯片的制备工艺及典型结果。(a) SiC 芯片制备过程的横截面示意图。步骤 1:对厚度为 500 μm 的双面抛光半绝缘 SiC 晶片进行有机清洗。步骤 2:沉积 300 nm 厚的 SiO₂ 层。步骤 3:光刻、溅射和去除工艺沉积 30 nm Ti 和 400 nm Pt。步骤 4:光刻、溅射和去除工艺沉积 30 nm Ti 和 300 nm Au。步骤 5:溅射 10 nm Ti 和 100 nm Au 作为种子层;随后光刻、电镀 5 μm Ni 作为掩模层,去除光刻胶,并蚀刻种子层。步骤 6:SiC 微通道蚀刻、去除 Ni 掩模并切割芯片。(b) SiC 芯片显微镜照片,聚焦于加热器表面。(c) SiC 微通道的扫描电子显微镜(SEM)图像。
SiC 的高硬度和化学稳定性使其非常适合在恶劣环境中使用,但同时也增加了蚀刻结构的难度。在深蚀刻工艺(>10 μm)中,长时间的等离子体暴露可能会侵蚀光刻胶或薄金属掩模,导致图案失真。为解决这一问题,采用电镀 5 μm 厚的镍(Ni)层作为硬掩模。在晶片背面,先溅射 10 nm Ti 和 100 nm Au 作为种子层。随后使用 10 μm 厚的 AZ P4620 光刻胶进行光刻以定义掩模图案。之后,电镀 5 μm Ni 层,去除光刻胶,并通过离子束蚀刻(IBE)去除暴露的种子层,从而打开蚀刻窗口,完成厚金属掩模的制备(见表 1)。
晶片的等离子体蚀刻使用 ULVAC 中性环放电(NLD)蚀刻机,反应性蚀刻气体为 SF6/O2,实现约 1 μm/min 的 SiC 蚀刻速率。蚀刻完成后,去除金属掩模,并沿预先标记的划线切割晶片以分离单个芯片。使用扫描电子显微镜(SEM)检查切割样片的侧壁轮廓和表面粗糙度。如图 2(c) 所示,微通道宽度为 15 μm,深度为 100 μm。
2.3. 实验装置
图 3 展示了用于研究 SiC 毫米级微通道(mmC)散热器传热性能的实验装置示意图。实验工作流体为单相去离子水。在实验前,水通过在储罐中剧烈沸腾两小时进行充分脱气。脱气后的水依次流经压力调节器、50 μm 滤网、齿轮泵、质量流量计、热交换器、2 μm 滤网、预热器和测试段。之后,流体进入板式热交换器冷却,再循环回储液槽。
为了监测热工况,使用直径 0.3 mm 的 T 型热电偶测量流体的入口和出口温度。热电偶通过恒温水浴进行校准,以确保测量准确性。测试段入口压力通过表压变送器记录,测试段的压降通过差压传感器测量。所有实验数据使用 Agilent 34970A 数据采集系统以 5 秒间隔记录。
表 1 SiC 毫米级微通道(mmC)散热芯片的几何尺寸参数。
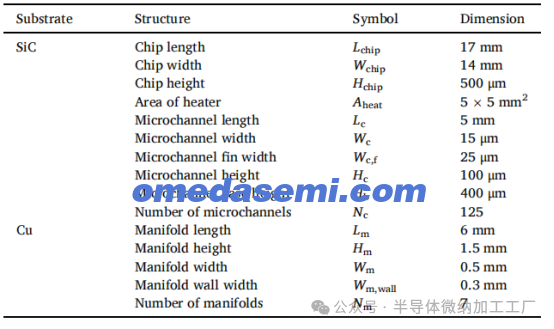
2.4. 数据处理与不确定度计算
在测试芯片表面施加均匀热通量作为热边界条件。有效热输入量 QeffQ_{\rm eff}Qeff 根据测量得到的冷却液显热增加计算,其计算公式如下:

相应的有效热通量 qeffq_{\rm eff}qeff 定义为单位面积上的有效热输入:

在本研究中,加热器表面积 AheatA_{\rm heat}Aheat 指定为 5 × 5 mm²。
为了表征 SiC 毫米级微通道(mmC)散热芯片的热性能,使用总热阻 RtotalR_{\rm total}Rtotal 进行评估。该总热阻包括三个主要组成部分:导热阻 RcondR_{\rm cond}Rcond、微通道内对流阻 RconvR_{\rm conv}Rconv 以及与工作流体平均温升相关的热阻,即热容阻 RcalR_{\rm cal}Rcal。总热阻可通过以下公式计算:

导热阻 RcondR_{\rm cond}Rcond 来源于热量通过固体层的传导,其计算基于傅里叶定律(Fourier 定律):

这里,HbaseH_{\rm base}Hbase 表示未被微通道占据的 SiC 衬底高度,即 SiC 层总厚度与微通道深度之差。δSiO2\delta_{\rm SiO2}δSiO2 表示加热器与 SiC 衬底之间的 SiO₂ 层厚度。SiC 衬底的测得热导率为 320 W/(m·K),SiO₂ 为 1 W/(m·K)。
与微通道壁面向流动冷却液的传热相关的对流热阻 RconvR_{\rm conv}Rconv 表达为:

在该公式中,Tf,refT_{f,{\rm ref}}Tf,ref 表示微通道内流体的平均温度。微通道基底的平均温度 Tw,avgT_{w,{\rm avg}}Tw,avg 通过从测得的加热表面温度中减去温降来确定:

热容阻 RcalR_{\rm cal}Rcal(或称 RheatR_{\rm heat}Rheat)考虑了冷却液在吸收热量时的温升,其表达式为:

微通道基底面积上的有效换热系数 heffh_{\rm eff}heff 可通过以下公式计算:

直接测量参数的不确定度基于所用仪器的规格确定,如表 2(a) 所示。由于红外相机的测量限制,加热器表面的平均温度和最大温度 Th,avgT_{h,{\rm avg}}Th,avg 与 Th,maxT_{h,{\rm max}}Th,max 的不确定度为 ±2 ℃。通过校准热电偶测得的流体入口和出口温度 Tf,inT_{f,{\rm in}}Tf,in 与 Tf,outT_{f,{\rm out}}Tf,out 的不确定度为 ±0.1 ℃。
对于由这些直接测量推导出的参数,不确定度使用标准误差传播方法进行评估 [38]。若 y 表示依赖于多个变量 xix_ixi 的参数,则 y 的合成不确定度 UyU_yUy 计算如下:

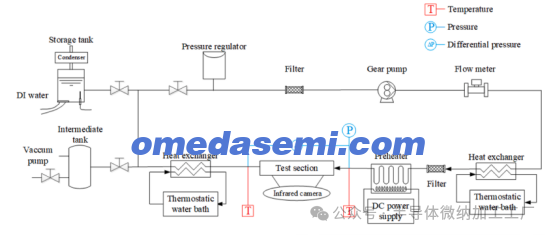
图 3. 实验中实验装置的示意图。
表 2a实验数据不确定度汇总 (a) 测量参数。

该方法遵循独立误差源的常规统计方法。计算得到的不确定度结果汇总如表 2(b) 所示。加热器表面积 AheatA_{\rm heat}Aheat 和比热容 cp(T)c_p(T)cp(T) 的不确定度被认为可以忽略,因此在最终的不确定度估算中未予考虑。
3.结果与讨论
3.1. 温度及其空间分布
图 4(a) 显示了在质量流量为 1、2 和 3 g/s 条件下,加热器最大温度和平均温度随有效热通量的变化情况。如预期,最大温度和平均温度均随热通量增加而升高,并随质量流量增加而降低。在测试的最高热通量 3190 W/cm² 下,测得最大温度为 180.0 ℃,平均温度为 147.9 ℃。在实验过程中,通过观察窗未发现明显气泡生成,并且在恒定流量下,加热器温度与施加热通量呈线性关系,验证了单相流运行状态。
商业 SiC MOSFET 和 GaN-on-SiC HEMT 的典型结点温度限制以确保长期可靠性通常低于 175 ℃。因此,本研究中芯片的最大温度限制为 180 ℃。由于芯片键合强度的限制,未在更高热通量或流量下进行测试,以避免潜在损坏。本研究的主要目标是在相对较低的质量流量和适中压力降(几十 kPa 级别)条件下,利用高热导率衬底实现最小热阻,同时考察不同热负荷对散热芯片热性能和液压性能的影响。
图 4(b) 显示了在热通量 3190 W/cm²、流量 3 g/s 条件下的加热器红外热像。所有测试热通量和质量流量下,空间温度分布保持一致。SiC 芯片背面蚀刻的微通道均匀平行排列。观察到的温度非均匀性表明,汇流管结构对芯片不同区域的传热具有显著影响。具体而言,出口汇流管覆盖区域的表面温度高于入口汇流管下方,因为冷却液在通过微通道后逐渐升温。对于单出口汇流管,下游区域局部温度较高,这取决于每条微通道的局部质量流率和流体温度,需要进一步数值研究以改善温度均匀性。在靠近中心的出口汇流管区域,加热器 3 的最大温度比加热器 1 高 11.6 ℃。尽管汇流管和微通道的液体路径在左右两侧对称,但实验中的温度分布图未完全呈现预测的对称性,这是由制备引起的偏差和匹配误差造成的。
虽然本研究报告的冷却性能显著,但我们承认尚未达到近结点冷却的理论极限,仍有进一步实验验证更高热通量去除能力的空间。在图 4(b) 条件下,出口流体温度测得为 83.3 ℃。考虑最大加热器温度(180 ℃)与出口流体温度(83.3 ℃)之间的温差,该差值较大,可归因于多个因素。
表 2b实验数据不确定度汇总 (b) 推导计算参数。

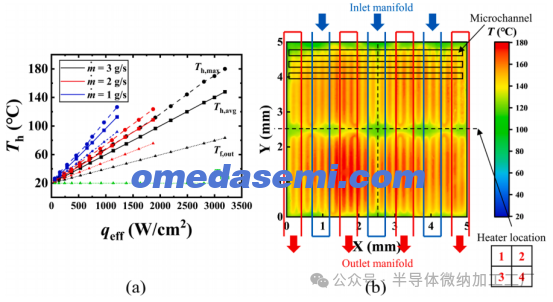
图 4.(a) 加热器的最大温度和平均温度 Th,maxT_{h,{\rm max}}Th,max 与 Th,avgT_{h,{\rm avg}}Th,avg 随有效热通量 qeffq_{\rm eff}qeff 的变化关系,分别在质量流量 1、2 和 3 g/s 下测量。(b) 在实验测试的最大热通量 3190 W/cm²、流量 3 g/s 条件下,加热器表面温度分布的典型红外图像。黑色线表示微通道方向,蓝色/红色线表示入口/出口汇流管通道位置。
首先,芯片上的温度非均匀性导致最大加热器温度与平均加热器温度之间存在差异,占总温差的 33%(32 ℃),这是由于流量分布不均引起的。该问题源于汇流管设计,芯片的某些区域——尤其是靠近出口汇流管的区域——温度较高。实验装置包含 125 条微通道,由于汇流管分支,芯片共有 725 个流动单元(125 条微通道 × 6 个汇流管分支)。每个段的流动路径较短且存在 90° 锐角弯曲,当地的传热性能同时受到流量不均、喷射冲击效应和入口效应的影响。在密集排列的微通道中实现均匀冷却液流动本质上十分复杂,需要先进的流体动力学建模。
其次,导热阻起着重要作用。保留的 400 μm 厚 SiC 衬底对导热阻贡献显著,导致芯片平均温度与微通道基底温度之间的温差占总温差的 51%(49.4 ℃)。虽然进一步减薄衬底可以降低导热阻,但会削弱微通道结构的机械稳定性,而机械稳定性对于可靠的近结点冷却至关重要。为确保结构完整性并实现有效冷却,本研究保持了该厚度的衬底。
最后,对流传热贡献了 16%(15.3 ℃)的温差,发生在微通道基底温度与出口流体温度之间。尽管实验中实现了高达 6.8 × 10⁵ W/(m²·K) 的换热系数,表明热去除能力强,但通过优化蚀刻深度和微通道布局,同时增加流体流量,可进一步提升冷却效率。
这些观察结果表明,要进一步提高热通量散热能力,优化温度均匀性、导热阻和对流传热将是关键。虽然已有显著进展,但通过改进实验装置以探索更高热通量去除能力仍有很大潜力。此外,进一步研究以改善流量均匀性并在优化蚀刻设计与保持结构完整性之间取得合理平衡,对于实现更高效的冷却也至关重要。
3.2. 热性能与液压性能
在单相流条件下,总热阻 RtotalR_{\rm total}Rtotal 在给定流量下几乎不受热通量影响,而随着质量流量从 1 g/s 增加到 3 g/s,总热阻会降低,如图 5(a) 所示。测得的最小总热阻为 0.040 cm²·K/W,其中导热阻为 0.016 cm²·K/W。通过减小 SiC 基底和绝缘层的厚度,可进一步降低导热阻在总热阻中的占比。总热阻 RtotalR_{\rm total}Rtotal 的较大不确定性主要源于出口流体温度的微小升高,在低热通量下导致显著偏差。
有效换热系数 heffh_{\rm eff}heff 按公式 (9) 计算,随着质量流量增加而升高,这与边界层理论及微通道入口效应的传热机理一致。在质量流量 3 g/s 条件下,最大 heffh_{\rm eff}heff 为 6.8 × 10⁵ W/(m²·K),表明在液压直径为 26 μm 的微通道中传热性能显著增强。这一提升主要归因于较大的表面积与体积比、发展流动中薄的热边界层以及增强的流体混合效果。
测得的总压降如图 5(c) 所示。在固定质量流量下,随着热通量增加,压降逐渐降低。这一趋势主要是由于冷却液温度升高导致动力粘度下降所致。
3.3. 非均匀背景加热情景
如图 6(a–f) 所示,将热通量施加于四个背景加热器(每个面积为 2.5 mm × 2.5 mm),以研究当加热面积小于嵌入式微通道阵列总面积时,横向热传导对整体传热性能的影响。每个加热器的平均温度分别测量,并根据实际加热表面积计算有效热通量。
例如,在图 6(a) 中,仅对加热器 1 施加热通量时,相邻的加热器 2 和 3 的平均温升约为加热器 1 的 21%。相比之下,对角线位置的加热器 4 平均温升较小,仅约 10%。这一趋势在其他单独加热器的情况中也被一致观察到。
计算得到的单个背景加热器 1–4 的热阻分别为 0.0379、0.0386、0.0370 和 0.0372 cm²·K/W,与在整个背景加热器区域均匀施加热通量时得到的 0.040 cm²·K/W 相比,降低了约 5–8%。热阻降低的主要原因是 SiC 衬底内的横向热扩散,使热量能够向相邻未加热区域扩散。这种扩散不仅降低了局部温度梯度,还有效增加了参与散热的面积。
实验中观察到的左右侧热性能不对称性,可归因于制备和装配过程中引入的结构偏差和对准误差。
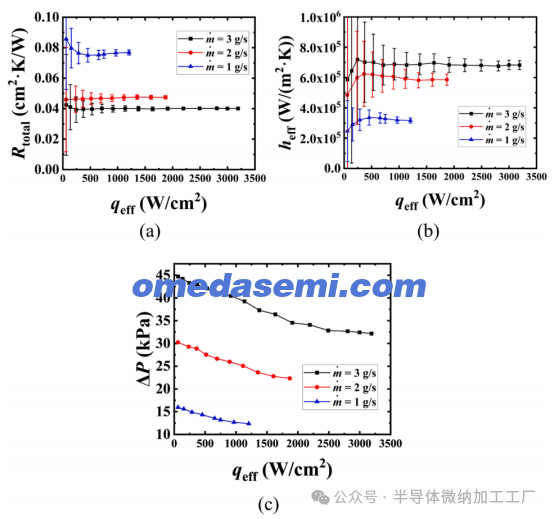
图 5.(a) 总热阻 RtotalR_{\rm total}Rtotal 随有效热通量 qeffq_{\rm eff}qeff 的变化关系;(b) 有效换热系数 heffh_{\rm eff}heff 随有效热通量 qeffq_{\rm eff}qeff 的变化关系;(c) 在不同质量流量条件下,总压降 ΔP\Delta PΔP 随有效热通量 qeffq_{\rm eff}qeff 的变化关系。
当热通量同时施加在加热器 1 和 3(对应左侧汇流管区域)时,加热区域的最大温度和平均温度几乎与对整个区域施加均匀热通量时的温度相同。此情况下计算得到的热阻约为 0.0401 cm²·K/W。
当热通量施加在对角线位置的加热器 1 和 4 时,加热区域的最大温度和平均温度略高于单独加热器加热的情况,计算得到的热阻约为 0.0389 cm²·K/W。
这些结果表明,将热源分布在不同汇流管区域,有助于降低加热区域的最大温度和平均温度(见图 7)。
3.4. 背景与热点同时加热情景
在热点散热实验中,将集中热通量施加于芯片中央 100 μm × 100 μm 区域,同时在整个 5 mm × 5 mm 芯片区域施加均匀背景热通量。对于本研究测试的样品,热点加热器的电阻约占 Pt 热点加热器、Au 引线、线键合及 PCB 迹线总电阻的 50%。在最大热点热通量 12.0 kW/cm² 且无背景加热的条件下,施加到热点加热器的功率仅为 1.2 W,相比背景加热器总功率可忽略不计。在流量 3 g/s 条件下,这部分热量导致流体温升仅约 0.1 ℃。
图 8(a) 显示了在零背景热通量下,不同质量流量 1–3 g/s 条件下,热点最大温度 Ths,maxT_{hs,{\rm max}}Ths,max 随热点热通量 qhsq_{hs}qhs 的变化。热点最大温度随热点热通量线性升高,在不同质量流量下温升斜率相似。在热点热通量 12.0 kW/cm² 条件下,热点最大温度在不同流量下保持恒定,为 169±1 ℃。在不同背景热通量条件下,当流量从 1 g/s 变化到 3 g/s 时,有效换热系数 heffh_{\rm eff}heff 范围为 3.16 × 10⁵ 到 6.82 × 10⁵ W/m²·K。尽管换热系数变化显著,热点温度基本不受影响,表明温升主要受 SiC 衬底内的热扩散和导热阻控制,而非局部对流传热限制。
图 8(b) 显示在流量恒定为 3 g/s 条件下,同时施加背景热通量时的热点最大温度。热点最大温度随背景热通量线性增加,不同背景热通量下的斜率相似。温升高度局部化于热点区域,而背景加热器未表现出明显温度升高。作为对比,当背景加热器在均匀加热下温度升高 150 ℃ 时,对应散发的背景热通量为 3.0 kW/cm²(流量 3 g/s)。较厚的基底(400 μm)以及 SiC 材料较高的热导率有助于横向热扩散并实现高效的热点散热。
为进一步提升热点散热性能,可通过优化衬底材料和厚度,在保证有效横向热扩散的同时降低导热阻;更重要的是,通过改进热点附近的局部汇流微通道结构,实现喷射冲击冷却,以增强局部散热效率。
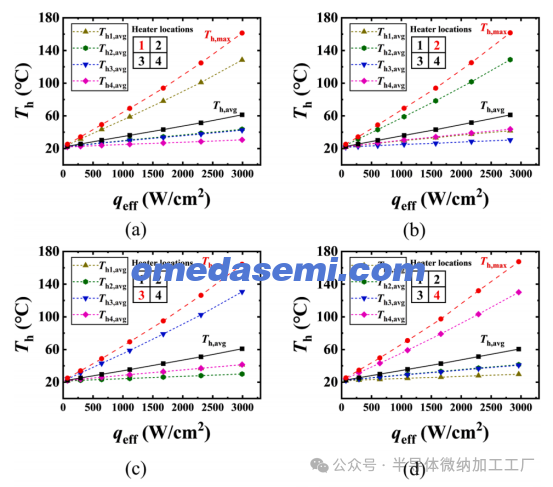
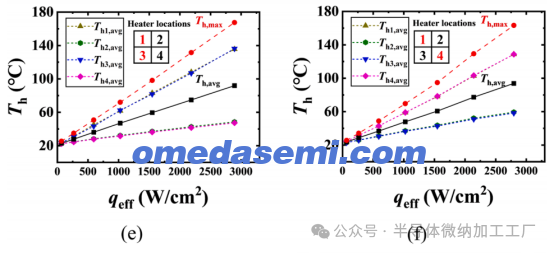
图 6.(a–f) 在不同背景热负荷下,每个加热器的平均温度随有效热通量 qeffq_{\rm eff}qeff 的变化关系。红色文字表示加热区域,黑色文字表示未加热区域。
3.5. 与文献数据的对比
表 3(a) 对比了代表性嵌入式微通道冷却研究的关键参数,包括冷却液条件、衬底材料、微通道尺寸、体积流量、系统压力降、实验热通量、芯片面积和热阻。本研究报告了嵌入式微通道散热器中实验验证的最高背景热通量之一,同时保持了适中的系统压力降,满足工业应用要求。
为了更精确地评估液体冷却性能,定义了复合热阻(composite thermal resistance),即总热阻减去导热阻 Rtotal−RcondR_{\rm total} - R_{\rm cond}Rtotal−Rcond,其值在文献中也属于最低水平。从理论上讲,在几何和冷却条件相同的情况下,用高热导率 SiC 衬底替代 Si 衬底,不仅降低了导热阻,还提高了翅片对对流换热的效率。这一改善有助于降低总热阻,实现更高效的热散。
本研究中的背景热通量实验验证了所提出的嵌入式冷却结构及制备工艺的可行性和有效性,并展示了其在提升热通量去除能力方面的潜力。

图 7.(a–f) 在质量流量 3 g/s 条件下,不同背景热负荷下的红外热像图。
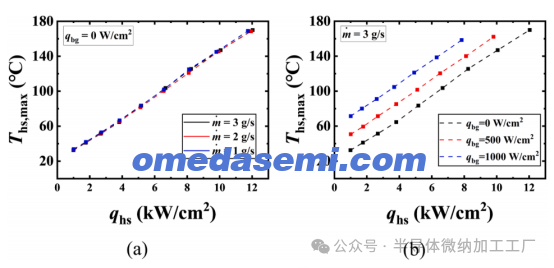
图 8.(a) 在无背景热通量 qbgq_{\rm bg}qbg 条件下,不同质量流量 1–3 g/s 下,热点最大温度 Ths,maxT_{hs,{\rm max}}Ths,max 随热点热通量 qhsq_{hs}qhs 的变化关系。(b) 在质量流量 3 g/s 条件下,随着背景热通量 qbgq_{\rm bg}qbg 从 0 到 1000 W/cm² 变化,热点最大温度 Ths,maxT_{hs,{\rm max}}Ths,max 与热点热通量 qhsq_{hs}qhs 的关系。
除了背景冷却,本研究还探讨了在不采用任何专门结构增强的情况下,管理局部热点加热的能力。需要注意的是,较小的热点往往会达到显著更高的局部热通量,如表 3(b) 所示。例如,100 μm × 100 μm 的热点可视为等效于 200 条并排排列、宽 0.5 μm、长 100 μm 的热点线。在这种配置下,相邻热源之间的热耦合会导致累积温升,从而影响热点的热响应。系统的热点散热能力仍有提升空间,可通过针对性的结构优化实现,例如局部喷射冲击冷却或优化微通道设计,以及改进衬底内的热传导路径。
表 3a嵌入式微通道散热器(MCHS)实验研究汇总 (a) 背景加热情景。
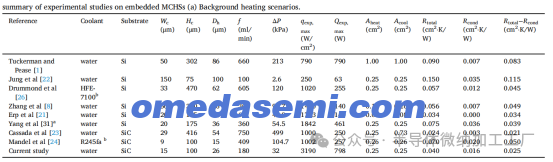
注:AheatA_{\rm heat}Aheat 表示器件中的加热区域;AcoolA_{\rm cool}Acool 表示微通道阵列占据的面积。a 表示我们先前研究中报告的硅 Z 型毫米级微通道(mmC)散热器的实验结果。b 表示两相冷却条件。
表 3b嵌入式微通道散热器(MCHS)实验研究汇总 (b) 热点加热情景。

注:Lhs×WhsL_{\rm hs} \times W_{\rm hs}Lhs×Whs 表示器件中热点的长度和宽度;Ths,maxT_{hs,{\rm max}}Ths,max 表示实验中测得的热点最大温度。c 在本研究中未提及。
4.结论
本研究提出了一种高性能 SiC 汇流微通道散热器,用于 5 × 5 mm² 背景加热器(热通量高达 3190 W/cm²)和 100 × 100 μm² 热点加热器(热通量高达 12.0 kW/cm²),采用单相水冷。所提出的设计将高纵横比微通道嵌入高热导率 SiC 衬底,在超高热通量条件下有效降低热阻。通过实验评估了不同热负荷和质量流量下的传热及压力降特性。主要结论如下:
1)所提出的汇流散热器采用嵌入式高纵横比 SiC 微通道,在质量流量 3 g/s 条件下,实现了 3190 W/cm² 的热通量散热能力,同时系统压力降仅为 32 kPa。微通道液压直径为 26 μm,换热系数最高可达 6.8 × 10⁵ W/(m²·K),表明微通道内传热显著增强。
2)对非均匀背景加热情景进行了研究。当热量仅施加于单个背景加热器(占总加热面积四分之一)时,由于衬底内的横向热扩散,总热阻相比整个加热器均匀加热下降了 5–8%。此外,将热通量施加于位于汇流管位置对角的两个加热器时,其热阻低于串联加热两个加热器的情况。
3)同样考察了局部热点加热情景。在热点热通量 12.0 kW/cm² 条件下,热点最大温升保持在 150 ℃ 以下,对质量流量和背景热通量变化的敏感性很小。此温升主要受衬底内热扩散和导热阻控制。
4)进一步提升性能可通过优化衬底材料和厚度,在保证横向热扩散的同时降低垂直导热阻;同时,通过改进热点附近的局部汇流微通道结构,实现喷射冲击冷却,可进一步增强局部散热效率。
文章名:Experimental study of a SiC manifold microchannel heat sink under background and hotspot heating scenarios at ultra-high heat flux
作者:Shudong Yang a,b,1 , Biqi Cao a,b,1 , Zan Wu a,b,c,* , Sihui Hong a ,Hongyi Xu b , Kuang Sheng a,b
单位:a.College of Electrical Engineering, Zhejiang University, Hangzhou 310027, China
b.ZJU-Hangzhou Global Scientific and Technological Innovation Center, Hangzhou 311200, China
c.Institute of Fundamental and Transdisciplinary Research, Zhejiang University, Hangzhou, Zhejiang 311215, China