划重点:
提供碳化硅深刻蚀加工
最深300um ,深宽比:7.5:1
提供金刚石刻蚀加工
目前最深 2um,正在开发更深的
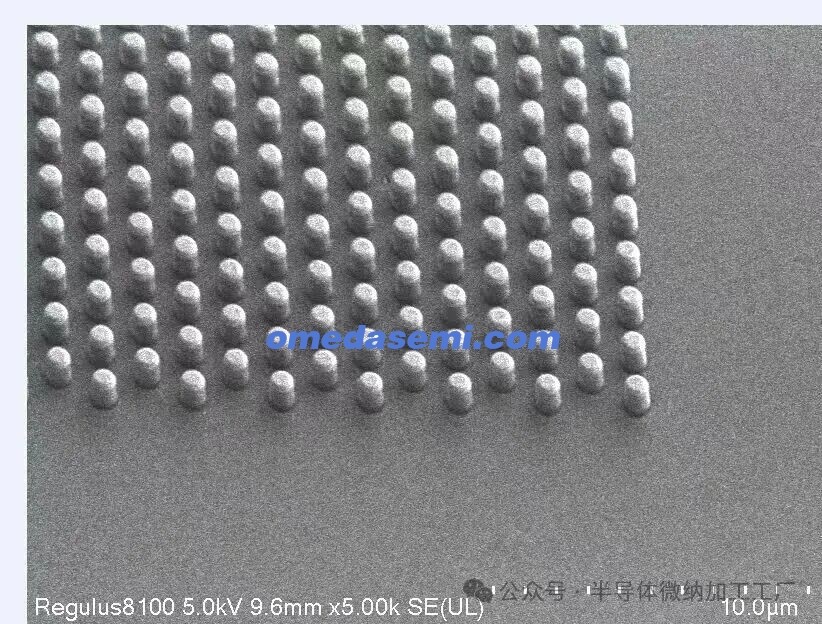
摘要
开发了一种基于PECVD SiO2厚掩模的钻石ICP-DRIE刻蚀工艺,采用CF4辅助O2等离子体抑制微掩模效应并实现稳定的深刻蚀。该工艺可在超过260 µm深度的微通道上实现高质量的刻蚀,且纵横比超过8。基于此,制造并测试了集成加热器和热电偶的钻石微通道散热器,展示了优异的热性能,总热阻为0.37 K/W,并在25°C温升下热通量密度超过640 W/cm²。所提出的方法为使用钻石微通道散热器进行高功率设备冷却提供了一种有效的途径。
关键词
PECVD SiO2掩模,钻石ICP-DRIE,微掩模效应,刻蚀纵横比,钻石微通道散热器,热性能
我们为客户提供晶圆(硅晶圆,玻璃晶圆,SOI晶圆,GaAs,蓝宝石,碳化硅(导电,非绝缘),Ga2O3,金刚石,GaN(外延片/衬底)),镀膜(PVD,cvd,Ald,PLD)和材料(Au Cu Ag Pt Al Cr Ti Ni Sio2 Tio2 Ti3O5,Ta2O5,ZrO2,TiN,ALN,ZnO,HfO2。。更多材料),键合(石英石英键合,蓝宝石蓝宝石键合)光刻,高精度掩模版,外延,掺杂,6寸DUVKRF电子束光刻等产品及加工服务(请找小编领取我们晶圆标品库存列表,为您的科学实验加速。
请联系小编免费获取原文

引言
钻石因其极高的热导率和卓越的化学稳定性,被认为是高功率电子设备和微系统中高效散热的理想材料[1]。当前基于钻石的冷却方法主要包括在设备表面沉积钻石薄膜[2]、局部或全局粘接钻石基板以增强热扩散[3][4],以及在钻石基板内形成微通道结构以实现直接液体冷却[5]。其中,钻石微通道散热器在高热通量条件下表现出卓越的性能[6];因此,可控且稳定的钻石深刻蚀工艺对其实现至关重要。
激光烧蚀是钻石深刻蚀的最常用方法。Yang等人制作了激光蚀刻的钻石通道,在351.5 W/cm²的热通量下实现了表面温度低于65.9°C,并具有良好的温度均匀性[7]。然而,激光加工的分辨率受限于光束斑的大小,使得很难实现较小或高纵横比的结构。此外,其串行性质导致高成本,且与片上微加工兼容性差,限制了大规模生产的可行性。
ICP-RIE是另一种核心的钻石图案化技术,当与光刻结合时,提供高分辨率和良好的工艺兼容性。然而,溅射的SiO2硬掩模通常存在高内应力和低沉积效率,限制了其可达到的厚度,从而限制了刻蚀深度。金属掩模可以提供更高的刻蚀选择性,但长时间刻蚀容易导致微掩模效应和“草”缺陷[8]。Zheng等人提出了一种Cr/Ni双层掩模策略,将选择性提高到约150:1[9],但该工艺仍然复杂且成本高,限制了其可扩展性和实用性。
为了克服这些限制,本研究开发了一种基于CF4辅助O2的ICP-DRIE工艺,用于钻石深刻蚀。优化的气体成分有效抑制了微掩模效应,能够制造深度超过260 µm的钻石微通道散热器。随后,通过热性能测试对制造的结构进行了封装和表征。
制造与测量
在我们之前的工作中[10],优化的工艺参数如下:ICP功率为1600 W,偏压功率为100 W,O2流量为49 sccm,腔体压力为5 mTorr。在这些条件下,达到了287 nm/min的刻蚀速率、17.3的刻蚀选择性以及88.7°的陡侧壁角,展示了该方法在高纵横比钻石深刻蚀中的潜力。然而,随着刻蚀深度的增加,微掩模效应变得越来越严重,导致草状结构的积累,限制了进一步的深刻蚀。
为了进一步抑制微掩模效应,并实现可控制造更深、更高纵横比的微通道,工艺得到了改进,并通过在ICP-DRIE系统中引入CF4辅助O2气氛进行了扩展。该方法旨在增强对微掩模效应的抗性,同时保持高刻蚀速率和良好的侧壁形态,从而实现稳定且精确的深刻蚀。整体制造过程如图1所示,详细过程在我们之前的出版物中[10]进行了描述。
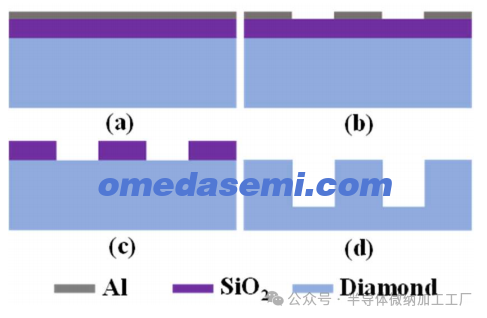
图1:钻石ICP-DRIE工艺流程。
首先,24 µm厚的PECVD SiO2薄膜被沉积在300 µm厚的多晶钻石基板上,然后溅射一层3.5 µm厚的铝(Al)膜,作为图案化SiO2层的硬掩模(图1(a))。接着,使用光刻和ICP-RIE技术将设计的图案转移到铝层上(图1(b))。随后,通过ICP-RIE刻蚀底层的SiO2掩模,将图案完全转移到24 µm的SiO2层中(图1(c))。最后,在O2基的ICP-DRIE条件下进行钻石深刻蚀,之后去除SiO2掩模,得到测试结构或钻石微通道结构(图1(d))。标准刻蚀测试图案包括25 µm宽的沟槽,而设计的微通道结构具有100 µm宽的肋和通道。
在工艺的第四步中,优化的工艺参数设置为ICP功率1600 W,偏压功率100 W,O2流量49 sccm,腔体压力5 mTorr。系统地研究了添加0-5% CF4的影响,以确定能够有效抑制微掩模沉积同时保持刻蚀速率和刻蚀选择性的最佳刻蚀条件。最后,采用稳定的ICP-DRIE工艺通过长时间刻蚀制造了钻石微通道散热器样品。
使用轮廓仪(Bruker DEKTAK XT)测量了铝掩模、SiO2掩模和刻蚀钻石结构的步高。在每次测量中,选择多个点在不同区域进行,以计算平均值和标准偏差。使用环境扫描电子显微镜(ESEM,FEI Quanta 250 FEG)检查了表面和侧壁形态。从近垂直的横截面视图中测量侧壁角度,这些视图是通过SEM的“倾斜”功能获得的。SEM的放大倍数和比例尺通过标准样品进行校准,校准后的图像在ImageJ中进行分析,以计算刻蚀侧壁与基板之间的角度。每个测量在相同条件下在多个位置重复进行,并使用平均结果进行分析。
结果与讨论
为了抑制刻蚀过程中的微掩模效应,向基于O2的ICP-DRIE工艺中引入了少量CF4气体。在不同CF4浓度(从3%到5%)下进行了20分钟的刻蚀测试,相关的SEM图像如图2所示。可以观察到,随着CF4浓度的增加,草状缺陷的数量逐渐减少。当CF4含量达到5%时,草状结构完全消失,表明微掩模效应被有效消除。
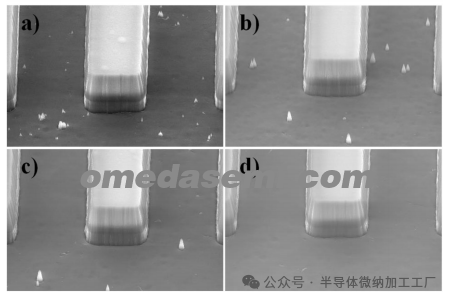
图2:在不同CF₄添加量下的刻蚀结果:a) 0%,b) 3%,c) 4%,d) 5%。
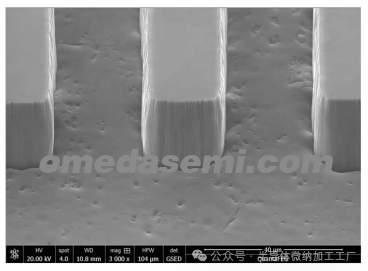
图3:刻蚀2小时后的SEM图像。
根据这个结果,优化后的刻蚀工艺配方如下:ICP功率 = 1600 W,偏压功率 = 100 W,O2流量 = 49 sccm,CF4流量 = 2.6 sccm,腔体压力 = 5 mTorr。在这些优化条件下,使用15 µm厚的SiO2掩模进行了2小时的刻蚀过程,SEM结果如图3所示。刻蚀表面由于草状结构的形成与消除作用以及钻石晶界的固有效应,出现了轻微的坑状损伤,但没有观察到草状结构。侧壁保持陡峭,且可见垂直条纹,底部角落附近由于微刻蚀效应发生了轻微的过刻蚀。钻石的刻蚀速率稳定在215 nm/min,而SiO2掩模的刻蚀速率为15.3 nm/min,得到的刻蚀选择性为14.0。因此,工艺稳定性得到了确认,为后续高纵横比钻石结构的长时间刻蚀提供了可靠的基础。
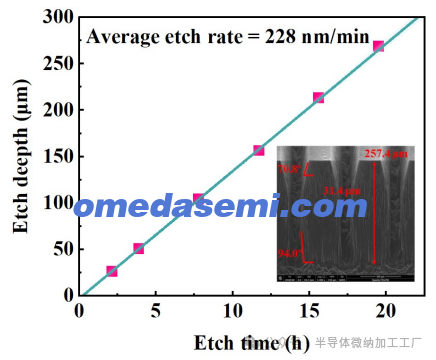
图4:刻蚀深度与时间的关系图及线性拟合。插图展示了在19.5小时刻蚀后,纵横比超过8的深刻蚀结构。
在优化的工艺条件下,进行了持续19.5小时的刻蚀实验,达到了约260 µm的刻蚀深度。在过程中使用轮廓仪定期测量刻蚀深度,深度随时间的变化如图4所示。结果显示出明显的线性关系,线性拟合的斜率表示钻石的平均刻蚀速率为228 nm/min,掩模的平均消耗速率为18.5 nm/min。
在刻蚀测试中,钻石刻蚀速率和掩模消耗速率略有增加。这可以归因于长时间刻蚀过程中基板温度的逐渐升高。计算得出的平均刻蚀选择性为12.3,低于没有添加CF4时获得的17.3值。此减少是由于CF4与SiO2掩模的直接反应,增加了掩模的消耗速率,同时氟自由基替代氧自由基稍微降低了钻石的刻蚀速率。
在刻蚀深度接近260 µm时,获得了定义良好的钻石深刻蚀结构,如图4的插图所示。测量的沟槽宽度为31.4 µm(设计值:25 µm),对应的纵横比超过8。肋的顶部边缘呈70.8°的钝角,而底部角落呈约94.0°的轻微收敛角度。总体而言,主要通道结构保持几乎垂直,侧壁上可见清晰的垂直条纹。由于长时间刻蚀过程中坑状结构的积累,沟槽底部显得相对粗糙。
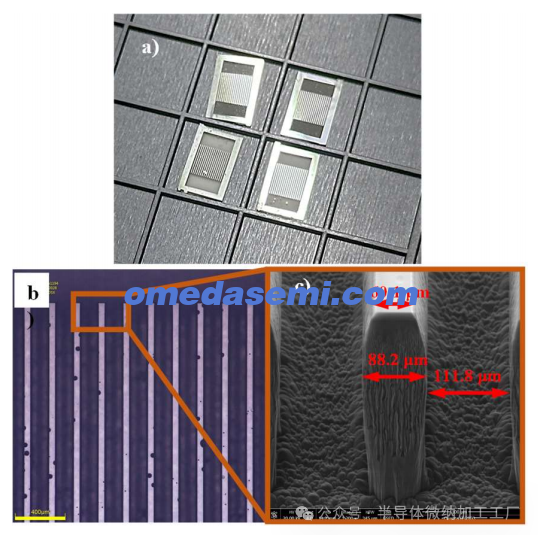
图5:(a) 钻石微通道散热器芯片的结构,(b) 通道的光学图像。
制造的钻石微通道散热器芯片,肋和通道宽度均设计为100 µm,如图5(a–b)所示。SEM测量(图5(c))显示,实际刻蚀的通道宽度为118.4 µm,肋的顶部宽度为60.1 µm,肋的最大宽度为88.2 µm,刻蚀深度为265 µm。刻蚀结构展现出均匀的形态和良好的侧壁定义,表明优化的PECVD SiO2掩模为钻石深刻蚀和三维微结构制造提供了优异的稳定性和可靠性。随后,按照描述的程序加工钻石微通道样品,并制造了背部加热器和热电偶进行集成。热测试系统组装完成后,评估了其散热性能。
热测试系统组装
为了实现钻石微通道的加热和精确的局部温度测量,在刻蚀后的钻石芯片上制造了背部加热器,设计电阻为100 Ω,并配备了多点热电偶阵列。加热器和热电偶均在同一金属薄膜上形成,该薄膜通过物理气相沉积(PVD)工艺沉积,包含20 nm的钛(Ti)和100 nm的金(Au),分别作为附着层和导电层。
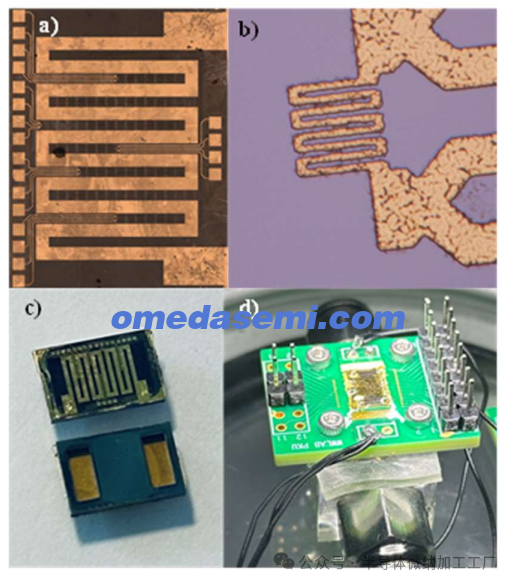
图6:(a) 背部加热器电阻器和热电偶阵列;(b) 热电偶图案的放大视图;(c) 微通道芯片与适配器基板之间的金–锡热压接结构;(d) 组装好的热测试系统。
通过光刻定义了电阻器和热电偶图案,随后通过离子束刻蚀对Au层进行图案化(图6(a–b))。微通道芯片与适配器基板之间的连接采用了Ti/Au溅射和Sn蒸发形成中间层,随后在300°C、70 N压力下进行Au–Sn热压接,持续600秒(图6(c))。热压接后,芯片使用环氧树脂安装在测试PCB平台上,流体固定装置通过螺丝连接。最后,整个组件连接到电源、循环泵、压力计和数据采集系统(图6(d))。
热性能分析
为了全面评估钻石微通道散热器的冷却能力,在多种压降条件下进行了系统的热测量。这些实验使得能够表征输入功率与相应表面温升之间的关系,为评估设备的热传递性能提供了定量依据。
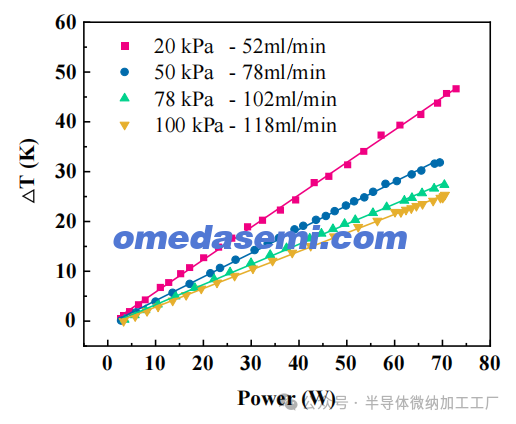
图7:在不同压降条件下,最大表面温升与输入功率的关系。
如图7所示,钻石微通道散热器的最大表面温升(ΔT)作为输入功率与不同压降下的关系进行了测量。实验在20–100 kPa的压降范围内进行,每条曲线对应一个固定的压降条件。结果表明,ΔT随着输入功率的增加大致呈线性增加,拟合线的斜率表示散热器的总体热阻(Rtotal)。随着压降的增加,Rtotal逐渐减小,表明较高的流量增强了对流热传递,并降低了芯片表面温升。在最高压降100 kPa下,测得的最低Rtotal仅为0.37 K/W。在此条件下,散热器实现了70 W的总功率耗散,对应的热通量密度为640 W/cm²,同时温升仅为25°C。这些结果验证了钻石微通道散热器在高压工作条件下的优异热管理能力。
结论
本研究提出并验证了一种基于PECVD SiO2厚掩模结合CF4辅助O2气氛的钻石深刻蚀工艺。该方法有效抑制了微掩模效应,并显著提高了钻石的深刻蚀能力。该工艺在长时间刻蚀过程中保持了稳定的性能,达到了215–228 nm/min的平均刻蚀速率和12.3–14.0的选择性。在19.5小时的刻蚀后,成功制造了深度超过260 µm、纵横比大于8的钻石微通道散热器,具有几乎垂直的侧壁。随后,集成了背部加热器和热电偶阵列,实现了散热器与流体和电气接口的完全集成。热测试表明了优异的冷却性能,实现了超过640 W/cm²的热通量密度,并且温升仅为25°C,总热阻低至0.37 K/W。本研究从工艺开发到热性能评估建立了完整的验证链,为制造高效的钻石微通道散热器提供了一条系统且可扩展的途径,适用于高功率电子设备。
文章名:DIAMOND ICP-DRIE ETCHING WITH PECVD SIO2 THICK MASKS AND ITS APPLICATION ON MICROCHANNEL COOLING
作者:Rui Tang, Jianyu Du, Jinwen Zhang* and Wei Wang
单位:School of Integrated Circuits, Peking University, CHINA