色心平台一直处于量子纳米光子学的前沿,应用于量子网络、计算和传感。然而,因无法在大规模集成光子器件的同时保持量子发射器的特性,这项技术的大规模应用一直受到限制。我们在碳化硅中解决了这一挑战,碳化硅既有商业化的晶圆级衬底,又是具有理想光学和自旋特性的色心的宿主。通过使用角度离子束刻蚀,我们开发了一种用于大规模 4H-SiC 中三角形横截面光子器件制造的 5 英寸晶圆工艺。该工艺的刻蚀速率和刻蚀角度的变异性分别为 5.4% 和 2.9%。此外,集成的色心在刻蚀后保持了其光学特性,从而实现了量子级碳化硅中晶圆级纳米制造的目标。
在过去几十年中,纳米光子学在通信、非线性光学、传感和显示等经典领域以及量子信息处理(QIP)领域中逐渐崭露头角。具有光学可调自旋态的固态发射器因其能够在电子自旋和光子之间产生纠缠而成为可扩展 QIP 实现的先驱者,随后,发射的光子可用于在远距离分配纠缠。当这种能够产生不可区分的自旋纠缠光子的发射器被集成到纳米光子学结构中时,它可以实现发射和收集光子的高效性,满足实施 QIP 协议的要求。早期的研究方向使用量子点和钻石中的氮空位色心,展示了量子纳米光子学的突破性效果,但由于缺乏可扩展的纳米制造技术或发射器之间的光谱不均匀性,难以实现规模化。碳化硅(SiC)有望弥补这些差距。SiC 是一个已建立的色心宿主,结合了长自旋相干时间、卓越的亮度、常温自旋操控、丰富的核自旋、超窄的非均匀展宽以及近红外和通信波段的发射波长。最重要的是,SiC 可作为晶圆级衬底,并且兼容 CMOS 工具中的纳米制造,成为大规模量子纳米光子学硬件的合适平台。
划重点--销售晶圆和加工
4H-HPSI-SIC晶圆
ALOOI晶圆;--氧化铝薄膜晶圆,键合工艺和镀膜工艺
TAOOI晶圆--氧化钽薄膜晶圆,镀膜工艺
SINOI晶圆;--超低损耗氮化硅薄膜晶圆,
SICOI晶圆;新型量子光学平台
6寸LTOI晶圆批量供应;铌酸锂的有力的竞争对手,薄膜钽酸锂晶圆
8寸LNOI晶圆;8寸LNOI助力更大规模薄膜铌酸锂产品量产
LN/LT-SOI/Si/SIN W2W&D2W异质集成
EBL和6寸 150nmDUV加工微纳结构
我们为客户提供晶圆(硅晶圆,玻璃晶圆,SOI晶圆,GaAs,蓝宝石,碳化硅(导电,非绝缘),Ga2O3,金刚石,GaN(外延片/衬底)),镀膜方式(PVD,cvd,Ald,PLD)和材料(Au Cu Ag Pt Al Cr Ti Ni Sio2 Tio2 Ti3O5,Ta2O5,ZrO2,TiN,ALN镀膜刻蚀,ZnO,HfO2。al2o3。更多材料),键合(石英石英键合,蓝宝石蓝宝石键合)光刻,高精度掩模版,外延,掺杂,电子束直写等产品及加工服务(请找小编领取我们晶圆标品库存列表,为您的科学实验加速。
请联系小编免费获取原文

悬浮光子学因其与周围介质空气(n = 1)之间具有最高的折射率对比,提供了最佳的光学约束。这样的悬浮光子学主要通过在牺牲层上进行光子器件层的异质外延生长,并在光子器件制造过程中选择性刻蚀牺牲层,将其从基体中释放出来。能够以可扩展的方式在二氧化硅上生长硅材料,推动了大规模硅光子学领域的发展。类似的努力也已应用于在硅上生长 3C-SiC,但由于这两种材料的晶格常数差异较大,这样的 SiC 层会在几微米的厚度内产生缺陷。这促使研究人员开发了非常规的方法,如 Smart-Cut 方法、光电化学刻蚀和晶圆键合及薄化。这些方法在实现可扩展性方面存在限制,例如植入损伤(Smart-Cut 方法)、特定掺杂剖面的要求(光电化学刻蚀)以及晶圆级均匀性(晶圆键合及薄化)。由于色心最好在块体 SiC 中定义,因此需要一种块体加工方法来解锁可扩展性。角度刻蚀是一种块体加工技术,用于制造悬浮光子器件;最早在钻石中得到了应用,随后在 SiC 中得到了应用。这些角度刻蚀实验采用法拉第笼辅助,其中反应离子刻蚀室中的离子被法拉第笼以角度引导,从而刻蚀掩膜下方,产生具有三角横截面的悬浮光子器件。三角横截面光子的有限差分时域(FDTD)建模显示,其适合色心集成和量子信息处理硬件应用。然而,法拉第笼辅助的角度刻蚀在毫米级芯片规模以上不可扩展,并且需要为不同应用和色心波长设计的光子芯片保持法拉第笼设计的库存。
作为法拉第笼方法的替代,离子束刻蚀(IBE)被用来在大块钻石的芯片级上实现角度刻蚀。在这种方法中,离子源中的离子被加速朝向基板,基板支架可以倾斜以在掩膜下方刻蚀,从而创建下切。在使用 IBE 制造的三角形光子器件中集成的色心被用来进行多个关键的量子信息处理(QIP)演示,例如具有超过 100 的协作性的纳米腔体、>99% 的单次读取和自旋初始化保真度、具有秒级相干时间的腔耦合两量子比特寄存器、生成具有高度可调时域波包和高光谱纯度的单光子(可用于生成簇态)、>90% 的从发射器-腔体系统到光纤的出耦效率、增强的量子通信、用于发射器调谐的应变控制以及具有高不可区分性的量子频率转换到通信波段。由于高纯度的 4H-SiC 晶圆已商业化且缺少一些关键的 QIP 演示,开发在 4H-SiC 中使用 IBE 的可扩展角度刻蚀工艺是迫切需要的。
在这项工作中,我们研究了一种新型方法,用于在大块 4H-SiC 上使用反应离子束刻蚀(RIBE,一种 IBE 的变体)在晶圆级别上制造具有三角横截面的悬浮光子器件。我们开发了一种 RIBE 工艺,用于在不同角度下刻蚀各种悬浮光子结构。接下来,我们展示了该刻蚀工艺在 5 英寸直径晶圆上的晶圆级应用,这是首次展示在任何块体材料中刻蚀悬浮结构的晶圆级工艺。最后,我们通过光致发光测量确认,集成到制造的光子结构中的色心的光学特性得到了保留,这是构建以色心作为量子发射器的量子信息处理(QIP)硬件的关键。
4H-SiC 的晶圆级刻蚀离子束刻蚀是一种物理铣削工艺,其中如氩气等惰性气体在射频离子源中被电离,这些离子通过一系列网格被提取并加速朝向基板,从而刻蚀目标基板。该工艺的变体,如反应离子束刻蚀(RIBE)和化学辅助离子束刻蚀(CAIBE),具有化学刻蚀成分,特别适用于选择性刻蚀或刻蚀耐铣削的材料。在 RIBE 中,离子源中的惰性气体被反应气体(如用于 SiC 的 SF6 和 O2)替代,朝向目标基板加速的反应气体离子束生成刻蚀。而在 CAIBE 中,离子源使用惰性气体,反应气体则被单独引入接近目标基板的气体环中。加速的惰性气体离子束在撞击接近目标基板的反应气体分子时,产生反应气体离子,从而生成刻蚀。虽然这两种变体都能产生理想的刻蚀效果,但 RIBE 提供了更优的刻蚀掩模选择性和晶圆级均匀性,而 CAIBE 对离子源的维护要求较低。

图 1 | 碳化硅的离子束刻蚀。
a. 在 4H-SiC 中制造三角横截面光子器件的纳米制造工艺流程。
b. 反应离子束刻蚀(RIBE)的示意图,使用倾斜的基板支架,在大块 4H-SiC 中纳米制造具有三角横截面的悬浮结构。
c. 三角结构的刻蚀角度(α)随基板支架倾斜角度(φ)的变化。
d–f. 1 μm 宽波导的三角横截面轮廓的扫描电子显微镜(SEM)图像,显示不同倾斜角度下的刻蚀角度:d 30°,e 45°,f 60°。
这些三角横截面的光子器件是使用图 1a 所示的工艺流程进行纳米制造的(具体细节见“方法”部分)。我们开发了一种 RIBE 工艺,涉及 SF6 和 O2 气体化学,同时保持 SF6 与 O2 的流量比为 4:1(刻蚀工艺参数见“方法”部分)。这些光子结构中的下切通过倾斜基板支架来实现(图 1b),以将离子引导到镍硬掩模层下方,并通过旋转基板支架来确保所有方向上的均匀刻蚀。刻蚀角度(α),定义为三角横截面顶点的半角,随着基板支架的倾斜角度(φ)线性变化,如图 1c 所示。由于次级制造过程,制造的器件的实际刻蚀角度与由倾斜角度决定的预期刻蚀角度偏差 15°。图 1d–f 显示了在倾斜角度分别为 30°、45° 和 60° 下刻蚀的 1 μm 波导的扫描电子显微镜(SEM)图像。以 60° 倾斜角度刻蚀的器件(图 1f)是 4H-SiC 中制造的三角横截面器件中报告的最高刻蚀角度(45°),其下切超过 1 μm。
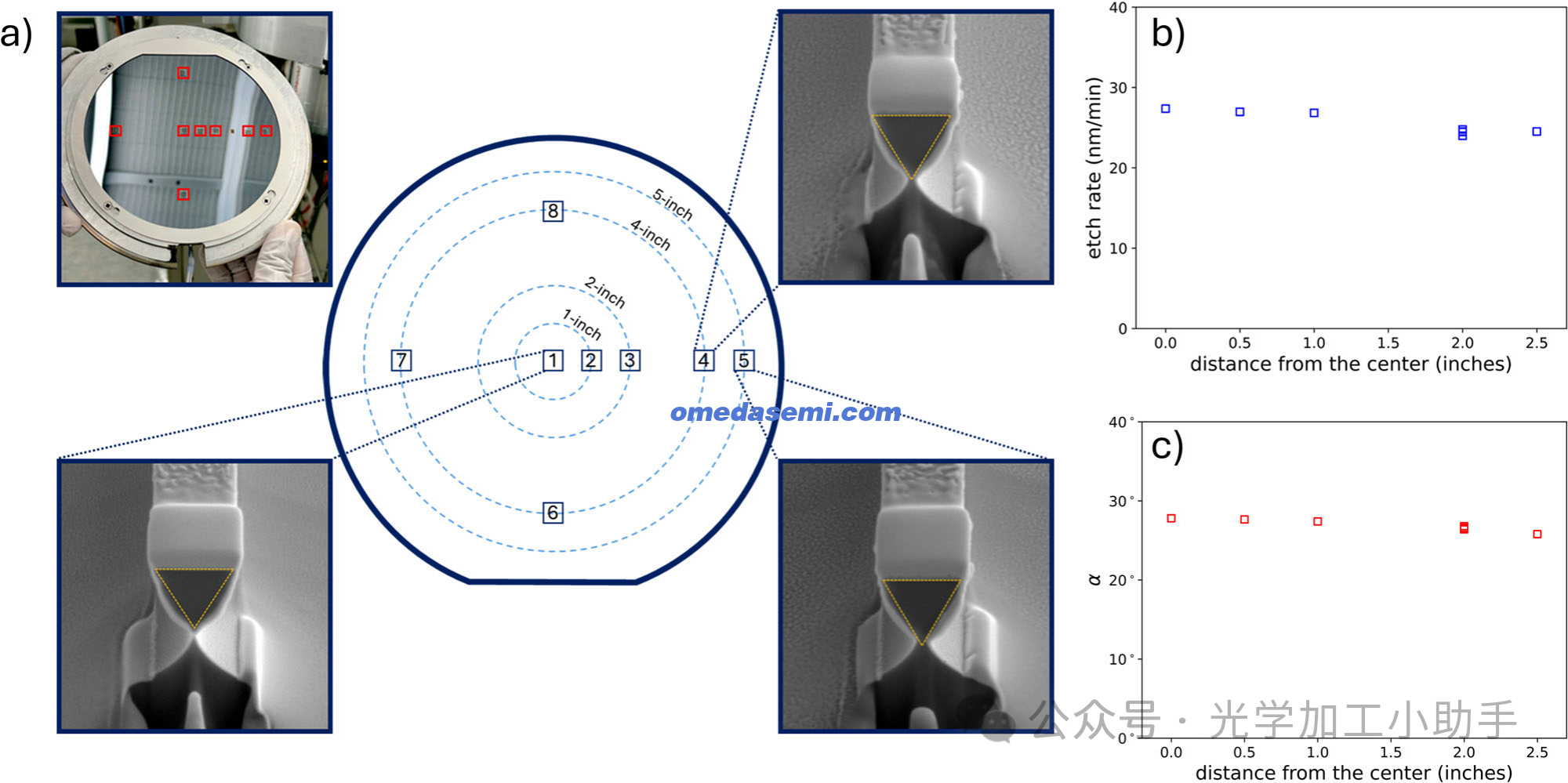
图 2 | SiC 三角纳米结构的晶圆级制造。
a. 示意图显示了 4H-SiC 样品放置在 6 英寸基板支架上的位置。4H-SiC 样品的位置代表了直径最大为 5 英寸的晶圆的圆周。(插图)基板支架上的 4H-SiC 样品及从一些示意芯片中纳米制造的 1 μm 波导的横截面轮廓。
b 和 c. 实现的 b. 刻蚀速率和 c. 刻蚀角度(α)均匀性随基板支架中心距离的变化,分别显示了 5.4% 和 2.9% 的变异性。
我们通过将总共八个图案化的 4H-SiC 样品放置在 6 英寸硅基板支架上,测试了 RIBE 工艺的晶圆级特性,样品的位置如下:一个样品放置在中心,分别放置在 1 英寸、2 英寸和 5 英寸晶圆的圆周上,四个样品放置在 4 英寸晶圆的圆周上,如图 2a 所示。所有八个样品都使用开发的 RIBE 工艺同时刻蚀,倾斜角度为 45°,刻蚀时间为 70 分钟。图 2a 插图显示了放置在中心和 4 英寸、5 英寸晶圆圆周上的 1 μm 波导样品的横截面扫描电子显微镜(SEM)图像。我们发现,刻蚀速率和刻蚀角度沿晶圆半径线性减少,如图 2b、c 所示。沿半径方向的刻蚀角度变化可归因于宽束 Kaufman 型离子源在 6 英寸直径范围内的离子束轮廓不均匀性。离子电流密度和离子方向性的径向减少分别导致了刻蚀速率和刻蚀角度的降低。刻蚀速率和刻蚀角度从晶圆中心到 5 英寸晶圆的圆周线性变化,分别为 12.3% 和 5%。在 4 英寸晶圆的四个样品上,刻蚀速率和刻蚀角度的变化分别为 1.2% 和 0.6%。该 RIBE 工艺的刻蚀速率为(25.9 ± 1.4)nm/min,刻蚀角度为(27±0.8)°,刻蚀选择性大于 8:1。据我们所知,这是首次展示在大块 4H-SiC 中纳米制造悬浮光子结构的晶圆级刻蚀工艺。
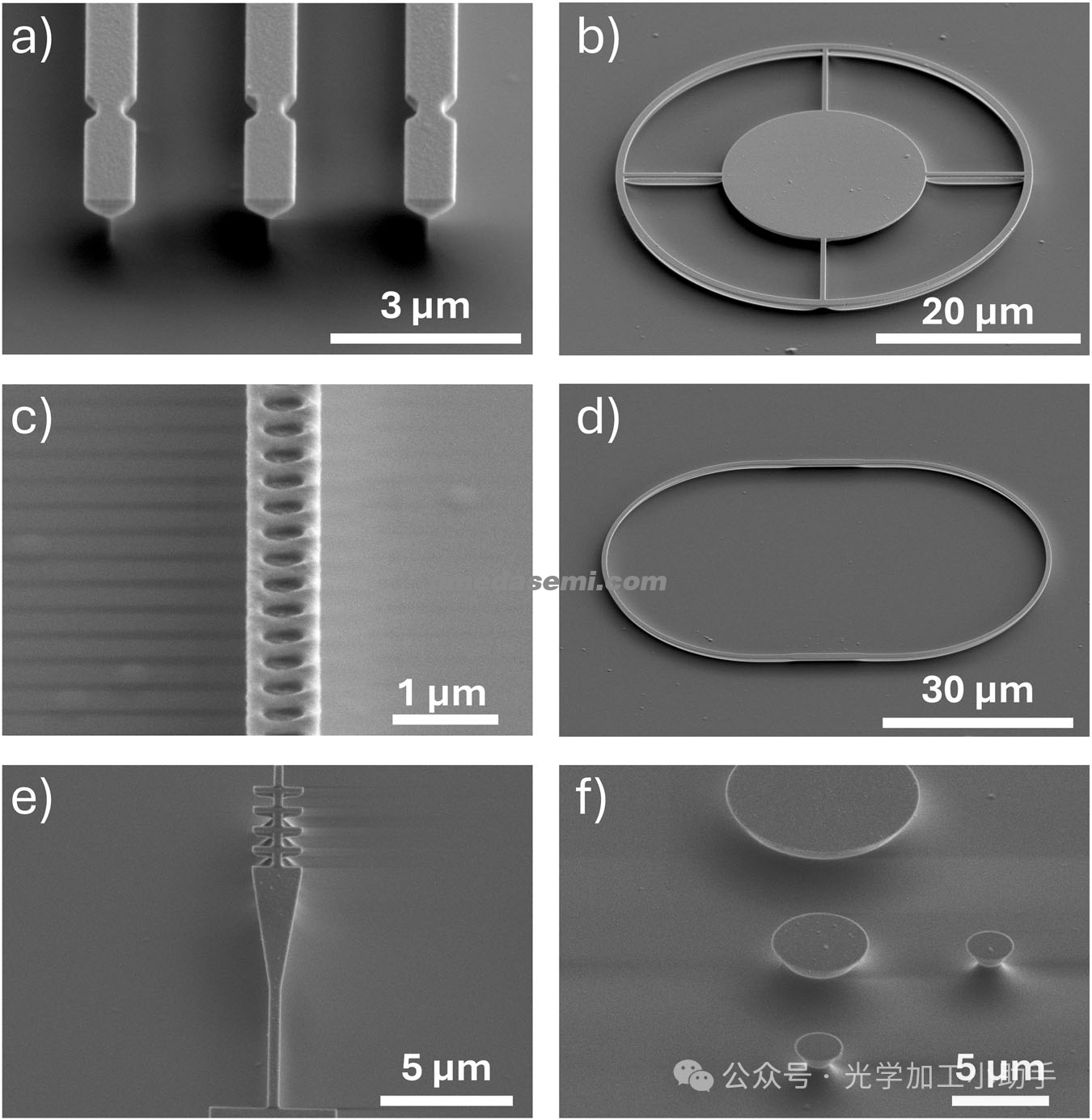
图 3 | 使用晶圆级角度刻蚀 RIBE 工艺纳米制造的 SiC 光子器件的扫描电子显微镜(SEM)图像。
a. 带有缺口耦合器的 0.8 μm 波导,
b. 半径为 20 μm 的微环谐振腔,
c. 宽度为 0.9 μm 的光子晶体腔体,邻近椭圆孔之间的间距为 0.495 μm,
d. 宽度为 0.8 μm、曲率半径为 24.6 μm 的环形谐振腔,
e. 鱼骨光栅耦合器,齿宽为 2 μm,间距为 0.8 μm,
f. 半径为 1.25、2.5 和 5 μm 的微盘谐振腔。
a–d 图像是在器件上方有镍金属硬掩模的情况下获得的,而 e 和 f 的图像则去除了镍掩模。
如图 3 所示,RIBE 刻蚀在一系列相邻的主动和被动纳米光子器件中表现均匀。我们使用我们的 3 合 1 集成低温系统进行发射、收集和光子探测,测量了集成到制造的三角光子器件中的氮空位色心的发射特性。图 4a 显示了 7 K 下三角横截面环形谐振腔的光致发光谱。该谱线特征包括零声子线(ZPL),对应自然存在的二空位色心(红色),波长为 1078、1108、1131、1132 nm,以及植入的氮空位色心(绿色),波长为 1175、1179、1222、1243 nm。这表明,我们的工艺解决了将色心与光子器件集成的关键挑战,因为许多制造工艺会破坏 ZPL 发射。为了测量发射保持的程度,我们在 T = 1.56 K 下拍摄了高分辨率的光致发光谱,如图 4b 所示,我们比较了来自块体(未刻蚀垫片)和三角波导的 NV 中心发射。由于背景噪声,信噪比适中,但两组光谱之间的非均匀线宽展宽相当可比。这表明,没有产生显著的应变或非晶化,并且色心的光学特性在集成到使用开发的 RIBE 工艺制造的三角横截面光子器件中时得到了保持。
讨论
前面部分的数据展示了我们认为是首次使用离子束刻蚀在量子级大块 4H-SiC 中制造三角横截面光子器件的晶圆级角度刻蚀工艺。重要的是,刻蚀过程不会干扰光子集成色心的光学特性。这种方法可用于制造具有广泛刻蚀角度的器件。在 5 英寸晶圆直径范围内,刻蚀速率和刻蚀角度的变化分别为 5.4% 和 2.9%,这些变化可以通过调整光刻掩模来抵消。相比之下,碳化硅-绝缘体(SiCOI)方法在 4 英寸晶圆上的厚度变化为 1 μm,如果使用统一的工艺制造,可能会导致整个晶圆上器件厚度增加三倍。
先前的建模结果表明,三角形光子晶体腔体的刻蚀角度变化会导致腔体的共振波长发生偏移,但不会显著影响品质因数和模式体积。刻蚀角度从中心到距中心 2.5 英寸的变化导致共振波长变化 1.2%,这一变化可以通过在掩模设计中引入 1.6% 的晶格常数变化来补偿这一共振波长偏移。对于三角波导,刻蚀角度变化 2.9% 并不会显著改变色心发射的耦合效率或这些波导的单模特性。刻蚀速率的变化在三角形器件的制造中并不发挥显著作用,因为它不会影响器件的形状,仅影响下切区域的高度。从理想情况下刻蚀角度等于倾斜角度的情形出发,刻蚀角度偏差 15° 的原因尚未完全理解。这个问题的可能原因包括在刻蚀过程中金属掩模在边缘的收缩,或者在附加刻蚀时间内对侧壁和三角横截面顶点的过度刻蚀,这需要进一步的研究。该工艺将应用于可扩展制造均匀表现的线性、非线性和量子光子器件,如波导、微谐振腔和光子晶体腔体,也可以应用于复杂的量子光学电路,如具有色心发射器的碳化硅网格光子学。通过利用其声学特性和化学惰性,该平台还可以支持光机学、光流体学和生物传感等应用。
方法
在光刻过程之前,我们通过商业化的氮离子植入(CuttingEdge Ions, LLC)在 4H-SiC 中生成氮空位色心,使用 N+ 离子,能量为 65 keV,剂量为 1 × 10¹⁴ cm⁻²,导致氮的峰值浓度出现在约 100 nm 的深度,深度由离子在物质中的停止和范围模拟(SRIM)计算得出。接下来,在氮气氛围中,将样品置于 1 英寸的 Lindberg Blue 管式炉中,在 1050 °C 下退火 60 分钟,以激活植入物。用于大块 4H-SiC 中三角光子器件纳米制造的工艺流程如图 1a 所示。首先,4H-SiC 样品被旋涂上一层 350 nm 的电子束光刻胶 PMMA 层,并使用 100 keV 电子束光刻将光子图案转移到这层光刻胶中((ii)和(iii))。然后,采用电子束蒸发法沉积 5 nm 的钛附着层和 120 nm 的镍硬掩模层,并通过剥离转移将光子图案转移到金属层上((iv)和(v))。三角横截面光子器件在 4H-SiC 中使用 Intlvac Nanoquest II 离子束刻蚀工具进行刻蚀,最后通过湿法刻蚀样品中的金属层,使用 Transene 的镍和钛刻蚀液((v)和(vi))。具有镍图案的 SiC 芯片在 Intlvac Nanoquest II 中使用 RIBE 进行刻蚀,该设备配备有 16 cm 直径的 Kaufman & Robinson RF 离子源和可倾斜旋转的台面。优化后的 RIBE 工艺参数为:束流电压 = 300 V,加速电压 = 120 V,束流电流 = 110 mA,RF 功率 = 150 W,Ar/SF6/O2 流量 = 10/10/2.5 sccm,压力 = 0.24 mTorr,基板温度 = 20 °C,刻蚀时间 = 每个刻蚀周期 35 分钟,共两个刻蚀周期,每个周期之间有 2 分钟冷却时间。氩气与 SF6 和 O2 一起添加到离子源中,以保持束流参数的稳定性。