SOI晶圆:--220nm薄膜/ 3um厚膜-3umSIO2-675um薄膜硅光:常见厚度220nmSi-3umSiO2-675umSi(有库存),可以定做其他厚度,同时也有单高阻SOI晶圆用于异质集成(异质集成PD),双高阻SOI晶圆用于CPO
厚膜硅光:常见厚度3000nmSi-3umSiO2-675umSi(有库存),该工艺为芬兰VTT公司提出,与OKEMTIC公司合作开发,目前我单位在6寸上可以达到与OKemetic同样器件层厚度精度+-100nm
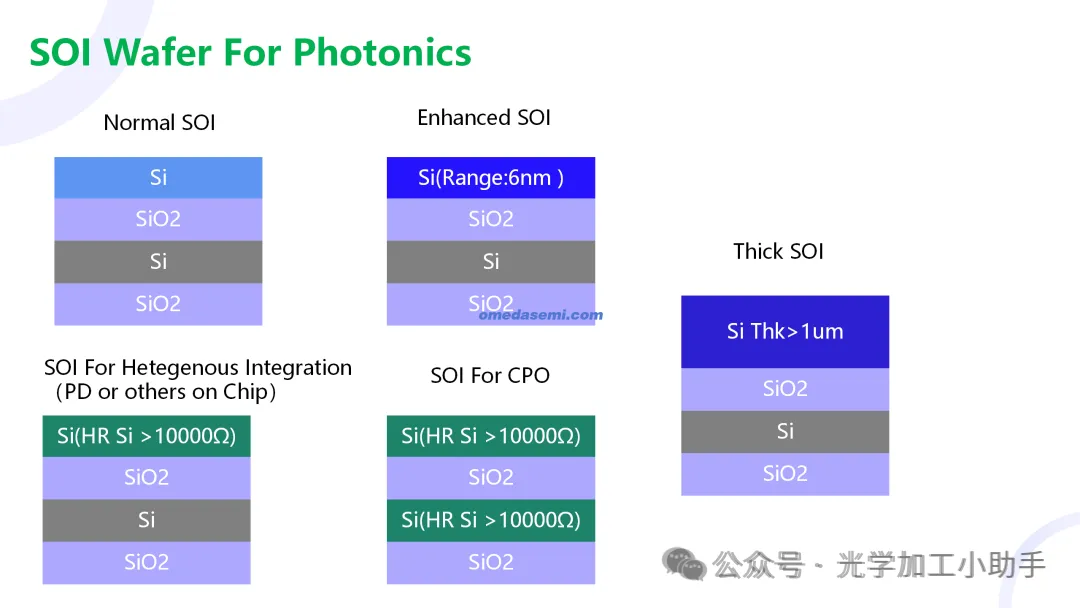
ALOOI晶圆;--氧化铝薄膜晶圆,键合工艺和镀膜工艺
TAOOI晶圆--氧化钽薄膜晶圆,镀膜工艺
SINOI晶圆--超低损耗氮化硅薄膜晶圆,160nm-180nm-200nm-300nm-350nm-400nm-800nm
SICOI晶圆;新型量子光学平台500nm-700nm-1um
8寸LTOI晶圆批量供应;铌酸锂的有力的竞争对手,薄膜钽酸锂晶300600
8寸LNOI晶圆;8寸LNOI助力更大规模薄膜铌酸锂产品量产
流片: 6寸 氮化硅 铌酸锂 硅光 超高性价比流片, 1个BLOCK的价格买一整片晶圆
划重点--全国产-超高性价比-6 寸硅光-氮化硅-铌酸锂流片白皮书
我们为客户提供晶圆(硅晶圆,玻璃晶圆,SOI晶圆,GaAs,蓝宝石,碳化硅(导电,非绝缘),Ga2O3,金刚石,GaN(外延片/衬底)),镀膜(PVD,cvd,Ald,PLD)和材料(Au Cu Ag Pt Al Cr Ti Ni Sio2 Tio2 Ti3O5,Ta2O5,ZrO2,TiN,ALN,ZnO,HfO2。。更多材料),键合(石英石英键合,蓝宝石蓝宝石键合)光刻,高精度掩模版,外延,掺杂,电子束光刻等产品及加工服务(请找小编领取我们晶圆标品库存列表,为您的科学实验加速。
请联系小编免费获取原文
文章名:Electrical manipulation of telecom color centers in silicon作者:Aaron M. Day 1,4, Madison Sutula 2,4, Jonathan R. Dietz 1, Alexander Raun1,Denis D. Sukachev3, Mihir K. Bhaskar3 & Evelyn L. Hu 11、John A. Paulson School of Engineering and Applied Sciences, Harvard University, Cambridge, MA 02138, USA.
2、Department of Physics, Harvard University,Cambridge, MA 02138, USA.
3、AWS Center for Quantum Networking, Boston, MA 02135, USA.
4、These authors contributed equally: Aaron M. Day, Madison Sutula.
硅是一种基础材料,广泛应用于计算、电子和光子学领域。因此,考虑将其作为量子信息处理应用的载体是非常具有吸引力的。尽管固态中的颜色中心已经成为一个有前景的量子存储平台,但最成熟的颜色中心技术(1-11)都托载在一些难以制造的材料中,如钻石和碳化硅。最近,在研究G中心和T中心方面取得的进展重新激发了人们对硅颜色中心作为量子发射体的兴趣(12-16)。此外,硅颜色中心与纳米光子学集成的演示(17-24)揭示了利用硅在可扩展设备工程方面的悠久历史,来实现有用的量子技术的潜力。然而,要实现高产率和可重复形成单一的G和T中心,仍然需要更好地理解材料处理。
虽然大多数关注点集中在将颜色中心与光子结构集成以增强缺陷读取,但与电子设备的集成也为缺陷控制提供了互补的好处。颜色中心性能的电子控制在其他平台上已经得到了观察,包括线宽变窄(8)、斯塔克调谐(8, 25, 26)、电荷态操控(27, 28)和读取(29)。最终,单一颜色中心的电子控制可能允许调节和稳定,从而产生不可区分的自旋-光子界面。然而,首先,研究发射体集合与电子结构的相互作用是有用的,因为它可以通过集合与设备电场的局部耦合来稳健地映射设备的电子特性。这种集合级别的设备表征对于理解未来用于单一缺陷控制的设备中缺陷的典型性能至关重要。
关键是,硅G中心的电场相互作用尚未被表征。因此,电子设备可以为缺陷和电荷噪声环境及其对集成颜色中心的光学和自旋相干性的影响提供重要的洞察。本文中,我们描述了这样一个电学平台:我们通过将G中心集合与在硅-绝缘体(SOI)中制造的横向p+-p-n+二极管集成,研究了硅颜色中心对施加电场的低温光学响应(图1a)。
图1 | 二极管集成硅G中心
a 碳相关硅颜色中心集成到横向p+-p-n+结(二极管)中,这些二极管是通过硅-绝缘体(SOI)材料制造的,并由焊接在16针氦制冷剂接头上的电连接器驱动。
b 颜色中心通过532 nm激光进行光学激发,并在通信O波段的1278 nm处发光。
c 制造二极管的侧面剖视图。p型和n型掺杂是通过离子植入实现的,并且氢被局部掺入,以选择性地在结中心形成G中心。
d 集成G中心集合的封装二极管的电流-电压(IV)曲线,在制冷至约6 K的工作温度时进行测量。插图显示在-200 V时低反向偏压泄漏电流,达到-0.5 μA。
G中心——由两个替代碳原子与一个间隙硅原子结合组成——是一个光学活性的O带发射体(图1b)。我们发现,氢植入是形成G中心所必需的。通过选择性地使用光刻掩膜对一个先前已经全面植入碳的晶圆进行氢植入,可以在未掩膜的区域创建一个局部化的集合,该区域位于制造的二极管的中心,在外部偏压下形成耗尽区。超过一个空间依赖的阈值电压时,集合的零声子线(ZPL)波长出现红移,红移率约为1.24 ± 0.08 GHz/V,最高可达到100 GHz。此外,我们观察到随着反向偏置电压的增大,G中心的光学荧光不断减少,在-210V时,荧光完全被抑制。最后,我们利用观察到的发射体-场耦合来成像结区内电场的空间分布。ZPL调谐和荧光熄灭的空间依赖性表明,这些机制可能归因于电场与缺陷的偶极矩相互作用的斯塔克效应以及由于带弯曲引起的电荷人口变化所造成的缺陷电荷状态的变化。我们的方法具有广泛的适用性,可以用于未来的量子网络实验控制,并作为探测基本颜色中心行为的工具。同样,利用颜色中心集合可以精确确定发射体在PN结中所经历的局部电环境。这种方法可以方便地扩展到探测和控制硅中的其他颜色中心,以及在广泛的半导体平台中的颜色中心,这些平台如碳化硅易于掺杂。
结果
集成G中心集合的横向二极管
我们的平台实现了一个空间隔离的G中心集合,最大程度地与埋藏平面的电二极管相互作用,并最终与集成硅光子学兼容。220 nm硅层中光子晶体腔的最大光模式浓度位于110 nm,因此我们实施了一种设计和制造策略,支持未来半导体量子发射体的电光耦合。为此,我们采用了行业标准的220 nm SOI晶圆,在110 nm深度处嵌入了掺杂定义的二极管。离子植入与连续对准的光学光刻结合,允许在所需深度局部化掺杂p和n以及G中心集合(图1c)。采用刻蚀定义的金属化策略,确保在掺杂平面处的稳健电接触和性能,且设备经过封装,准备进行低温表征。设备的电流-电压特性(图1d)不会随着温度或氢植入的掩膜而退化,并且在高反向偏压下表现出低泄漏电流(图1d插图)。
设备设计与制造
横向二极管是在商业SOI中制造的(University Wafer,220 nm Si,2 μm埋氧绝缘体,掺硼,ρ = 10 − 20 Ω cm,〈100〉方向),以便同时进行低温光学和电学测量颜色中心。设备的起始基底是轻度掺p型的,基于先前的发射体合成报告(15,19),尽管在本征材料中电性能会有所改善。设备设计使光学访问变得简便,结宽可调,且可以在单个商业晶圆上制造数百个具有不同参数的设备,这些设备是通过光学光刻定义的。此外,设计将形成的颜色中心与掺杂定义的结定位于同一空间平面,从而改善了发射体-场的相互作用。设备性能通过COMSOL Multiphysics半导体模块(见补充注释6)进行了验证。设备的完整设计和制造过程如图2a所示。设备相关区域的自上而下示意图如图2b所示,并附有成品设备的光学图像(图2c)。设备制造的详细信息见方法部分。
图2 | 设备设计与制造
a 实现SOI中二极管集成G中心的制造过程。
b 完成的电气设备的俯视图示意图。
c 相关的光学显微照片,展示了成品设备的外观,并标出了显著区域。结区间距d在晶圆上有所变化,以实现不同的发射体-场耦合强度。
集合体掺入
为了在二极管中形成G中心,我们首先用碳离子植入硅,然后在1000°C下进行快速热退火以修复晶格损伤。然而,与一些先前的工作(17-19,30)不同,我们在此阶段没有观察到G中心。与其他研究的发现一致,认为质子辐照有助于间隙碳的掺入形成G中心(12,31),我们研究了多种氢化方法以完成G中心的形成(参见补充说明7-8)。最终,选择了掩膜离子植入氢的方法,将氢选择性地引入设备-发射体集成区域,以在电场最强的目标深度形成明亮的局部集合,同时对电性能几乎没有降解。与氢在G中心形成和稳定中的作用一致,我们发现集合发射只局部化在植入掩膜区域。此外,我们发现G中心在200°C以上不稳定(补充信息),这与之前的工作一致(32),因此需要将氢掺入作为最终制造步骤。为了确保二极管制造与G中心生产兼容,两种制造过程的步骤被交替进行。
电学调控
对二极管施加反向偏压可以对结集成的颜色中心环境进行多种有利控制。在平衡条件下,中间带缺陷态的占据由费米能级与缺陷的电荷跃迁能级的位置决定。通过调节费米能级,无论是通过引入外源掺杂、内源缺陷、表面功能化,还是通过电子结构中的带弯曲进行主动调节,都可以通过使缺陷的暗态或亮态在统计上更容易出现,来改变缺陷的相对亮度。事实上,费米能级已被发现是颜色中心光学活性的关键因素(33-35)。在二极管的耗尽区内,电荷分布受准费米能级(EF,n和EF,p)位置的影响。此外,缺陷的选择性电荷分布可能表现出更大的稳定性,避免了来自导带自由电子或价带自由孔的跃迁。二极管耗尽区内的内部电场也可能与G中心相互作用,产生斯塔克效应,正如已观察到的其他颜色中心(25,27,36)。此外,反向偏置驱动具有低泄漏电流,确保了最小的局部加热。因此,二极管集成颜色中心的电学调控将调节它们的光致发光光谱。
因此,我们首先表征了在施加反向偏置直流电场下,氢植入孔区域局部化的二极管集成G中心集合的光学响应。作为局部温度的标定,硅自由激子在相同条件下也进行了表征。为了更全面地了解集合光学响应的空间变化,我们监测了不同反向偏置电压下的光致发光和光激电流。
反向偏置下的G中心集合响应
图3a-b展示了G中心集合对反向偏置直流电场的响应。我们在0至-210 V的反向偏压下,每次以10 V为间隔测量了光致发光(图3a)。随着反向偏置的增大,集合的荧光强度减小,直到信号降到测量的噪声水平以下(图3b)。在超过空间依赖的阈值电压时,观察到G中心的零声子线(ZPL)波长出现大约100 GHz的红移,红移率约为1.24 ± 0.08 GHz/V。此外,随着中心波长红移,集合的线宽也变宽(参见补充说明3A)。部分地,电场对电压的依赖性在区域完全耗尽之前呈现出平方根关系(37)。电场方向与部分G中心群体的选择性相互作用,并且根据斯塔克效应的方向,可能会使观测到的整体发光峰变宽。未来的单发射体实验可能有助于阐明具体机制。
图3 | 反向偏置电学调控
a 在施加反向直流电场的情况下,G中心的零声子线(ZPL)光学响应。随着反向偏压从0 V增加到-210 V,发射强度持续下降,而中心波长约红移100 GHz。
b ZPL调制比随反向偏压的变化分析,在-210 V时实现100%的调制。数据归一化至零偏压下的ZPL强度。
c 反向偏置下硅自由激子的保持情况。与G中心不同,激子强度、中心波长和线宽与反向偏压的增加没有相关性,表明热效应不是观察到的G中心行为的显著来源。
在-200 V下,反向电流为-0.5 μA,对应的施加功率为100 μW,分布在103 μm的结区间隙上。设备在高反向偏压下保持低泄漏电流,因此局部加热不太可能是观察到的G中心展宽、红移和调制的来源。为说明这一点,我们在相同偏压条件下研究了硅自由激子线的演变(图3c)。硅自由激子在高温下被抑制,因此作为局部结加热的探测工具。我们在0至-210 V的反向偏置下测量了激子光致发光(PL)(图3c)。激子发光在反向偏置下没有发生变化,这与没有显著加热一致,波动归因于实验中的噪声。我们注意到,激子中不对称的部分来源于未完全分辨的与横向光学(TO)和纵向光学(LO)带相关的峰,这些峰位于1130 nm附近(38)。这些G中心和硅自由激子的结果与在补充说明4中对高功率正向偏压下的行为进行了对比。
通过捕捉发射体光学响应在结区的分布,可以帮助表征发射体-场相互作用的性质。通过使p接触相对于n接触逐渐变负,可以简单地在耗尽区域创建电场,后果应体现在结区的光致发光轮廓中。理想情况下,由于我们二极管的横向几何结构,随着反向偏置增大,我们应期望耗尽层宽度均匀增加。然而,中心氢植入区域可能会影响该区域的费米能量,以及二极管之间反向偏置场的线性度。光激发反向偏置结将产生光电流,这提供了另一种映射耗尽区域的方式,从而可以交叉关联缺陷集合的光致发光响应提供的空间信息。为此,我们成像了电场与G中心集合的耦合空间分布(图4上排),并与二极管在0偏压(图4a)、-100 V(图4b)和-200 V(图4c)下的光电流进行了关联。
图4 | 发射体-场相互作用的空间分布
反向偏置下二极管的共聚焦图,展示了不同反向偏压下的集合光致发光(顶部行)和测量的结光电流(底部行):
(a) 0 V,
(b) -100 V,
(c) -200 V。
结区的耗尽区域分布通过ZPL光学强度调制来表征,该调制从最靠近n型接触的区域开始,在集合体中扩展,并通过将光学响应与结区测得的光电流相结合,得到强一致性。PL颜色条的噪声底限设置为0.2,因1秒积分。调制比通过对比图(a)顶部的零偏压下的平均ZPL强度进行归一化得到。
在0V时,G中心集合的局部化是明显的(图4a顶部)。G中心的光致发光(PL)仅在二极管中心的50 × 50 μm孔区域观察到,该区域通过氢植入形成。与零偏压下的预期一致,测量的光电流可以忽略不计(图4a底部)。
共聚焦扫描在反向偏压为-100V时重复进行(图4b)。在-100V时,G中心的光学强度调制比在空间上是依赖的,靠近n接触的氢植入孔区域的发射体表现出比靠近p接触的发射体更强的抑制效应,抑制幅度为40%。有趣的是,通过将共聚焦PL(顶部)与设备中共聚焦激发的光电流(底部)进行比较,发现集合体——因此氢的存在——减少了通过结的电流,因结内孔区域(孔上方和下方)表现出更强的光电响应。我们认为这可能是由于(a)这些区域的反向偏置配置不同,以及(b)氢植入提供了用于光生电子和孔的陷阱态(39),导致结区域外的光电流强度更大。
最后,在反向偏置为-200V时,重复了共聚焦PL和光电流的空间扫描(图4c)。靠近n型接触的区域,G中心荧光的100%调制被观察到(图4c顶部)。相反,靠近p接触的区域,G中心仅受轻微抑制。此外,相关的共聚焦激发光电流(图4c底部)也遵循相同的空间模式。在结区测量的光电流在发射体强度调制最大的位置达到最大值,确认最大耗尽区域与最强的发射体相互作用相对应。随着反向偏置场强的增加,经历最大光学调制的集合体的空间范围从n接触区域向p接触区域扩展,因为电子和孔被分别扫向它们的n型和p型接触(图4a-c)。
尽管在结的中心观察到部分光学调制,但没有观察到波长调节(图5a红色)。这一发现与先前的实验(8)和理论研究(37)一致,在反向偏压低于某个临界值时,耗尽区的尺寸小于结宽度。在(8)中,观察到在4H-碳化硅的垂直二极管的不同空间平面上,观察到单个双空位的斯塔克效应的阈值电压依赖于发射体在结中的位置。在这里,我们通过直接成像整个二极管耗尽区的空间依赖性来扩展这一论点。当结的耗尽区到达集合体时(图5a棕色),观察到持续的红移,约为1.24 ± 0.08 GHz/V(图5b)。然而,距离几微米的地方,结的耗尽区尚未与集合体重叠,因此没有观察到波长调节(图5a红色)。非均匀的电场和以过量电荷形式存在的电噪声掩盖了G中心的差异极化性(18)以及斯塔克位移调节的确切性质。然而,未来通过在PIN二极管未掺杂I层中使用单个发射体的实验,将有助于与理论预测的永久偶极矩进行比较,因为精确的斯塔克位移速率可以通过单个发射体清晰地捕捉,并且缺少残余掺杂剂将改善电场的均匀性。
图5 | G中心光学响应在结区的变化
a 集合体响应在图4c的共聚焦PL图中从0 V到-200 V之间进行了分析。接近n接触(棕色)时,集合体经历了完全的光学调制和波长调节。波长调节表现为虚线之间的距离(完整数据集见图3)。在结中心(红色)时,集合体经历了部分光学调制,但没有波长调节。
b 集合体中心波长的红移与施加的反向偏压的关系为1.24 ± 0.08 GHz/V,通过图3a数据的高斯拟合得到(详细信息见补充说明2)。给出了带有一个标准差的线性拟合。
c 观察到的反向偏压红移示意图。结的耗尽区(波浪曲线)在达到足够大的阈值电压(蓝色到青色)时到达集合体(中心的橙色方块和黑色发射体),从而导致波长调节。
d 随着反向偏压增加,模拟的带弯曲(虚线)与实验测得的ZPL强度的一维切片(实线)之间的空间相关性。
波长调节仅在也表现出强光电流的区域观察到,这表明该区域内存在耗尽区和大局部电场。此观察概念上展示在图5c中,其中随着反向偏置的增加,结的耗尽区(波浪线)——通过共聚焦激发的光电流确认——及相应的发射体调节从n接触扩展到p接触(更浅的色调)。这些结果表明,斯塔克效应可能是导致观察到的发射体红移的原因。这些区域内结的硼掺杂剂已足够离子化,因此可以建立电场,从而导致斯塔克位移的G中心。
最后,在反向偏置增加时,G中心的光强度在耗尽区内外都发生了调制。这个观察可以通过考虑通过费米能级工程修改缺陷电荷状态的影响来解释。预测的带弯曲趋势和集合亮度的空间关系是良好相关的(图5d),这表明在增加反向偏压时,光学活性电荷态的耗尽。随着费米能级在外部偏压下的调节,G中心可以被电离到非发光的电荷态(41,42)。我们的观察结果与这一解释一致:随着我们在结中增加反向偏压,发射体会以概率方式被电离到暗态,作为结果带弯曲的函数。
集合体的中心波长和标称(零偏压)亮度在终止二极管偏压后恢复——无论在正向还是反向偏压下——因此集合体的电荷状态并未在测量中永久改变。此外,在恢复发射体光学特性时没有观察到时间延迟,尽管未来更敏感的时域测量将提供有关响应瞬态特性的详细信息。
讨论
我们通过将G中心集成到二极管中并保留光学访问,探讨了通信波段硅颜色中心与直流电场的耦合。我们随后利用集合体的电学调控来成像二极管内电场分布,捕捉了在不同反向偏压下结区耗尽区域的空间演化。在结区的耗尽区域内,ZPL的强度减小,并且波长红移约100 GHz,红移率为1.24 ± 0.08 GHz/V,超过阈值电压,而在耗尽区外仅观察到ZPL荧光强度的调制。这些发现表明,发射体与电场的耦合表现出明显的空间依赖性,其中电荷态调制和斯塔克效应可能解释了观察到的现象。此外,我们发现氢在我们的设备中观察G中心起着关键作用。为此,未来的工作将继续阐明G中心的形成和稳定化的具体机制,包括通过氢化和电学调控。最后,我们注意到我们所展示的将缺陷从光学亮态转换为暗态的能力,同样可以在反向过程中发生——通过施加反向偏压来调节费米工程,可能有利于从暗态转化为亮态。衬底的平衡费米能级将决定缺陷的电荷人口,这由背景掺杂给定。在这次示范中,使用所选的基片,G中心在平衡时是光学活跃的,因此增加反向偏压可能会导致光学活跃电荷态的去人口化。
这些设备为电学调控颜色中心提供了一种工具,具有广泛的应用性,既可应用于其他硅颜色中心,也可应用于其他半导体平台中的颜色中心。这些发现利用颜色中心集合体展示了结区发射体与电场耦合的空间分布,将激励并指导电气设备的设计,以最优地与单个发射体耦合。特别有兴趣的是观察硅T中心对二极管的电学调谐响应,因为T中心具有相干的自旋-光子界面(15),并且据报道其合成过程与这里实施的类似。此外,我们展示了在半导体中直接可视化电场动态——在原位光学映射直流电场——这在量子电场传感中有应用(43)。最后,我们的横向二极管设计,位于110 nm的埋藏平面,兼容光子晶体腔集成(44,45),未来的工作将使得电学调谐、稳定性和腔增强量子发射体的控制同时实现。
方法
制造
所有的碳、氢、硼和磷离子植入都在INNOViON公司进行。离子植入能量是通过使用物质中离子停止范围(SRIM)计算(补充信息)来确定的,针对每个离子的深度大约为110 nm。掺杂剂密度选择为在所需深度获得1 × 10¹⁹/cm³的受主/供主浓度,因为这个量级对于硅中的电气设备来说是典型的。此外,将最大掺杂浓度深度与刻蚀定义的金属化重叠,确保了金属-半导体界面的透射性欧姆接触。每次植入都以7°倾斜角度进行。所有的掩膜植入都使用正光刻胶掩膜S1813,在375 nm波长下以250 mJ的能量进行光刻,采用Heidelburg Maskless Aligner 150进行对准。光刻胶在115°C下预烘3分钟,并在TMAH基CD-26中显影70秒。每个光刻胶掩膜都通过500 W的O₂等离子体去除,并通过在80°C下浸泡12小时的PG去除剂去除Ti-Au掩膜。
首先,将未掩膜的硅晶圆片植入7 × 10¹³/cm²的12C离子,能量为38 keV。接下来,通过光学光刻在光刻胶掩膜上写入500 × 500 μm的孔,并以29 keV的能量通过这些孔植入1 × 10¹⁴/cm²的11B离子,从而定义局部的p型掺杂岛。在去除光刻胶后,通过偏移500 × 500 μm孔,再通过光学光刻定义的掩膜,植入1 × 10¹⁴/cm²的31P离子,形成n型掺杂岛。p型和n型掺杂孔之间的间距(图2b)在晶圆上变化,以调节给定电压下的结区电场强度。为了修复晶格并将掺杂剂替代性地引入硅晶格(32),在去除光刻胶后,采用1000°C的快速热退火(RTA),在氩气环境中退火20秒。
接下来,通过在新的光刻胶掩膜中写入250 × 250 μm孔,并使每个开口与植入的掺杂岛中心对齐,生成电气接触。使用SF6和C4F8化学物质在反应离子刻蚀室中刻蚀暴露的窗口220 nm,直到氧化物层,以确保金属接触与植入的掺杂剂最优重叠。定义了一个新的300 × 300 μm光刻胶掩膜(S1813在LOR3A上的掩膜),并在电子束蒸发过程中沉积了300 nm的金薄膜和30 nm的钛粘附层(Ti-Au)。
为了完成G中心集合体的掺入,通过光刻胶掩膜中的50 × 50 μm孔,将氢离子植入每个结区的中心(图2b)。通过这种方式植入7 × 10¹³/cm²的H离子,能量为9 keV,形成二极管集成的G中心集合。晶圆片随后被切割成6 × 6 mm的样本,并集成到一个16针电气接线的低温冷指中,通过外部接线驱动(图1a)。
实验设置
实验在一个自建的共聚焦显微镜中进行,使用Mitutoyo 100 × 0.5 NA近红外物镜。G中心通过532 nm的二极管泵浦固态激光进行光学激发,二极管通过±210V的Keithley 2400源表进行偏置。光学和电气测量在Janis ST-500连续流氦冷制冷剂中同步进行,制冷系统具有16针电气引线,通过电线与二极管连接。该系统的基础温度大约为6 K。二极管集成颜色中心的光致发光通过Acton Spectra Pro 2750分光光度计和Princeton Instruments OMA:V铟镓砷氮冷却光电二极管阵列探测器进行测量。拉曼光谱通过LabRAM Evolution Horiba多线室温共聚焦拉曼光谱仪使用532 nm激光激发进行测量。
共聚焦激发光电流
这里提供了关于生成图4数据的测量的额外信息。激光束通过快速调节镜扫描二极管。在每个扫描点,触发脉冲同时发送到分光光度计和源表施加反向偏置,以同时记录光致发光光谱和在给定共聚焦点的光激光电流。这使我们能够精确地同时映射二极管中的集合体光致发光和电流的空间相关性。






