摘要
在二维光子晶体(PhCs)中实现平滑且垂直的侧壁轮廓对于集成光学器件中的光子晶体波导(PCWs)至关重要,因为“火山”形状的光子晶体会导致光泄漏和光子带隙漂移。本文优化了感应耦合等离子体反应离子刻蚀(ICP-RIE)工艺,以改善Ta2O5光子晶体波导的侧壁轮廓,最小光子晶体尺寸为300 nm的间距和185 nm的直径。通过统计软件(MINITAB)生成了一系列实验,以有效地研究工艺空间中感兴趣区域,通过调整RF平台功率、ICP功率、气体混合物中C4F8的百分比(C4F8和O2)和腔室压力。随后,确定了最适合的实验条件,并用作中心运行,以分析单个参数对Ta2O5的ICP刻蚀的影响。主要发现包括:保持50% C4F8在总气体流量中的比例的重要性,以及ICP和RF功率调整的权衡。压力对侧壁角度的影响微乎其微,但对刻蚀速率和微掩模效应有更明显的影响。在这些参数之间保持微妙的平衡对获得最佳刻蚀结果至关重要。推荐的工艺配方(50 W RF平台功率、2000 W ICP功率、10 mTorr压力、总气体流量中50% C4F8)可获得113.325 nm/min的刻蚀速率,并在光子晶体中实现平滑且垂直的侧壁。整个刻蚀探索过程是在沉积在Si基底上的Ta2O5层上进行的。此外,该工艺配方还被应用于刻蚀在Ta2O5层和Si基底之间插入2 μm SiO2层的Ta2O5,取得了良好的结果,并保持了光子晶体侧壁的完整性。
划重点:
TAOOI晶圆--氧化钽薄膜晶圆,镀膜工艺, 离子束溅射镀膜工艺,磁控溅射镀膜,膜层质量高,支持68寸,大批量生产制造,超高的顶层膜厚精度及均匀性#6寸DUVKRF流片--SIN/铌酸锂晶圆级流片
#利用现有掩膜版提供流片好的SIN晶圆做键合工艺调试
*近化学计量比 Z切 X切 Stoichiometric_LNOI/LTOI 薄膜铌酸锂 和钽酸锂晶圆 -----量子应用#高电光系数和非线性光学系数 #更少的短波吸收 #更小的矫顽场SLT和SLN与其对应的同成分相比电光系数和非线性系数都有比较大的提高,有利于电光器件的制作。对于制作周期极化结构,其畴结构的变化和矫顽场的降低,制作的周期结构更加容易和质量更好。由于SLT折射率差值变得更小,Ppslt更容易在量子光学上得到应用。ALOOI晶圆;--氧化铝薄膜晶圆,键合工艺和镀膜工艺
SINOI晶圆;--超低损耗氮化硅薄膜晶圆,
SICOI晶圆;新型量子光学平台
6寸LTOI晶圆批量供应;铌酸锂的有力的竞争对手,薄膜钽酸锂晶圆
8寸LNOI晶圆;8寸LNOI助力更大规模薄膜铌酸锂产品量产
LN/LT-SOI/Si/SIN W2W&D2W异质集成
流片: 6寸 氮化硅 铌酸锂 硅光 超高性价比流片, 1个BLOCK的价格买一整片晶圆
划重点--全国产-超高性价比-6 寸硅光-氮化硅-铌酸锂流片白皮书
I. 引言
五氧化二钽(Ta2O5)是一种在光学和硅光子学领域中具有前景的材料,因为它具有高折射率,并且其光学常数已经在从可见光到远红外的广泛光谱区域内得到了测定。1 用于波导中的Ta2O5显示出超低损耗C波段光导、高阶模式超连续谱生成、光学微推进、片上放大器和滤波器等方面的巨大潜力。光子晶体(PhCs)是周期性纳米结构,用于影响光的传播,它们创造了光子带隙(PBGs),在这些频率范围内光无法传播。7 将光子晶体集成到硅光子学中有助于最小化光学元件、8 提高光与物质的相互作用、9,10 并增强非线性光学效应。11 光子晶体波导(PCWs)是将光子晶体集成到硅光子学中的基本组件。
图1. ICP蚀刻机示意图。
感应耦合等离子体反应离子刻蚀(ICP-RIE)是用于Ta2O5干刻蚀的常用方法之一。图1展示了ICP刻蚀机的示意图。两个RF发生器在等离子体生成中起着关键作用:RIE RF发生器和圆柱形ICP RF发生器。12,13 RIE RF发生器通过对平行板电极的RF激发电容性地生成等离子体,电离腔体中的气体,并在电极之间产生电磁场。在平行板之间产生的负自偏压会加速正离子朝向样品,使其沉积到带电电极上。离子能量可以达到几百电子伏(eV),从而产生具有相对较高离子能量但低密度的等离子体。相比之下,圆柱形ICP RF发生器通过对位于腔体外部的线圈进行RF激发产生高密度的感应耦合等离子体,该线圈被屏蔽以防止任何电容耦合。该线圈在腔体内产生电磁场,同样电离气体并创造高密度等离子体。配备平板RIE和圆柱形ICP发生器的优势在于,它提供了分别调节等离子体密度和离子能量的机会。晶圆通过机械加载、夹紧,并在背面氦气冷却以优化热导性。ICP工艺利用物理刻蚀和化学刻蚀。物理刻蚀涉及高速正离子溅射刻蚀;而化学刻蚀则通过等离子体与材料表面的相互作用生成中性反应物质,从而产生挥发性产物。14,15 在刻蚀特性方面,化学刻蚀提供了高刻蚀速率、高选择性,并且对离子轰击引起的损伤最小,但刻蚀轮廓为各向同性。相比之下,物理刻蚀实现了各向异性的轮廓,但会造成严重的轰击引起的损伤,并且选择性较低。14 ICP刻蚀中物理与化学刻蚀的结合可以实现各向异性的刻蚀轮廓,且具有适度的损伤。
基于氟或氯的化学方法被发现能够实现Ta2O5 ICP刻蚀的最大刻蚀速率,约为120 nm/min,相较于CH4/H2/Ar或N2/Ar等气体混合物。16 在Ta2O5 ICP刻蚀过程中(使用SF6/Ar和Cl2/Ar等等离子体化学方法)紫外线照射显著提高了刻蚀速率,这是由于光辅助去吸附TaClx和TaFx刻蚀产物。17 与Ta2O5 ICP刻蚀相关的最新研究来自Muttalib等人,研究了关键参数(包括ICP功率、RF平台功率、气体流量和腔室压力)对刻蚀速率和侧壁坡度角的影响,但其研究对象是线波导。18 还有一项研究讨论了在PhCs背景下刻蚀Ta2O5,采用脉冲电子回旋共振法。19 另一项研究涉及Ta2O5 PhC干刻蚀,使用反应离子刻蚀(RIE)制造窄带光栅波导反射滤波器,使用50 nm中间Ge掩模层使侧壁光滑且垂直。6
图 2. (a) 使用现有工艺配方制造的“火山”形光子晶体和 (b) 斜线波导。
Muttalib等人提出的ICP工艺配方,如表I所示,由于设备更新,已有多年未被更新。此外,当前样本集成了光子晶体,最小尺寸具有300 nm间距和185 nm直径。而Muttalib等人研究的结构包括最小尺寸为600 nm宽度,间隔约200 μm的线波导。因此,需要使用电子束光刻(EBL)。与光学光刻相比,EBL具有更高的图案分辨率,能够制造更小的结构。13 在这项工作中,引入更复杂的结构需要对现有的工艺配方进行调整,以获得最佳结果,因为使用以前的配方会导致“火山”形状的光子晶体和有角度的线波导(见图2(a)和2(b))。通过统计软件(MINITAB)生成了一组9个实验运行,均匀地映射了选定参数范围内的工艺空间。这使我们能够识别出一个适合条件的区域,以获得期望的结果,并为微调刻蚀过程提供依据,一次调整一个参数。
II. 实验
图 3. (a) PCW 测试晶圆的制造工艺流程。(b) PCW 电子束图案示意图,其中彩色区域表示曝光区域,空白区域表示未曝光的保留区域。(c) Ta2O5 蚀刻速率测量。(d) 蚀刻 Ta2O5 层的角度测量。
图3(a)展示了测试晶圆的制造工艺流程。使用Helios ProXL(Leybold Optics)阴极溅射系统在真空条件下,在6英寸硅晶圆上沉积了450 nm厚的Ta2O5薄膜。随后,使用Lab700(Leybold Optics)通过电子束蒸发技术沉积了一层75 nm厚的Cr层作为硬掩膜。之后,采用旋涂法涂布了一层大约400 nm厚的ZEP520A和60 nm厚的Electra92层。前者是典型的正性光刻胶,用于电子束光刻(EBL),而后者作为顶层涂层,用于在电子束写入过程中帮助电荷散发并减少图像位置误差。在电子束曝光后,Electra92通过水洗去除,暴露出的光刻胶层则用ZED-N50进行显影。为了将ZEP520A的图案转移到Cr层上,采用基于Cl2/O2(50/12.5 SCCM)的ICP刻蚀,腔体压力设置为10 mTorr,ICP功率为750 W,RF平台功率为10 W。Cr刻蚀和Ta2O5刻蚀都在Plasmalab System 100上进行,该系统配备了来自Oxford Instruments的Cobra高密度等离子源,距离380 mm。该系统使用13.56 MHz的电容耦合下电极(位于晶圆下方)作为RF平台生成器,并使用2 MHz的感应线圈作为ICP生成器。根据Muttalib等人的经验,选择了氟碳化学体系(C4F8和O2)来进行Ta2O5的刻蚀,因为这种体系有可能通过CFx聚合物保护侧壁来控制刻蚀各向异性。
图3(b)展示了用于测试Ta2O5刻蚀速率和侧壁角度的电子束图案。通过去除单排光子晶体(PhCs)来创建光子晶体波导(PCW)。该波导被逐渐锥形化,宽度为5 μm的线波导,便于光的耦合进出PCWs。锥形部分和线波导都是通过在两侧刻蚀2 μm宽的沟槽形成的。新配方是在芯片尺度(约2×1.4 cm²)上开发的,然后扩展到6英寸完整晶圆尺度处理。测试芯片包括了不同组合的PhC特性,填充因子为0.35和0.45,间距值从300 nm到390 nm,步长为30 nm。为了模拟一个过程晶圆,该晶圆包含大部分表面积为Cr硬掩膜,测试芯片被安装在涂覆Cr的载体晶圆上,以防止由于Si大面积导致的宏观加载。我们使用Santovac-5真空油作为芯片和载体晶圆之间的界面材料,以便于热传导并更好地控制温度的均匀性和稳定性。
统计软件(MINITAB)用于生成总共九组实验参数组合:RF平台功率、ICP功率、气体混合物中C4F8的百分比(C4F8和O2)以及腔室压力。表II提供了我们选择的研究参数的范围,这些参数基于ICP工具可以提供稳定等离子体的可用范围。表III显示了九次实验运行的总结及结果。为了在初始运行前准备处理腔体,首先进行10分钟基于O2的等离子体清洗过程,然后是4分钟的调理步骤。为了确保每次运行时ICP腔体内的一致条件,我们进行了一次简短的清洗和调理程序,包括持续两倍于每次刻蚀时间的氟基等离子体清洗,接着进行3分钟的基于O2的等离子体清洗,并随后进行3分钟的调理过程,调理是在涂覆Cr的载体晶圆上进行的,使用与相应运行相同的条件。为了方便测量角度和刻蚀速率,刻蚀的Ta2O5大约是其总厚度的50%-70%。侧壁角度是通过测量2 μm沟槽的侧壁角度来确定的,因为PhCs区域太狭窄,无法进行精确测量。刻蚀后,测试芯片被劈开,并通过扫描电子显微镜(SEM)成像来确定刻蚀速率和侧壁角度。图3(c)和3(d)分别提供了Ta2O5刻蚀速率和侧壁角度测量方法的示意图。
III. 结果与讨论
A. 初步刻蚀实验结果
图 4. 光子晶体尺寸的 SEM 图像:间距 (390 nm) 和直径 (245 nm)。第 2 次运行:(a) 线波导与 PCW 的连接点;(b) 光子晶体图像。第 4 次运行:(c) 剥离的聚合物层;(d) 光子晶体的顶视图 SEM 图像。第 7 次运行:(e) 线波导与 PCW 的连接点;(f) 光子晶体图像。第 8 次运行:(g) 线波导;(h) 光子晶体图像。九个不同的实验参数组合列在表III中。重复运行(Run 2的三次重复)得到了相同的结果,表明在进行完整的实验集之前的一致性。图4显示了Run 2、4、7和8的横截面SEM图像。
† Run 2显示了最好的结果,PhC具有垂直的侧壁,2 μm沟槽上几乎没有碎片。它具有较低的RF平台功率、更高的ICP功率和合理的气体流量中C4F8的百分比,表现出物理刻蚀和化学刻蚀之间的良好平衡。
† Run 4显示了所有九个运行中最差的情况。RF平台功率(因此,离子轰击能量)较低,导致物理刻蚀较少。此外,较高的C4F8比例促进了大量CFx聚合物的形成,这意味着化学刻蚀速率较低,形成了薄的CFx聚合物层,并且PhC完全被覆盖。
† Run 7也有较高的C4F8聚合物比例,但RF平台功率较高。更剧烈的物理刻蚀抵消了由氟化碳等离子体引起的过度聚合物化的影响,导致了角度较大的PhC侧壁。
† Run 8作为一个例子,显示了适度的碎片。这些碎片可能是由于较高的RF平台功率产生的,因为ICP刻蚀中的物理刻蚀会导致严重的轰击引起的损伤,从而导致表面不均匀。另一种假设是,Cr碎片在刻蚀过程中被从Cr层轰击并掉落到Ta2O5层表面,作为后续刻蚀的微掩膜。
在测量响应(侧壁角度)中观察到的小变化未能建立一个强健的模型来统计预测最佳结果,因此没有进一步使用MINITAB进行分析。最初提出的九次实验旨在均匀扫描过程空间中的兴趣区域,并确定适合的条件,以获得在刻蚀速率和侧壁角度方面的期望结果。这为进一步探索每个参数对ICP-RIE工艺的影响提供了基础。通过使用Run 2的条件作为中心运行,我们逐一调整一个参数,以研究其在Ta2O5刻蚀速率和侧壁角度中的单独影响。所得到的结果总结在第III节B到III节D中。
B. RF平台功率和ICP功率
图 5. (a) 射频压板功率对 Ta2O5 蚀刻速率和侧壁角度的影响,参数固定:总气流 (100 SCCM) 中 C4F8 含量为 50%,ICP 功率为 2000 W,气压为 10 mTorr。(b) 射频压板功率为 50 W 时的光子晶体 SEM 图像。(c) 射频压板功率为 200 W 时的光子晶体 SEM 图像。
图5(a)显示了Ta2O5刻蚀速率和侧壁角度与RF平台功率之间的关系。可以观察到,随着RF平台功率的增加,刻蚀速率增加。这是因为RF平台功率提供了离子物种(如F+和CFx+)的动能,这些离子轰击基材。增加RF平台功率会导致离子轰击能量增加,从而导致物理刻蚀的增加。随着RF平台功率的增加,侧壁角度的减小可能是由于掩模切面效应的出现,这是由于溅射(或物理刻蚀)速率的角度依赖性。切面大多源于离轴离子的优先溅射(物理刻蚀)。这是物理刻蚀中的一个固有问题,并且可以解释在预期聚合物再沉积较低时出现的倾斜轮廓。切面的角度为后续刻蚀过程提供了优选的平面,从而切面可以传播到Ta2O5层中。图5(b)和5(c)中的横截面SEM图像分别显示了RF平台功率为50 W和200 W时PCWs的比较。
图 6. (a)ICP 功率对 Ta2O5 蚀刻速率和侧壁角度的影响,参数固定:总气流(100 SCCM)中 50% C4F8,射频压板功率为 50 W,气压为 10 mTorr。(b)1000 W ICP 功率下的沟槽和(c)光子晶体 SEM 图像。(d)2000 W ICP 功率下的沟槽和(e)光子晶体 SEM 图像。(f)2500 W ICP 功率下的沟槽和(g)光子晶体 SEM 图像。
图6(a)展示了Ta2O5刻蚀速率和侧壁角度与ICP功率之间的关系。增加ICP功率会加快刻蚀速率,并提供更垂直的侧壁。高密度感应耦合等离子体由圆柱形ICP RF发生器生成。在给定的压力设定下,高ICP功率会导致C4F8的分解增加,从而提高离子化F⁺物种的浓度。相反,在低ICP功率下,会观察到离子化的重分子,如CFx⁺,的显著存在。由于离子化的F⁺物种质量较小,它们更容易从50 W RF平台功率获得动能,并被引导到晶圆表面。大量的反应性F⁺物种会导致化学刻蚀现象主导于聚合物再沉积,从而导致较高的刻蚀速率和较高的侧壁角度。非常高的等离子体密度的副作用是产生粗糙的刻蚀表面。图6(b)、6(d)和6(f)中比较了1000 W、2000 W和2500 W的ICP功率水平,清楚地显示了微掩膜效应的增加。与此同时,图6(c)、6(e)和6(g)展示了在相应ICP功率水平下的PhC SEM图像,随着ICP功率的增加,侧壁角度有明显改善。
C. 气体混合物中C4F8的百分比(C4F8和O2)
根据不同C4F8和O2流量,图7(a)和7(b)显示了Ta2O5刻蚀速率和侧壁角度与%C4F8的关系。显然,Ta2O5刻蚀速率与%C4F8成反比。更多的O2的存在会加速Ta2O5的刻蚀速率。通过探索C4F8和O2在化学刻蚀中的作用,可以更好地理解这一趋势。在Ta2O5刻蚀过程中,C4F8发挥多重作用:一方面,它包含C,用于形成CFx聚合物类物种,这些物种提供侧壁保护并使得刻蚀具有各向异性;另一方面,它提供F用于通过形成挥发性分子TaF4刻蚀Ta2O5。如果表面沉积的过量CFx聚合物没有通过形成挥发性物种(如CO、CO2和COF2)去除,它们将被覆盖上一层氟聚合物薄膜,并且刻蚀最终会停止。氧气可以来自O2气流,也可以通过Ta2O5刻蚀本身生成。在Cr表面,去除碳的唯一方式是形成挥发性物种,如CF4。由于从Ta2O5刻蚀中释放出的O促进了COx类挥发物的形成,Ta2O5表面的CFx聚合物层比Cr表面上的薄。在聚合物形成与消耗速率之间找到良好的平衡对获得所需的侧壁角度至关重要。
图 7. C4F8 含量对 Ta2O5 蚀刻速率和侧壁角度的影响。(a) O2 流量固定在 50 SCCM 时 C4F8 流量的变化。(b) C4F8 流量固定在 50 SCCM 时 O2 流量的变化。其他参数保持不变:腔体压力 10 mTorr,RF 压板功率 50 W,ICP 功率 2000 W。(c)–(h) C4F8 含量在 28.6% 至 83.3% 范围内变化的光子晶体 (PhC) SEM 图像。
图7(a)展示了不同C4F8气体流量比例(从28%到62%)对Ta2O5侧壁角度的影响。在C4F8过多的情况下,聚合功能被增强,导致更多的微掩膜现象和较慢的刻蚀速率。相比之下,较低的C4F8水平会导致清晰的刻蚀表面,但对于PhCs而言,刻蚀是各向同性的[见图7(c)],因为侧壁保护减少且化学反应增强。当C4F8占总气体流量的50%时,达到了较好的折中点。图7(b)展示了从最优点(50% C4F8)到C4F8过度聚合(83% C4F8)对Ta2O5侧壁角度的过渡。当C4F8超过50%时,PhCs内出现了支柱结构[见图7(e)–7(h)],这表明过度的聚合覆盖了刻蚀。
D. 室内压力
图 8. (a)腔室压力对 Ta2O5 蚀刻速率和侧壁角度的影响,工艺参数固定:总气流(100 SCCM)中 C4F8 的含量为 50%,RF 压板功率为 50 W,ICP 功率为 2000 W。(b)5 mTorr 压力下的沟槽和(c)光子晶体 SEM 图像。(d)10 mTorr 压力下的沟槽和(e)光子晶体 SEM 图像。(f)20 mTorr 压力下的沟槽和(g)光子晶体 SEM 图像。
图8(a)展示了Ta2O5刻蚀速率和侧壁角度与室内压力的关系。从曲线中可以明显看出,随着压力的增加,Ta2O5的刻蚀速率减小。此外,在高压力下,微掩膜效应变得更加明显,通过观察2 μm的沟槽状态[见图8(b)、8(d)和8(f)]可以看出。压力被认为影响聚合物沉积速率,较高的压力会导致较快的沉积速率。18 在保持总气体流量(100 SCCM)和%C4F8(50%)不变,并且RF平台功率(50 W)和ICP功率(2000 W)不变的情况下,高压系统中会出现较低水平的反应性F⁺物种。这是由于较短的平均自由程效应,它是导致前驱体C4F8分子气体裂解的一个促成因素。在较高的压力下,存在大量的CFx⁺,这些离子负责再沉积(聚合物形成),从而导致较低的刻蚀速率、较低的侧壁角度和更多的问题残留物。
尽管最佳的侧壁角度出现在压力为10 mTorr时,但值得注意的是,所有的角度都在85°–88°之间,这是一个相对较小的变化,且随着压力变化变化不大。类似地,PhCs的SEM图像也没有随着压力变化显著变化[见图8(c)、8(e)和8(g)]。
E. 在Ta2O5层下方放置2 μm SiO2层的Ta2O5刻蚀
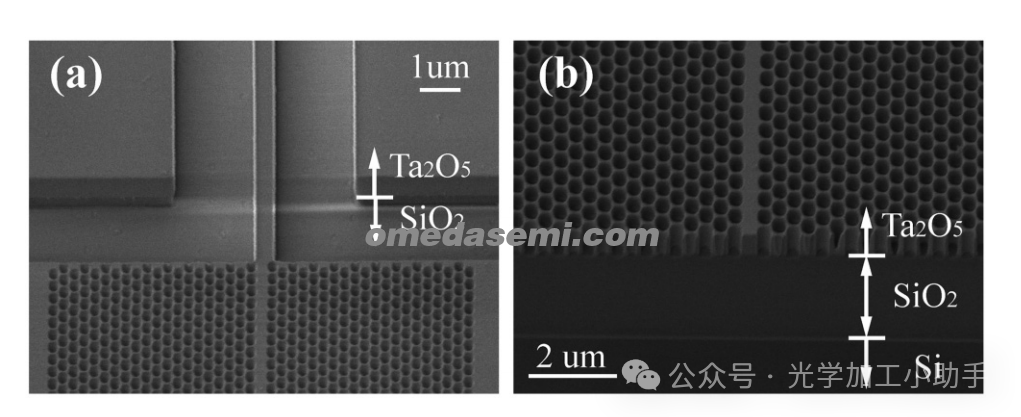
图 9. 经过 Ta2O5 蚀刻、Cr 湿法蚀刻(去除 Cr 硬掩模)以及在 70°C 下用 40% KOH 浸泡 5 分钟后,PCW SEM 图像(倾斜度为 45°):(a) PCW 与线波导的连接处;(b) PCW 的横截面。
虽然刻蚀过程已经针对Si基板上的Ta2O5层进行了优化,但该结构不支持光传播。光的传输仅发生在低-高-低折射率配置的夹层结构中,这种结构能够通过全内反射原理实现光的限制和引导。因此,使用Run 2的配方,Ta2O5刻蚀实验在6英寸的晶圆上进行了实验,该晶圆在Ta2O5层和Si基板之间放置了2 μm的SiO2层。该2 μm SiO2层是通过使用CTR-200紧凑型热反应炉进行湿氧化形成的。图9展示了在Ta2O5刻蚀后,经过Cr湿刻蚀(去除Cr硬掩膜)和在70°C下浸泡40% KOH 5分钟后的PCW SEM图像。KOH浸泡用于去除2 μm沟槽以及PhCs孔中的微小残留物。KOH平滑了表面,但以去除一层薄的SiO2为代价,因为在70°C下,40% KOH和SiO2之间的反应速率非常慢,大约是200 nm/h。20
然而,这种去除残留物的方法不适用于仅在Si基板上方有Ta2O5层的芯片,因为KOH与Si反应迅速,反应速率大约为38 μm/h。20 在进行SEM成像时,芯片被倾斜45°,使得去除的薄SiO2层在图9(a)中能够清晰地观察到。图9(b)中的PhC侧壁保持了完美的垂直形状,表明底部的2 μm SiO2层对Ta2O5刻蚀过程几乎没有影响。
IV. 结论
本文重点优化了ICP刻蚀过程,以提高Ta2O5 PCW的侧壁轮廓,PhC的最小尺寸为300 nm的间距和185 nm的直径。通过一系列实验,绘制了工艺空间图,并确定了最佳的刻蚀参数组合,包括RF平台功率、ICP功率、气体混合物中%C4F8的比例(C4F8和O2)以及腔室压力。随后,获得的最佳实验条件作为起点,研究了每个参数对ICP-RIE的个别影响。每次仅调整一个参数,保持其他三个常数,以评估它们对刻蚀速率和侧壁角度的影响。结果如下:(1)增加RF功率可以增强物理刻蚀速率,但会导致侧壁倾斜;(2)增加ICP功率可以加速刻蚀速率并提供更好的侧壁,但会产生较粗糙的表面;(3)保持气体流量中50%的%C4F8非常关键,因为偏离(过高或过低)会导致不良效果,如增加微掩膜或各向同性侧壁;(4)较高的压力增加了聚合物沉积速率,从而减慢了Ta2O5的刻蚀速率,同时伴随有较强的微掩膜效应。
本质上,四个参数之间的微妙平衡对刻蚀结果至关重要。推荐的工艺配方为50 W的RF平台功率、2000 W的ICP功率、10 mTorr的腔室压力和50% C4F8气体流量(100 SCCM),可实现113.325 nm/min的刻蚀速率,并在PhC中获得平滑的垂直侧壁。此外,这一配置也适用于在Ta2O5下方有2 μm SiO2层的刻蚀,能够保持PhC侧壁的完整性。
作者;Wenjie Wang ; Libe Arzubiaga; Maryam Shayesteh; Stephen Fenner ; Owain Clark;Martin D. B. Charlton
单位;1School of Electronics and Computer Science, University of Southampton, Southampton SO17 1BJ, United Kingdom
2Southampton Nanofabrication Centre, Optoelectronics Research Centre, University of Southampton, Southampton SO17 1BJ,United Kingdom