最先进的PZT和铌酸锂绝缘体(LNOI)微环电光调制器的性能对比集成电光(EO)调制器是光电信息技术的核心部件,而铌酸锂是目前应用最广泛的晶体薄膜材料,然而有限的电光系数限制了调制器的调制效率。本文提出了一种基于锆钛酸铅(PZT)和氮化硅(SiN)异质平台的集成电光调制器,该调制器采用微环谐振器。采用低介电常数SiN作为电极衬底,降低了微波衰减,实现了33 GHz的电光带宽。得益于PZT薄膜沉积的高质量和我们结构中较高的电光重叠度,实现了半波电压长度积为0.7 V·cm的超高调制效率。此外,一个显著的结果是,使用该调制器可以生成 80 Gbps 的开关键控信号。
#划重点
#PZTOI晶圆 #PZT电光调制器光刻显影刻蚀流片
#6寸DUVKRF150nm流片
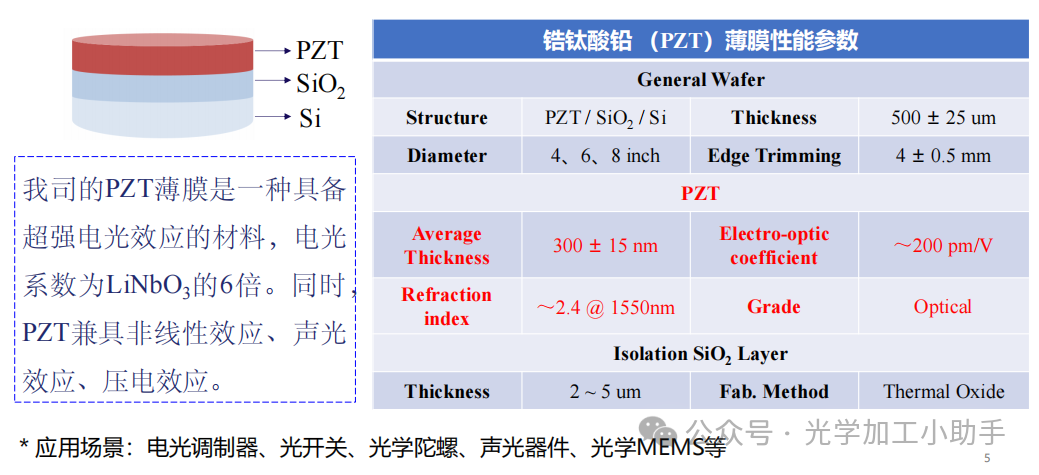

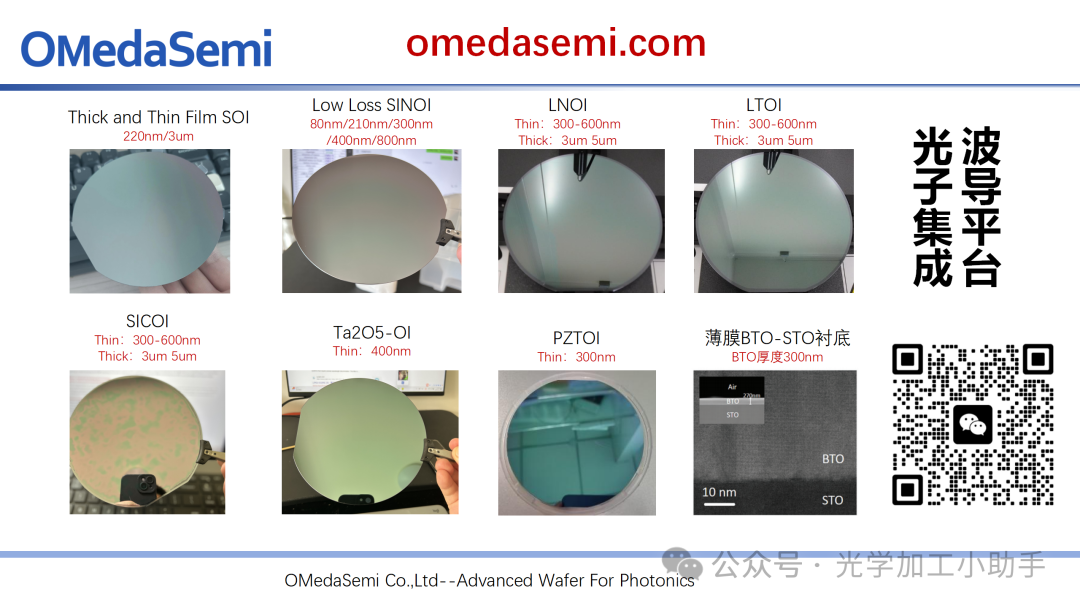
集成电光 (EO) 调制器可以将电信号高速调制为光波,广泛应用于光通信网络 [1]、光计算 [2]、量子光子学 [3] 和可编程集成电路 [4]。实现电光调制器的物理效应多种多样,例如自由载流子色散效应 [5]、电吸收效应 [6] 和普克尔斯效应 [7]。对于前两种效应,绝缘体上硅 (SOI) 是一种常用的材料平台。它具有与 CMOS 兼容和结构紧凑的优势 [8,9],然而,自由载流子色散具有吸收性和非线性,这不仅会降低调制幅度,还会在高级调制格式中导致失真。由于硅缺乏固有的二阶非线性[10],其对未来实现高波特率传输以及功耗提出了重大挑战。幸运的是,普克尔斯效应能够在非常宽的光谱范围内实现超快且纯粹的折射率调制,而不会引入额外的损耗[11]。因此,在硅衬底上异质集成各种新型电光功能材料引起了人们的极大兴趣,包括铌酸锂(LiNbO3,LN)[12]、钽酸锂(LiTaO3,LT)[13]、氮化铝(AlN)[14]、钛酸钡(BaTiO3,BTO)[15]和碳化硅(SiC)。由于其电光效应和低损耗光传输,LN在高波特率多级信号传输中表现出良好的效果。然而,LN的电光系数限制在30 pm/V,导致半波电压长度积(VπL)控制在2~4 V·cm范围内[16]。锆钛酸铅(PbZrxTi1-xO3,PZT)具有较大的带隙(4.1 eV)[17]、较低的损耗,以及比LN高四倍的电光系数[18]。这些优势使其成为电光调制器的有希望的候选材料。在早期研究中,PZT微环电光调制器是采用化学溶液沉积(CSD)法在SiN波导上沉积PZT薄膜而制备的[19]。然而,SiN波导表面平坦化工艺的不完善降低了PZT薄膜的质量,将VπL限制在3.3 V·cm。通过去除PZT薄膜下方的SiN波导,并将PZT薄膜沉积在平坦的氧化硅(SiO2)衬底上,PZT薄膜的质量得到改善,调制效率达到1.17 V·cm[20]。然而,PZT的高介电常数会导致较大的微波衰减,从而将调制器的带宽限制在24 GHz。本文展示了一种基于SiN负载PZT平台的高速高效微环调制器。采用CSD方法在平坦的SiO2/Si衬底上制备了高质量的PZT薄膜。由于PZT薄膜无需刻蚀,电光系数高达84 pm/V。得益于0.6的大电光重叠系数,该微环调制器的VπL低至0.7 V·cm。通过将电极置于低介电常数的SiN薄膜上,有效降低了微波衰减。该调制器实现了33 GHz的调制带宽,并成功生成80 Gbps的开关键控(OOK)信号。
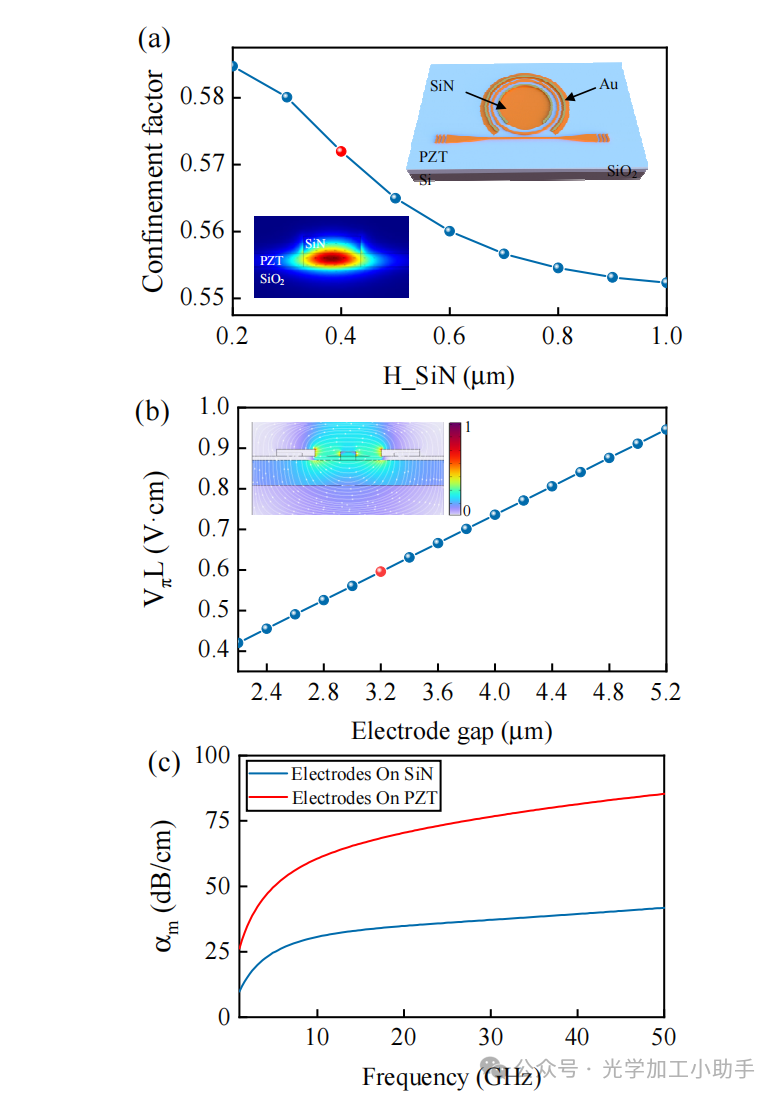
图1. (a) PZT层内能量束缚因子与SiN波导厚度之间的关系。插图:基本TE模式下的电场和PZT-SiN异质集成微环电光调制器的示意图。 (b) 模拟VπL与电极间隙之间的关系。插图:电场分布(施加电场为1V)。红色球体显示了本研究中使用的参数。 (c) 电极分别放置在SiN薄膜(蓝色曲线)和PZT薄膜(红色曲线)上的微波衰减。
所提议的PZT-SiN异质集成微环电光调制器的示意图如图1(a)的插图所示。SiN波导被放置在300纳米的PZT层上,以引导光波。与SiN(~2)相比,PZT(~2.4)的较高折射率确保光场在PZT层内传播。图1(a)显示了通过有限元方法计算的PZT层内光场能量束缚因子,作为SiN厚度的函数。增加SiN厚度会逐渐减少光场在PZT波导内的束缚百分比。将SiN波导的厚度设置为400纳米,宽度为1.2微米,可以实现PZT层内光场束缚因子超过57%,从而有效利用PZT中的强电光系数。图1(a)的插图展示了基本TE模式下的电场,计算得出的混合波导在1550纳米处的有效折射率为2.03。高调制效率依赖于较大的电光重叠。理论上的电光重叠和VπL可以通过以下方程表示[19]:
其中,g是电极之间的间隙,V是施加的电压,ε0是真空介电常数,c是真空中的光速,nPZT是PZT的折射率,Eo x和Ee x分别是光场和电场在平面内(x-方向)的横向分量,λ0是共振波长。图1(b)显示,当电极间隙减小时,VπL相应地减小。为了实现调制效率与电极金属对光场吸收之间的最佳平衡,电极间隙设为3.2微米,理论上的VπL为0.6 V·cm,得益于电光重叠度为0.6。
微波衰减限制了高频下的电光性能,而高介电常数通常会导致微波衰减增加[21]。我们使用有限元方法模拟电极在PZT和SiN薄膜上的微波衰减。图1(c)表明,将电极放置在SiN薄膜上,与放置在PZT薄膜上相比,微波衰减显著较低,主要是由于PZT薄膜的相对介电常数比SiN薄膜高两个数量级。
在实验中,使用化学溶胶-凝胶法(CSD)将300纳米厚的PZT薄膜沉积在由2微米厚SiO2层和525微米厚Si层组成的基板上。接着,使用等离子体增强化学气相沉积法(PECVD,Oxford)沉积了400纳米厚的SiN薄膜。随后,使用电子束光刻(EBL,Vistec EBPG 5200+)在光刻胶(AR-P6200.09)上定义了包括光栅和微环在内的图案。通过感应耦合等离子体(ICP)干法刻蚀将图案转移到SiN层上。在随后的电子束光刻(EBL)和电子束蒸发步骤中,先在10纳米厚的钛粘接层上蒸发300纳米的金,通过剥离过程形成电极和接触垫。
图2. (a) PZT-SiN集成微环电光调制器的制造过程示意图。 (b) 总线波导和环形波导的伪彩色SEM图像。 (c) 波导横截面的伪彩色SEM图像。
图2展示了所制造设备的详细流程图和伪彩扫描电子显微镜(SEM)图像。
所制造的PZT-SiN微环的传输光谱在C波段使用可调激光扫描系统(EXFO T100S-HP-CLU-M-CTP10-00)进行表征。片上光栅耦合器用于将光耦合进/出混合SiN-PZT光波导。测量的耦合损耗为6 dB/个事实。为了最小化弯曲损耗的影响,采用了200微米的微环半径。图3(a)显示了在1550纳米附近波长下相对于光栅耦合器的传输光谱。洛伦兹曲线拟合揭示,在1553纳米时测得的品质因子Q为4.4×10⁴,内在品质因子Q为8.2×10⁴,消光比为20.79 dB,空域范围(FSR)为0.773纳米,如图3(b)所示。
图3. (a) 测量的PZT-SiN微环的归一化传输光谱。 (b) 在1553.7纳米处共振凹陷的洛伦兹拟合(红色曲线)。
方程3可用于计算PZT-SiN混合波导的传播损耗[22]。
其中,α是单位长度的传播损耗,ng、Qi和R分别代表群折射率、内在品质因子和微环半径。混合波导的传播损耗计算为1.2 cm⁻¹。通过优化薄膜沉积过程并减少表面和侧壁粗糙度,以最小化光散射损耗,可以进一步减小损耗。
由于PZT薄膜的平面内偶极子相对于表面法线的取向,缺乏电光效应,需要电场极化才能诱导铁电状态的偶极特性[23]。我们在升高温度下向电极施加48 V(≈150 kV/cm)的电压,持续1小时,以获得最佳的电光响应。图4(a)展示了微环共振波长随施加电压的线性偏移。随着电压从0 V变为20 V,共振波长蓝移了1.1纳米。
图4. (a) 在不同电压下的PZT-SiN微环归一化传输光谱。 (b) 共振波长随电压的变化及线性拟合的调谐效率。
图4(b)中的拟合线性调谐效率为58 pm/V。此外,根据公式:VπL = |L·FSR·ΔV/(2Δλ) | ≈ 0.7 V·cm,所测得的调制效率可以表示为VπL,该结果接近于模拟结果。
调制效率可以归因于两个关键因素:极高的电光重叠度和PZT薄膜的显著高电光系数。具体来说,电光系数计算为84 pm/V。电光系数的提升归因于在均匀的SiO2/Si基板上沉积的高质量薄膜,同时避免了PZT直接刻蚀对电光性能的影响。
为了研究调制器的电光响应,我们使用67 GHz光波分量分析仪(LCA,Keysight N5227B)表征微环调制器的电光S21响应。图5(a)展示了所制造调制器的电光S21响应,测得的3 dB带宽为33 GHz。
最后,调制器通过高速驱动信号进行测试。由任意波形发生器(AWG,Keysight M8195A)生成并通过射频放大器(SHF 807C)放大的峰峰电压约为2 V的OOK信号通过GS探头施加到电极上。光波长选择在光功率降低3 dB的位置。然后,调制光被高速光电探测器(PD,Finisar XPDV3120)检测,并通过数字存储示波器(DSO,Keysight N1092)进行分析。成功生成了60 Gbps、70 Gbps和80 Gbps的OOK信号,其中OOK信号的信噪比(SNR)分别为5.4 dB、3.1 dB和2.47 dB,如图5(b)所示。
图5. (a) 测量的电光S21响应。 (b) 分别为60 Gbps、70 Gbps和80 Gbps数据率的OOK信号的测量眼图。
表1比较了最先进的PZT和铌酸锂绝缘体(LNOI)微环电光调制器的性能。与在SiN波导上生长PZT薄膜的方法相比,采用CSD方法在均匀的SiO2/Si基板上沉积PZT薄膜,并形成带有SiN薄膜的波导,避免了PZT的刻蚀。这种方法提高了PZT薄膜的质量,并使调制效率几乎增加了五倍。与PZT薄膜的直接刻蚀相比,引入低介电常数的SiN薄膜来形成波导并减少微波损耗,从而实现了更高的调制带宽,并使得生成更高速的OOK信号成为可能。与LNOI微环调制器相比,该调制器展现出了更高的调制效率。
总之,我们展示了一种高速高效的PZT-SiN异质集成微环调制器。PZT薄膜沉积在平坦的表面上,避免了刻蚀,从而提供了具有84 pm/V电光系数和0.7 V·cm调制效率的高质量PZT薄膜。通过使用低介电常数的SiN层,该器件的带宽达到了33 GHz,特别地,成功地使用该调制器生成了80 Gbps的OOK信号。所提出的PZT-SiN平台将为高效、低成本和高速电光调制器的发展提供新的见解,并为低功耗可编程光子学奠定基础。
作者;
WENFENZHOU,1YONGZHANG,1,2,* YONGHENG JIANG,3 PU ZHANG,3 JIAN SHEN,1 XUN ZHANG,1 YUQI CHEN,1 MIN SUN,1 FENG QIU,4 HUIFU XIAO,3, * YONGHUI TIAN,3 AND YIKAI SU
1State Key Lab of Advanced Optical Communication Systems and Networks, Department of Electronic Engineering, Shanghai Jiao Tong University, Shanghai 200240, China
2State Key Laboratory of Precision Spectroscopy, East China Normal University, Shanghai 200241, China
3School of Physical Science and Technology, Lanzhou University, Lanzhou, Gansu 730000, China
4Hangzhou Institute for Advanced Study, University of Chinese Academy of Sciences, Zhejiang, Hangzhou 310024, China






